Nedenfor er den engelske oversættelse. Jeg brugte klare, enkle formuleringer og grundlæggende forbindelsesord (and, but, so, then, because). Jeg holdt tekniske termer og tal nøjagtige. Teksten er lang (over 1800 ord), som du bad om.
Grundlæggende proces til fremstilling af HDI-kort med blinde og nedgravede vias
1. Oversigt over
HDI står for High Density Interconnect. Det er en printkortteknologi, der opstod i slutningen af det 20. århundrede. Den største fordel er brugen af laserboring. Traditionel mekanisk boring er begrænset af bor. Når hulstørrelsen når 0,15 mm, stiger omkostningerne meget, og det er svært at optimere. HDI-laserhuller kan kun være 3-5 mil (0,076-0,127 mm). Sporbredden kan være 3-4 mil (0,076-0,10 mm). Pad-størrelser bliver meget mindre. Der er plads til flere spor i det samme område. Dette muliggør sammenkoblinger med høj tæthed.
HDI lader designere bruge tætte pakker som BGA og QFP. HDI på første niveau er nu almindeligt for BGA med 0,5 pitch. Når BGA-routing bevæger sig fra hjørneflugt til centerflugt, bliver første niveau HDI kan ikke længere opfylde nogle behov. HDI på andet niveau bliver fokus for R&D og produktion. Første niveau HDI laser blind vias forbinder kun overfladen med det tilstødende indre lag. HDI på andet niveau kan bore fra overfladen ned til det tredje lag eller fra overfladen gennem det andet lag til det tredje lag. Det er meget sværere end HDI på første niveau.
2. Materialer
2.1 Materialetyper
- Kobberfolie: det grundlæggende materiale, der skaber ledende mønstre.
- Kerne (CORE): Boardets rygrad. Det er en dobbeltsidet kobberbeklædt plade, der bruges til at lave indre lag.
- Prepreg: Halvhærdet harpiksplade, der bruges som lim til flerlagsplader og som isolering.
- Loddemaskeblæk: bruges til loddemaske, isolering og korrosionsbeskyttelse.
- Legend ink (silketryk): bruges til markeringer og etiketter.
- Materialer til overfladebehandling: omfatter tin-bly-legeringer, nikkel-guld, sølv, OSP, og andre.
2.2 Isoleringsmaterialer af laminat
2.2.1 Almindelige laminater
Almindelige høj-Tg-materialer omfatter MICA/EG-150T, SYST/S1141, Grace/MTC-97 og HITACHI/MCL-HD-67. De bruges, når der er brug for højere varmebestandighed.
2.2.2 HDI-specifikke isoleringsmaterialer
Almindelige typer og specifikationer:
- RCC-materialer: 80T18, 60T12, 65T12, 80T12, 60T18.
- fr4 (LDP): 1080, 106.
Bemærk: Jeg brugte “fr4” for FR-4, som du foretrækker.
2.3 Særligt materiale: RCC forklaret
RCC betyder Resin Coated Copper (harpiksbelagt kobber). Det er kobberfolie belagt med en særlig harpiksfilm. Filmen dækker de indre spor helt og fungerer som isolering. RCC findes hovedsageligt i to typer: B-stadiet (Mitsui) og B+C-stadiet (Polyclad).
Vigtige funktioner:
- Intet glasfiberlag i harpiksfilmen. Det gør det lettere at danne mikrovias med laser eller plasma.
- Tyndt dielektrisk lag og høj afskalningsstyrke.
- God sejhed og glat overflade, god til ætsning af meget smalle spor.
- Laserboring til HDI er ofte rettet mod RCC. Laserhuller er formet som omvendte trapezoider, ikke cylindre som mekaniske huller. Typisk hulstørrelse er 0,076-0,10 mm.
Andre HDI-materialer (kerne, prepreg, kobberfolier) er ikke specielle. Normalt er den indre kobbertykkelse tynd: indre lag 1 oz, ydre lag 0,5 oz basiskobber belagt til 1 oz. Hele printet er tyndere. Fordi RCC ikke har nogen glasfiber, er dets hårdhed og styrke lavere end andre printkort med samme tykkelse.
3. Fremstillingsproces (eksempel: 2+4+2 otte-lags plade)
Nedenfor viser jeg de vigtigste trin og nøglepunkter. Jeg bruger enkle ord og en klar rækkefølge.
3.1 Skærende råmateriale (CUT)
Skæring forvandler store kobberbelagte plader til størrelser, der passer til produktionsmaskiner. Tre kernebegreber skal være klare:
- UNIT: en designenhed i kundens layout.
- SET: flere UNITs sammen, inklusive proceskant og værktøj.
- PANEL: flere SETs sat sammen med værktøjskanter for at lave et produktionspanel. Almindelige indkøbte rå størrelser er 36,5 tommer × 48,5 tommer, 40,5 tommer × 48,5 tommer og 42,5 tommer × 48,5 tommer. Udbyttet afhænger af design og panelets anvendelse.

3.2 Tørfilmsproces med indre lag (INNER DRY FILM)
Det indre tørfilmstrin overfører indre lagmønstre. Trinene omfatter laminering af fotoresistfilm, eksponering, fremkaldelse, ætsning og stripping:
- Laminat: Klæb lysfølsom film på kobber. Lyset hærder de eksponerede dele og danner et beskyttende lag.
- Eksponér og fremkald: Eksponér filmen. Belyste dele hærder. Mørke dele forbliver bløde. Fremkaldelse fjerner den bløde film.
- Æts og strip: Æts det blottede kobber. Fjern derefter den hærdede beskyttelsesfilm. Der dannes spor i det indre lag.
Designtips: Kontroller minimumsbredde, afstand og ensartethed. Hvis afstanden er for lille, kan der ske kortslutning under lamineringen. Hvis sporene er for tynde, kan filmens vedhæftning svigte, og sporene åbnes. Efterlad sikre marginer til produktionen.
3.3 Sort eller brun oxidering (BLACK OXIDATION)
Når de indre spor er lavet, skal du lave sort eller brun oxidering før laminering. De vigtigste mål:
- Fjern olie og forurening fra kobberoverfladen.
- Øg kobberoverfladen for at forbedre bindingen til resin.
- Omdanner upolær kobberoverflade til polær CuO og Cu₂O for at forbedre den kemiske binding.
- Forbedrer fugtbestandigheden ved høje temperaturer og reducerer risikoen for delaminering mellem kobber og resin.
Hvis Cu₂O er hovedproduktet, kaldes det brun oxidation (rød farve). Hvis CuO er hovedproduktet, kaldes det sort oxidation (sort farve).
3.4 Laminering (presning)
Laminering binder alle lag sammen ved hjælp af B-stage prepreg. De vigtigste trin:
- Stackup: arranger kobberfolier, prepreg, indre kerner, rustfri stålplader, separatorplader, kraftpapir og ydre presseplader. For plader med seks eller flere lag er det nødvendigt med forudgående stabling.
- Varmepresse: Læg stakken ind i en varm vakuumpresse. Varmen smelter harpiksen og binder stakken sammen, så hulrummene fyldes ud.
Tips: Hold lamineringen symmetrisk. Hvis belastningen ikke er afbalanceret på begge sider, vil der opstå skævheder. Kontroller kobberfordelingen for at undgå forskelle i harpiksflowet, som giver ujævn tykkelse. Planlæg blinde og nedgravede vias i forvejen.
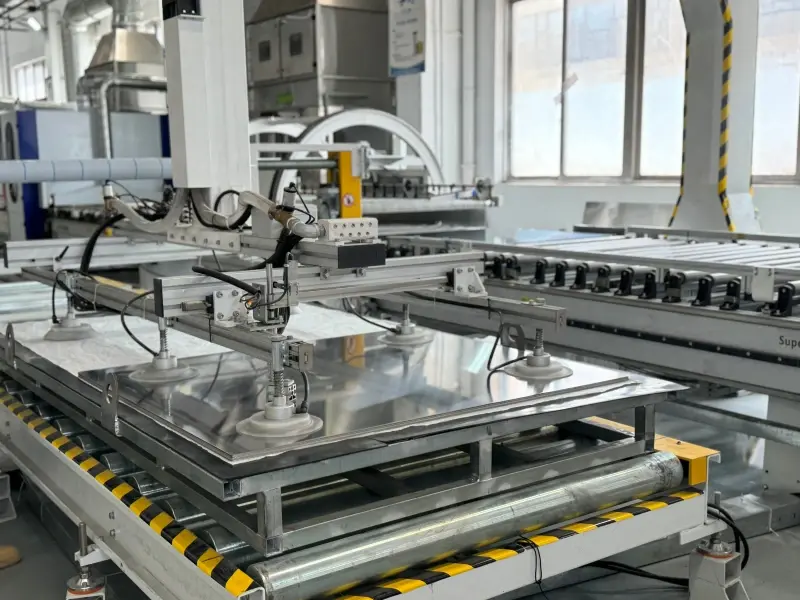
3.5 Boring af blinde og nedgravede vias (DRILLING)
I printkortproduktion er mekanisk boring den vigtigste metode til gennemgående huller, der er større end ca. 8 mil. Mekanisk boring bestemmer, hvor blinde og nedgravede vias ikke kan krydse. I et eksempel med otte lag kan man lave begravede vias til lag 3-6, blinde vias til lag 1-2 og blinde vias til lag 7-8 på samme tid. Men man kan ikke designe krydsende buried vias som 3-5 og 4-6, fordi de ikke kan laves. Asymmetriske begravede viamønstre (som 3-5 og 4-6) øger sværhedsgraden og skrotningsraten betydeligt. Omkostningerne kan være over seks gange så høje som for symmetriske viaer.

3.6 Kobberudfældning og -belægning (via metallisering)
Via metallisering dækkes den borede hulvæg med kobber, der er ensartet og varmebestandigt. Tre trin:
- Fjern rester af boret.
- Kemisk kobberaflejring.
- Galvanisering af hele panelet for at gøre kobberet tykkere.
Nøgleparameter: aspektforhold (pladetykkelse i forhold til huldiameter). Når pladetykkelsen stiger, og huldiameteren falder, kan kemikalierne ikke nemt nå ind til hullets midte. Det kan gøre pletteringen tynd i midten og forårsage mikroåbne fejl. Designere skal kende boardhusets procesgrænser. Både blinde/nedgravede vias og gennemgående huller skal tage højde for grænserne for størrelsesforholdet.
3.7 Andet indre lag tør film
Efter metallisering af nedgravede vias til lag 3-6 fyldes hullerne med resinblæk, og der vendes tilbage til de indre tørfilmstrin for at lave lag 3- og 6-spor. Når de er færdige, skal du lave sort/brun oxidering igen og derefter sende til endnu en laminering. Denne anden laminering følger samme proces som den første.
3.8 Anden laminering (HDI-presse)
HDI-plader har tynde isoleringslag, så det er sværere at presse dem. Ved samme tykkelse er LDP-styrken bedre end RCC. LDP flyder langsommere, så det er nemmere at kontrollere.
Bemærkninger om design:
- På indre områder med blinde/nedgravede vias skal ydre spor undgå via-placeringerne for at undgå åbne kredsløb forårsaget af fordybninger.
- For mange nedgravede vias mellem det andet og næstsidste lag kan skabe kanaler, der udtynder dielektrikummet. Reducer sådanne vias, når det er muligt.
Til HDI CO₂-laserblind vias er en almindelig metode den konforme masketeknik. Overfør mønstre til det ydre kobber, æts små vinduer, der matcher laser-via-positioner, og brug derefter laser med højere effekt ved disse koordinater. Dette passer til subtraktiv flerlagsfremstilling.
3.9 Konform maske (laser via forbehandling)
Conformal mask består af to dele: Conformal mask1 og Conformal mask2:
- Conformal mask1: Ætsningspuder, der flugter med den blinde via på begge sider af subboardet, og ætsningsmål til den automatiske eksponeringsmaskine. Dette hjælper med senere behandling og laserboring.
- Conformal mask2: Æts vinduer på kortets øverste og nederste kobber, der er lidt større end laserhullet. Dette forbereder til CO₂-laserbehandling.
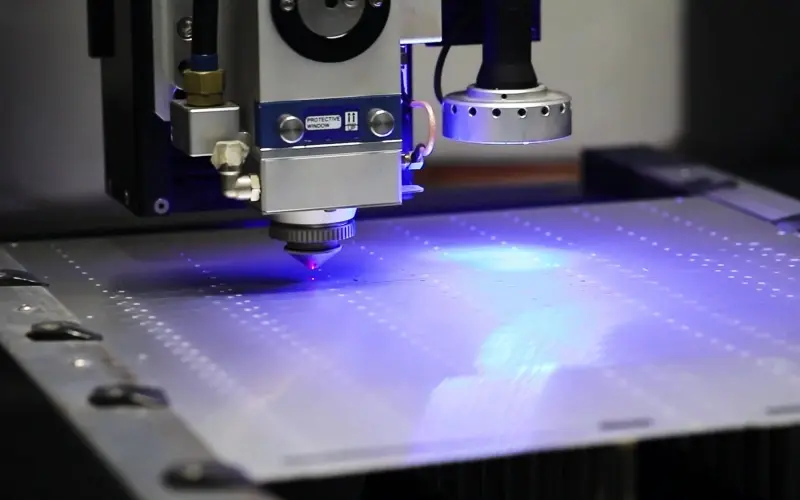
3.10 Laserboring (LASER DRILLING)
Laserboring bruger laserenergi til at brænde harpiks og danne blinde vias. Laserenergien falder fra top til bund, så hullets diameter bliver mindre med dybden. Typisk hulstørrelse er 4-6 mil (0,10-0,15 mm). I henhold til IPC6016 kaldes huller ≤0,15 mm for mikro-vias.
Huller større end 0,15 mm kræver spiralboring. Hastigheden falder, og omkostningerne stiger hurtigt. Almindelige laserværktøjer bruger nu tre-skudsboring. Hastigheden er 100-200 huller pr. sekund. Mindre huller kan være hurtigere (0,100 mm hul ~120 huller/sek; 0,076 mm hul ~170 huller/sek).
3.11 Laser via metallisering
Laserhuller brænder hulvæggen og efterlader trækul. Det andet kobberlag kan oxidere. Højtryksspuling er nødvendig for at fjerne borerester. Mikro-via-kul er svært at fjerne. Stablet HDI i to niveauer kræver særlig blind-via-belægning og kobberfyldning (COPPER FILLING). Dette er dyrt og bruges til avancerede produkter.
3.12 Tredje indre tørre film
Efter laser via metallisering skal du lave en anden Conformal mask1. Gå derefter tilbage til de indre tørfilmstrin for at lave lag 2 og 7 spor. Når sporene er færdige, skal du lave sort/brun oxidering og en tredje laminering. Lav derefter det tredje blinde via ætsningstrin 1 og det andet blinde via ætsningstrin 2 for at forberede den anden laserboring.
HDI på andet niveau kræver mange tilpasninger. Fejlene kan hobe sig op. Dette gør skrotningsraten højere. Fra lettere til sværere i via-kombinationer:
1-2 + 2-3 vias < kun 1-3 vias < 1-2 + 1-3 vias < 2-3 + 1-3 vias < 1-2 + 2-3 + 1-3 vias.
HDI-vias skal designes symmetrisk.
3.13 Anden laserboring
Udfør det andet laserboringstrin som planlagt for HDI på to niveauer. Dette følger de samme regler som den første laserboring, men kræver omhyggelig justering og planlægning.
3.14 Mekanisk boring (bor gennem huller)
Efter lasertrin skal du udføre mekanisk boring af gennemgående huller. Dette trin borer huller, der går gennem hele panelet.
3.15 Fjernelse af borerester og via plating (P.T.H.)
Plader de blinde vias og gennemgående huller sammen, så alle vias er metalliserede. På dette tidspunkt slutter det særlige HDI-flow. Fra nu af følger printkortet standardtrin for PCB-efterbehandling.
3.16 Tørfilm i yderste lag og mønsterbelægning (DRY FILM & PATTERN PLATING)
Den ydre mønsteroverførsel ligner de indre lag. Den største forskel er pletteringsmetoden:
- Subtraktiv metode: Brug negativ film. Den hærdede tørre film forbliver som kredsløb. Æts og strip filmen for at bevare kredsløbet.
- Additiv/normal metode: Brug positiv film. Den hærdede tørre film dækker ikke-kredsløbsområder. Lav mønsterplettering (kobber og derefter tin), strip derefter filmen, lav alkalisk ætsning, fjern tin, og behold kredsløbet.
3.17 Vådfilm-loddemaske (WET FILM SOLDER MASK)
Loddemasken dækker kortets overflade. Den forhindrer forkert lodning, fugt eller kemikalier i at forårsage kortslutninger og beskytter sporene mod fysiske skader. Det holder PCB-funktionen stabil.
Proces: forrensning → belægning → forbagning → eksponering → udvikling → UV-hærdning → termisk hærdning. Vigtige kontrolpunkter: Justering af loddemaske, størrelse af maskebro, via-produktion og masketykkelse. Blækkvaliteten påvirker senere overfladefinish, SMT-montering og kortets levetid.
3.18 Selektivt nedsænket guld (IMMERSION GOLD)
Kemisk nikkel/guldbelægning er en overfladefinish efter loddemaske. Den passer til printkort med lille sporafstand og mange overflademonterede dele. Det hjælper med at gøre puderne plane og flade. Guld er stabilt og beskyttende. Pletteringsspecifikationer: nikkel ~5 μm, guld 0,05-0,1 μm. For tykt guld kan revne og give svage loddeforbindelser. For tyndt guld giver dårlig beskyttelse. ENIG er i nogle tilfælde mindre loddevenligt og kan vise mørke paddefekter.
3.19 Udskrivning af tegnforklaring (C/M PRINTING)
Udskriv mærkater og markeringer med mærkatblæk. Det hjælper ved senere montering og service.
3.20 Fræsning og profilering (PROFILERING)
Skær det færdige panel til UNIT- eller SET-størrelse med CNC-fræser. Udfør kanttrimning og notfræsning. Hvis der er behov for V-CUT, skal der tilføjes trin i overensstemmelse hermed. Nøgleparametre: profiltolerance, affasningsstørrelse, indre hjørneradius. Efterlad en sikker afstand mellem mønstre og pladekant.
3.21 Elektrisk test (E-TEST)
Dette er en kontinuitets- og isolationstest. De vigtigste metoder er test med søm og test med flyvende sonde:
- Nålestykke: generiske eller specialfremstillede armaturer. Generiske fiksturer koster mere, men passer til mange printkort. Tilpassede armaturer er billigere pr. del, men kun til specifikke printkort.
- Flyvende probe: Flytter prober til testnet. Den er fleksibel og god til mange små kørsler.
3.22 OSP (organisk konserveringsmiddel for loddeevne)
OSP danner en organisk film på nøgne kobberpuder og gennemgående huller efter elektrisk test og visuel kontrol. Filmtykkelsen er 0,3-0,5 μm. Nedbrydningstemperatur ca. 300 °C.
Vigtigste fordele: flad plettering, der passer til printkort med lille pitch; enkel proces, lav forurening, lave omkostninger og god loddeevne. Ulemper: Filmen er tynd og let at ridse. Holdbarheden er kort.
I dag bruges ENIG + OSP-kombinationer til højpræcisionskort. De giver beskyttelse og loddeevne og er en blyfri mulighed for at erstatte HASL i nogle tilfælde. Omkostningerne er højere.

3.23 Afsluttende revision (FINAL AUDIT)
Inspicér printkortets udseende, størrelse, elektriske ydeevne og belægningskvalitet. Sørg for, at alt lever op til design- og industristandarder.
3.24 Pakning (PACKING)
Pak forbipasserende printkort ind for at undgå fugt og ridser. Beskyt printpladerne under forsendelse, og opbevar dem godt til senere brug.




