Piirilevy toimii monien komponenttien kantajana ja piirisignaalin siirron keskuksena. Siitä on tullut erittäin tärkeä ja keskeinen osa elektronisia tietotuotteita. Piirilevyn laatu- ja luotettavuustaso ratkaisevat koko laitteen laadun ja luotettavuuden.
Elektronisten tietotuotteiden pienentämisen ja lyijyttömien ja halogeenittomien ympäristösääntöjen vaatimuksen myötä piirilevyt ovat siirtyneet kohti suurempaa tiheyttä, korkeampaa Tg-arvoa ja ympäristöystävällisempiä materiaaleja. Kustannusten ja teknologiarajoitusten vuoksi monia vikoja esiintyy kuitenkin seuraavien vaiheiden aikana PCB-valmistus ja käyttää. Nämä puutteet aiheuttavat monia laatukiistoja. Jotta voidaan selvittää, miksi vikoja esiintyy, löytää keinoja niiden korjaamiseksi ja selvittää vastuu, on tarpeen tehdä vika-analyysi esiintyvistä vioista.
Vika-analyysin perusvaiheet
Piirilevyn vian tai vian tarkan syyn tai mekanismin selvittämiseksi on noudatettava perusperiaatteita ja analyysivirtaa. Jos niitä ei noudateta, saatat menettää arvokasta vikatietoa. Analyysi voi pysähtyä tai antaa väärän johtopäätöksen. Yleinen perusvirta on seuraava.
Kerää ensin vikaoireiden perusteella tietoja, tee toiminnallisia testejä, sähkötestejä ja yksinkertaisia silmämääräisiä tarkastuksia. Näiden avulla etsitään vikaantunut alue ja vikatila. Tämä on vian paikallistamista tai vian paikallistamista.
Yksinkertaisille PCB:ille tai yksinkertaisille PCBA levyt, epäonnistunut osa on helppo löytää. Mutta monimutkaisissa laitteissa tai substraateissa, kuten esimerkiksi BGA tai MCM-paketeissa vikoja ei ole helppo nähdä mikroskoopilla. Niitä on aluksi vaikea löytää. Silloin tarvitaan muita menetelmiä.
Analysoi seuraavaksi vikamekanismi. Käytä fysikaalisia ja kemiallisia menetelmiä tutkiaksesi piirilevyn vikaantumiseen johtanutta mekanismia. Näitä mekanismeja voivat olla esimerkiksi kylmät juotosliitokset, saastuminen, mekaaniset vauriot, kosteuden aiheuttama rasitus, dielektrinen korroosio, väsymisvauriot, CAF- tai ionimigraatio, jännityksen ylikuormitus ja niin edelleen.
Tämän jälkeen analysoi vian perimmäinen syy. Etsi vikamekanismin ja valmistusprosessin perusteella syyt, jotka aiheuttivat mekanismin. Tee tarvittaessa kokeita syyn todentamiseksi. Sinun tulisi suorittaa testivarmennus aina kun mahdollista. Kokeilla voidaan löytää tarkka syy, joka johti vikaantumiseen.
Näin saadaan selkeä ja kohdennettu perusta seuraavalle parannusvaiheelle. Tee vika-analyysiraportti testitietojen, tosiasioiden ja analyysin johtopäätösten perusteella. Tosiasioiden on oltava selkeitä. Logiikan on oltava tiukka. Ulkoasun on oltava järjestyksessä. Älä kuvittele syitä ilman todisteita.
Käytä analyysin aikana menetelmiä yksinkertaisista monimutkaisiin, ulkopuolisista sisäisiin ja ei-tuhoavista tuhoaviin. Noudata näitä perussääntöjä. Vain näin voit välttää keskeisen tiedon menettämisen ja uusien, ihmisten luomien vikamekanismien lisäämisen.
Tämä on kuin liikenneonnettomuus. Jos toinen osapuoli tuhoaa tapahtumapaikan tai pakenee, edes taitava poliisi ei voi tehdä oikeaa arviota vastuusta. Liikennelainsäädäntö edellyttää yleensä, että se osapuoli, joka pakeni tai tuhosi tapahtumapaikan, kantaa kaiken vastuun.
Sama pätee myös piirilevyjen tai PCBA:n vikojen analysointiin. Jos joku käyttää juotosrautaa epäonnistuneen juotosliitoksen korjaamiseen tai raskaita saksia piirilevyn leikkaamiseen, myöhempi analyysi on mahdotonta. Vikaantumispaikka tuhoutuu. Tämä on erityisen huono asia silloin, kun epäonnistuneita näytteitä on vain muutama. Jos vikaantunut kohta on vaurioitunut, todellista syytä ei voida löytää.
Vika-analyysitekniikat
Optinen mikroskooppi
Optinen mikroskooppi on tarkoitettu pääasiassa piirilevyn visuaaliseen tarkastukseen. Käytä sitä löytämään vikaantunut alue ja siihen liittyvät fyysiset todisteet. Se antaa ensimmäisen arvion vikaantumistavasta. Silmämääräisellä tarkastuksella etsitään piirilevyn saastumista, korroosiota, halkeamia, piirijälkiä ja vikojen kuvioita. Tarkista esimerkiksi, tulevatko viat erissä vai ovatko ne yksittäistapauksia. Tarkista, keskittyvätkö viat aina yhdelle alueelle.

X-ray (röntgentarkastus)
Käytä röntgenkuvausjärjestelmää sellaisten osien osalta, joita ei voida nähdä silmämääräisesti, tai läpivientireikien sisäisten vikojen ja muiden sisäisten vikojen osalta. Röntgenkuvausjärjestelmä toimii, koska eri paksuus- tai tiheysluokan materiaalit absorboivat tai läpäisevät röntgensäteitä eri tavalla. Näin syntyy kuvia. Röntgenkuvausta käytetään usein PCBA-juotosliitosten sisäisten vikojen ja läpivientireikien sisäisten vikojen tarkastamiseen sekä viallisten juotosliitosten paikantamiseen suuritiheyksisissä pakkauksissa, kuten BGA- tai CSP-koteloissa.

Poikkileikkausanalyysi
Poikkileikkausanalyysi tarkoittaa näytteenottoa, upottamista, viipalointia, kiillottamista, syövyttämistä ja piirilevyn poikkileikkauksen tarkastelua. Tämä prosessi osoittaa piirilevyn sisäisen rakenteen. Poikkileikkausanalyysin avulla saat runsaasti mikrorakennetietoa piirilevyn ominaisuuksista (kuten läpivienneistä ja pinnoituksesta). Tämä auttaa ohjaamaan laadun parantamista. Tämä menetelmä on kuitenkin tuhoisa. Kun näyte leikataan, se tuhoutuu.
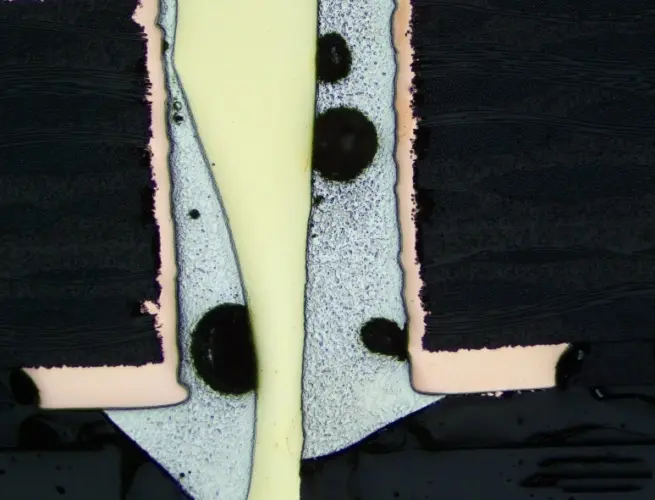
Pyyhkäisyakustinen mikroskooppi (SAM)
Nykyään tärkein työkalu pakkausten ja kokoonpanojen analysoinnissa on C-moodin akustinen pyyhkäisyyn perustuva mikroskooppi. Siinä käytetään suurtaajuisia ultraääniaaltoja. Nämä aallot heijastuvat materiaalin epäjatkuvuuskohtiin. Amplitudin, vaiheen ja polariteetin muutosta käytetään kuvien muodostamiseen. Skannaus liikkuu Z-akselia pitkin X-Y-tason tietojen tallentamiseksi.
Siksi SAM pystyy havaitsemaan monia sisäisiä vikoja komponenteissa, materiaaleissa ja piirilevyissä tai PCBA-levyissä. Se löytää halkeamia, delaminaatiota, sulkeumia ja tyhjiöitä. Jos SAM:n taajuusalue on riittävän laaja, sillä voidaan havaita myös juotosliitosten sisäisiä vikoja.
Tyypillisissä SAM-kuvissa käytetään varoitusväriä, kuten punaista, osoittamaan vikoja. Siirryttäessä lyijyllisistä lyijyttömiin SMT-prosesseihin on ilmennyt monia kosteuteen liittyviä reflow-ongelmia. Kosteutta imevät muovipaketit voivat delaminoitua tai halkeilla sisältä, kun ne sulatetaan uudelleen lyijyttömien prosessien korkeammissa lämpötiloissa. Myös tavalliset piirilevyt voivat halkeilla tai delaminoitua näissä korkeammissa lämpötiloissa.
Tässä tapauksessa SAM:lla on erityisiä etuja monikerroksisten, tiheiden piirilevyjen rikkomattomassa testauksessa. Suuret näkyvät levyn halkeamat tai puhjenneet levyt voidaan kuitenkin yleensä löytää yksinkertaisella silmämääräisellä tarkastuksella.
Mikro-FTIR (mikroskooppinen infrapuna-analyysi)
Mikroinfrapuna-analyysissä yhdistetään infrapunaspektroskopia ja mikroskooppi. Siinä hyödynnetään sitä, että eri materiaalit - pääasiassa orgaaniset materiaalit - absorboivat infrapunavaloa eri tavoin. Näin voidaan analysoida materiaalin kemiallisia komponentteja. Mikroskoopin avulla näkyvä valo ja infrapuna voivat käyttää samaa valoreittiä. Näkyvän kentän alta voit löytää pieniä määriä orgaanista epäpuhtautta analysoitavaksi.
Ilman mikroskooppia infrapunaspektroskopiassa tarvitaan yleensä suurempi näytemäärä. Elektroniikkaprosesseissa pienet epäpuhtaudet voivat aiheuttaa padin tai lyijyn huonon juotettavuuden. Ilman mikroskoopilla yhdistettyä infrapunaa on siis vaikea ratkaista joitakin prosessiongelmia. Mikro-FTIR:ää käytetään pääasiassa juotospintojen tai juotosliitosten orgaanisen kontaminaation analysointiin sekä korroosion tai huonon juotettavuuden syiden analysointiin.
Pyyhkäisyelektronimikroskooppi (SEM)
Pyyhkäisyelektronimikroskooppi on hyödyllinen suuri kuvantamisjärjestelmä vikojen analysoinnissa. Sitä käytetään morfologian havainnointiin. Nykyaikaiset SEM-laitteet ovat tehokkaita. Niillä voidaan suurentaa hienoja rakenteita tai pintapiirteitä satojatuhansia kertoja.
PCB- tai juotosliitosten vika-analyysissä SEM on pääasiassa vikamekanismien analysointiin. SEM:ää käytetään erityisesti tyynyjen pintamorfologian ja juotosliitosten metallografisen rakenteen havainnointiin, intermetallisten yhdisteiden mittaamiseen, juotettavien pinnoitteiden analysointiin sekä tinalevyjen analysointiin ja mittaamiseen.
Optiseen mikroskooppiin verrattuna SEM muodostaa elektronikuvan, joten se on mustavalkoinen. SEM-näytteiden on oltava johtavia. Ei-johteiden ja joidenkin puolijohteiden osalta näyte on päällystettävä kullalla tai hiilellä. Muuten näytteen pintaan kertyy varausta, joka vaikuttaa havainnointiin. SEM-kuvissa on paljon suurempi syväterävyys kuin optisissa mikroskoopeissa. Metallografisten rakenteiden, mikromurtumapintojen ja tinaviiksien osalta SEM on tärkeä analyysimenetelmä.
Lämpöanalyysi
Differentiaalinen pyyhkäisykalorimetria (DSC)
DSC mittaa tehoeron testinäytteen ja referenssinäytteen välillä ohjelmallisesti ohjatussa lämpötilassa. Se tallentaa tehoeron ja lämpötilan tai ajan välisen suhteen. DSC tutkii, miten lämpö muuttuu lämpötilan mukana. Sen avulla voidaan tutkia materiaalien fysikaalista, kemiallista ja termodynaamista käyttäytymistä.
DSC:llä on monia käyttötarkoituksia. PCB-analyysissä DSC:tä käytetään pääasiassa PCB:ssä käytettyjen polymeerien kovettumisasteen ja lasittumislämpötilan (Tg) mittaamiseen. Nämä kaksi parametria määrittävät PCB:n luotettavuuden myöhemmissä prosessivaiheissa.

Lämpömekaaninen analyysi (TMA)
TMA mittaa kiinteiden aineiden, nesteiden ja geelien muodonmuutoskäyttäytymistä ohjelmallisesti ohjatun lämpötilan tai mekaanisen voiman vaikutuksesta. Se tutkii termisen ja mekaanisen käyttäytymisen välistä yhteyttä. Muodonmuutoksen ja lämpötilan (tai ajan) välisestä riippuvuudesta voidaan tutkia materiaalin fysikaalisia ja kemiallisia ominaisuuksia ja termodynamiikkaa.
PCB-analyysissä TMA mittaa pääasiassa kahta keskeistä parametria: lineaarista laajenemiskerrointa ja lasittumislämpötilaa. Jos perusmateriaalilla on suuri laajenemiskerroin, piirilevy voi usein kärsiä metalloidun läpiviennin murtumisesta juottamisen ja kokoonpanon jälkeen.

Termogravimetrinen analyysi (TGA)
TGA mittaa aineen massanmuutosta ohjelmallisesti säädetyssä lämpötilassa tai ajassa. Tarkan vaa'an avulla TGA:lla voidaan seurata pieniä massanmuutoksia valvotun lämpötilan aikana.
Massanmuutos vs. lämpötila (tai aika) -käyrän avulla voit tutkia materiaalin fysikaalista ja kemiallista käyttäytymistä sekä termodynamiikkaa. PCB-analyysissä TGA:ta käytetään pääasiassa PCB-materiaalien lämpöstabiilisuuden tai hajoamislämpötilan mittaamiseen. Jos substraatin hajoamislämpötila on liian alhainen, piirilevy delaminoituu tai halkeaa korkean lämpötilan juottamisen aikana.

Loppuhuomautukset ja muistutukset parhaista käytännöistä
Kun suunnittelet vika-analyysia, noudata selkeää, vaiheittaista lähestymistapaa. Aloita visuaalisista ja rikkomattomista tarkastuksista. Käytä sähköisiä testejä ja tiedonkeruuta. Siirry sitten kuvantamismenetelmiin, kuten röntgen- ja SAM-menetelmiin. Käytä tarvittaessa mikrokemiallisia työkaluja, kuten mikro-FTIR, ja pintakuvausta, kuten SEM. Varaa tuhoavat testit, kuten poikkileikkaus, silloin, kun tarvitset mikrorakennetietoa ja kun näytteen määrä sallii tuhoamisen.
Kirjaa tiedot aina ylös ja pidä faktat selkeinä. Käytä yksinkertaisimpia loogisia vaiheita. Todista johtopäätökset mahdollisuuksien mukaan kokeilla. Älä muuta tai vahingoita vikakohtaa ennen sen dokumentointia, sillä kun vikakohtaa on muutettu, todellinen syy voi kadota. Noudata sääntöä: yksinkertaisesta monimutkaiseen, ulkopuolisesta sisäpuoliseen, ei-tuhoavasta tuhoavaan. Tämä säästää aikaa ja tuottaa oikeita analyysituloksia.


