1. Überblick
Blind Vias und vergrabene Durchkontaktierungen werden hauptsächlich für Leiterplatten mit hoher Dichte und für Leiterplatten mit sehr kleinen Löchern verwendet. Ziel ist es, Platz für das Routing zu sparen und so die Leiterplatte kleiner zu machen. Ein gängiges Beispiel sind Leiterplatten für Mobiltelefone.
2. Klassifizierung
A) Laserbohren
1. Gründe für den Einsatz des Laserbohrens
a. Der Kunde wünscht eine Laserbohrung.
b. Blind Vias können sehr klein sein (<= 6 MIL), so dass nur ein Laser sie zuverlässig bohren kann.
c. Für spezielle Stapel von Blind- und vergrabenen Durchkontaktierungen - zum Beispiel, wenn es eine Blinddurchkontaktierung von L1 nach L2 und eine vergrabene Durchkontaktierung von L2 nach L3 gibt - ist Laserbohren erforderlich.
2. Das Prinzip des Laserbohrens
Beim Laserbohren wird die Hitze des Lasers genutzt, um das Plattenmaterial zu verdampfen oder zu schmelzen und ein Loch zu bohren. Damit dies funktioniert, muss das Plattenmaterial die Laserenergie absorbieren. Aus diesem Grund werden in der Regel RCC-Materialien verwendet, da sie kein Glasfasergewebe enthalten und daher den Laser nicht reflektieren.
3. Kurze Einführung in das RCC-Material
RCC bedeutet Resin Coated Copper. Es handelt sich um eine Kupferfolie, die auf der rauen Seite der elektrolytischen Kupferfolie mit einer speziellen Harzschicht versehen ist.
In unserem Unternehmen haben wir drei Lieferanten für RCC: Shengyi, Mitsui und LG.
Materialoptionen: Harzstärke 50, 65, 70, 75, 80 µm, Kupferfolienstärke 12, 18 µm, etc.
RCC gibt es mit hoher Tg und niedriger Tg. Seine Dielektrizitätskonstante ist in der Regel niedriger als die von Standard-FR-4. Shengyi's S6018 hat beispielsweise eine Dielektrizitätskonstante von 3,8, also Vorsicht, wenn Sie eine Impedanzkontrolle benötigen.
Für Einzelheiten zu bestimmten Materialien wenden Sie sich bitte an das PE (Product Engineering) oder RD (Research & Development) Team.
4. Werkzeuge und Werkzeuganforderungen für das Laserbohren
A) Der Laser kann nur schwer durch Kupfer brennen. Ätzen Sie daher vor dem Laserbohren einen Kupferabstand an den Positionen der Sacklochbohrung. Der Abstand sollte der Größe des fertigen Lochs entsprechen.
B) Positionierungsmarken für das Laserbohren werden auf der Schicht L2 / L(N-1) hinzugefügt. Markieren Sie dies auf der Seite MI-Filmwechsel.
C) Die Folie zum Ätzen von Blind-Via-Spots muss von LDI hergestellt werden. Geschnittene Platten und Werkzeuge müssen die LDI-Plattengröße verwenden.
5. Merkmale des Produktionsflusses
A) Wenn die Gesamtzahl der Lagen N beträgt, werden zuerst die L2-L(N-1)-Lagen nach dem normalen Verfahren für die inneren Lagen hergestellt.
B) Nach dem Laminieren und dem Fräsen der Platinenumrisse ändern Sie den Fluss wie folgt:
→ LDI-Registrierlöcher bohren → Film trocknen → Blind-Via-Spots ätzen → Laser bohren → Löcher durchbohren → Kupfer stromlos machen → (normales Verfahren).
6. Andere Anmerkungen
A) RCC-Materialien sind in vielen Fällen nicht UL-zertifiziert. Fügen Sie also vorerst kein UL-Zeichen zu diesen Platten hinzu.
B) Zu Plattenlayout und MI: Um zu vermeiden, dass Layouts, die RCC enthalten, als unechte Platten behandelt werden (die MI-Filmwerkstatt stellt unechte Folien anders her als normale Folien), trennen Sie RCC von L2 oder L(N-1), wenn Sie die Plattenstruktur zeichnen. Siehe zum Beispiel SR2711/01 Plattenaufbau.
C) IPC-6016 ist der Standard für HDI-Platten:
- Laser-Blinddurchgang Wand Kupferstärke: 0,4 mil (min).
- Anforderung an die Lötnaht: Tangentialität ist erlaubt.
- Wenn die Größe des Pads nicht mehr als 5 mil größer ist als der Lochdurchmesser, sollten Sie einen Teardrop hinzufügen.
D) Halten Sie die Plattenkante ≥ 0,8”.
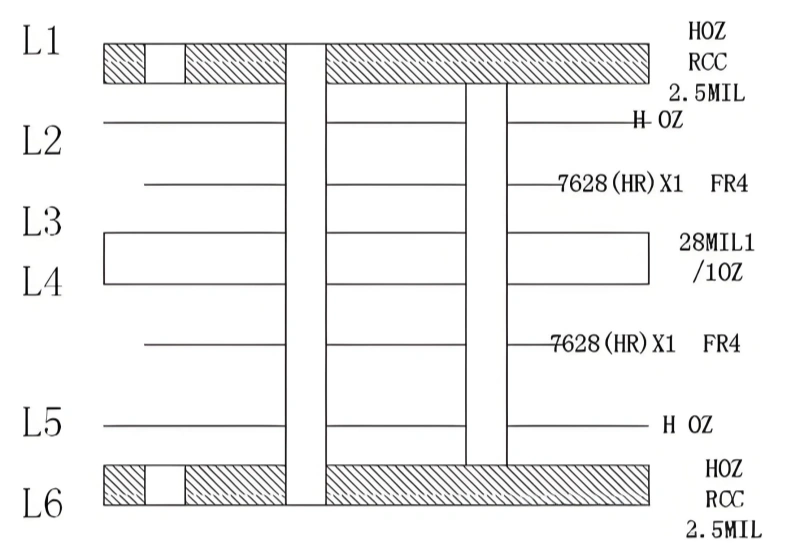
B) Mechanisches Bohren für Blindbohrungen/vergrabene Durchführungen
1. Anwendungsbereich
Wenn die Bohrergröße ≥ 0,20 mm ist, sollten Sie mechanisch bohren.
2. Beschichtungsverfahren für Blind-/Buried Vias (siehe RD-Mitteilung TSFMRD-113)
A) Normalerweise darf die Kupferoberfläche eines Schaltkreises auf jeder Schicht nur einen Plattierungsschritt und einen Musterplattierungsschritt aufweisen.
B) Normalerweise müssen Durchgangslöcher nach Abschluss des vollständigen Laminiervorgangs und bei einer Plattendicke von ≥ 80 MIL mit einer Platte und einem Muster plattiert werden. Daher darf bei der Beschichtung von Blind Vias die Oberfläche der Außenschicht nicht plattiert werden.
C) Wenn die beiden oben genannten Punkte erfüllt sind, wird die Blind-Via-Beschichtung wie folgt durchgeführt:
I) Wenn die Leiterbahnbreite der Außenschicht > 6 MIL und die Dicke der durchkontaktierten Leiterplatte < 80 MIL ist, kann die Oberfläche der Außenschicht während der Blind-Via-Beschichtung mit der Leiterplatte beschichtet werden.
II) Wenn die Leiterbahnbreite der Außenschicht > 6 MIL, die Dicke der Durchgangsbohrung jedoch > 80 MIL ist, muss die Oberfläche der Außenschicht während der Blind-Via-Beschichtung mit einem Film geschützt werden.
III) Wenn die Leiterbahnbreite der Außenschicht < 6 MIL und die Dicke der Durchgangslochplatte ≥ 80 MIL ist, muss die Oberfläche der Außenschicht während der Blind-Via-Beschichtung mit einem Film geschützt werden.
3. Filmverfahren (Lötmaske/Trockenfilm)
- Wenn das Blind-Via-Seitenverhältnis L/D ≤ 0,8 ist, wird ein trockener Film auf die Außenschicht aufgebracht und die gesamte Platte belichtet. Dann werden die Innenflächen der Blindvia-Schichten als ganze Platte stromlos beschichtet.
- Wenn das Blind-Via-Seitenverhältnis L/D > 0,8 ist, bringen Sie einen trockenen Film auf der Außenschicht an und belichten Sie nur die Blind-Via-Punkte. Dazu müssen Sie einen Belichtungsspotfilm herstellen oder LDI-Belichtung verwenden. Dann werden die Blind-Via-Oberflächen der Innenschichten als ganze Platte stromlos beschichtet.
4. Methoden zur Belichtung von Blindgängern
- Für Blind Vias ≤ 0,4 mm (16 MIL) verwenden Sie LDI, um die Blind-Via-Stellen freizulegen.
- Für Blind Vias > 0,4 mm (16 MIL) verwenden Sie einen Film, um die Blind-Via-Stellen zu belichten.
5. Schichtverfahren für vergrabene Durchkontaktierungen
- Wenn die Leiterbahnbreite der Buried-Via-Seite ≤ 4 MIL ist, benötigt die Buried-Via-Oberfläche einen Film, um die Punkte freizulegen.
- Wenn die Leiterbahnbreite der Buried-Via-Seite > 4 MIL ist, kann die Buried-Via-Oberfläche direkt plattiert werden.
6. Anmerkungen und Merksätze
- Für das Seitenverhältnis L/D: L = Dicke des Dielektrikums + Dicke des Kupfers, D = Durchmesser des blinden/vergrabenen Durchgangs.
- Für Blind-/Buried Via-Plating-Filme: Belichtungspunktdurchmesser D_spot = D - 6 (MIL).
- Bringen Sie Ausrichtungsmarkierungen auf dem Belichtungsspotfilm an. Ihre Koordinaten müssen mit den äußeren Referenzlöchern übereinstimmen.
- Blinde Durchkontaktierungen, die mit einer Folie geschützt werden müssen, werden in der Regel während der Galvanisierung mit Impulsstrom (AC) beschichtet.
3. Besondere Anforderungen und Verfahrenshinweise für Blind-via-Platten
- Harzgefüllte Blind Vias:
Bei großen vergrabenen Vias und vielen Löchern kann das Pressen der Leiterplatte viel Harz erfordern, um die Vias zu füllen. Um zu vermeiden, dass sich dies auf die endgültige Plattendicke auswirkt, kann F&E verlangen, dass die vergrabenen Durchkontaktierungen vor dem Laminieren mit Harz gefüllt werden. Die Füllmethode kann der grünen Lötmasken-Via-Füllmethode folgen. - Wenn die äußere Schicht Blind Vias hat:
a. Beim Pressen kann aus der äußeren Schicht Harz austreten. Fügen Sie daher nach dem Laminieren einen Schritt zur Harzentfernung (Entgummierung) hinzu.
b. Vor dem Trocknen der Außenschicht wird die Leiterplattenoberfläche gereinigt und poliert. Chemisches Kupfer (stromloses Kupfer) ist sehr dünn (nur 0,05-0,1 mil), so dass es beim Polieren abgetragen werden kann. Um dies zu vermeiden, fügen Sie einen Schritt der Plattenbeschichtung hinzu, um das Kupfer zu verdicken. Typischer Ablauf: Laminierung → Harzentfernung → Bohren → stromloses Kupfer → Plattenbeschichtung → Trockenfilm → Musterbeschichtung. - Blind-via-Platten mit hoher Lagenzahl und PIN-LAM:
Bei der Herstellung von Leiterplatten mit vielen Lagen und Blind Vias kann die PIN-LAM-Laminierung verwendet werden. Beachten Sie, dass unsere Maschinen nur PIN-LAM-Löcher bohren können, wenn die Kerndicke weniger als 30 MIL beträgt. In vielen Fällen verwenden wir nach wie vor die normale Laminierung; PR4726010 wird zum Beispiel mit normaler Laminierung hergestellt. - Bordkante:
Da es mehrere Laminierungen und viele Bearbeitungslöcher geben kann, lassen Sie den Rand der Platte ≥ 0,8”. - LOT-Karte und Tafelanschrieb:
Beim Schreiben der LOT-Karte müssen Sie für Unterprozesse die Panelstruktur für den einzelnen Unterprozess und die Panelstruktur des Hauptprozesses in die besonderen Anforderungen schreiben. Dies hilft bei späteren Operationen. - Wohin mit der trockenen Blindfolie (innere oder äußere Schicht):
Beispiele: Ist die A-Dicke des Kerns größer als 12 MIL (ohne Kupferdicke), dann legen Sie die Trockenfolie auf die Außenschicht. Wenn die A-Dicke des Kerns weniger als 12 MIL beträgt (ohne Kupferdicke), dann legen Sie die Trockenfolie auf die Innenschicht.
4. Schnelle Erinnerungen und geprüfte Werte
- Halten Sie die Plattenkante ≥ 0,8”.
- Laser blind-via Wand Kupfer ≥ 0,4 mil.
- Bei einem Größenunterschied zwischen Pad und Loch von ≤ 5 mil wird die Verwendung von Teardrops empfohlen.
- Verwenden Sie RCC zum Laserbohren, da RCC den Laser absorbiert.
- Bei der Blind-/Buried-Via-Beschichtung sind die Leiterbahnbreite der Außenschicht und die Gesamtdicke der Leiterplatte zu prüfen, um zu entscheiden, ob die Platte beschichtet oder mit Folie geschützt werden soll.
- L/D = (Dielektrikum + Kupfer) / Lochdurchmesser. Verwenden Sie diesen Wert, um Belichtungs- und Filmverfahren auszuwählen.