Ein Via ist eines der wichtigsten Teile einer mehrlagigen Leiterplatte (PCB). Bei vielen Leiterplatten machen die Bohrkosten etwa 30% bis 40% der Herstellungskosten der Leiterplatte aus. Vereinfacht ausgedrückt, kann jedes Loch auf einer Leiterplatte als Durchkontaktierung bezeichnet werden. Von seiner Funktion her hat ein Via zwei Hauptverwendungen: Zum einen dient es der Herstellung elektrischer Verbindungen zwischen den Schichten, zum anderen der Befestigung oder Lokalisierung von Teilen.
Betrachtet man den Herstellungsprozess, so lassen sich drei Arten von Durchkontaktierungen unterscheiden: Blind Vias, vergrabene Vias und Durchkontaktierungen (Through-Hole-Vias). Ein Blind Via beginnt an der Ober- oder Unterseite der Leiterplatte und geht bis zu einer inneren Schicht. Es hat eine bestimmte Tiefe und wird zur Verbindung von Oberflächenbahnen mit Innenlagenbahnen verwendet. Die Tiefe eines Blind Vias überschreitet in der Regel ein bestimmtes Verhältnis zum Lochdurchmesser nicht. Ein vergrabenes Via ist ein Loch, das nur innere Lagen verbindet; es erreicht keine Oberfläche der Leiterplatte. Sowohl Blind Vias als auch Buried Vias werden vor dem Laminieren im Inneren der Leiterplatte hergestellt und können bei ihrer Herstellung mehrere Innenlagen überlappen. Der dritte Typ ist das Durchgangsloch. Dieses Loch geht ganz durch die Leiterplatte hindurch. Es kann für interne Verbindungen oder als Montage- oder Positionierungsloch für Bauteile verwendet werden. Da Durchkontaktierungen leichter herzustellen und billiger sind, werden sie auf den meisten Leiterplatten anstelle von Blind- oder vergrabenen Durchkontaktierungen verwendet. Im weiteren Verlauf dieses Textes bezieht sich das Wort “Via”, sofern nicht anders angegeben, auf ein Durchgangsloch.
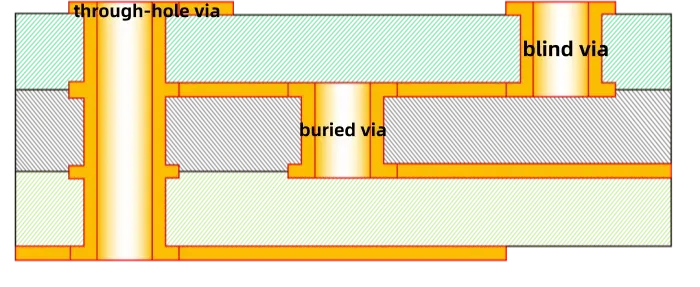
Über die Struktur und warum die Größe wichtig ist
Aus konstruktiver Sicht besteht ein Via aus zwei Hauptteilen. Der eine ist das zentrale Bohrloch. Der andere ist der Pad-Bereich um das Bohrloch herum. Die Größe dieser beiden Teile bestimmt die Größe der Durchkontaktierung. Wenn eine Leiterplatte eine hohe Geschwindigkeit und eine hohe Dichte erfordert, möchten die Designer, dass die Durchkontaktierungen so klein wie möglich sind. Kleine Durchkontaktierungen lassen mehr Platz für das Routing auf der Leiterplatte. Außerdem haben kleinere Durchkontaktierungen eine geringere parasitäre Kapazität, so dass sie sich besser für Hochgeschwindigkeitsschaltungen eignen.
Die Verkleinerung von Vias erhöht jedoch die Kosten. Außerdem kann die Größe der Vias nicht unbegrenzt reduziert werden. Die Grenzen ergeben sich aus den Bohr- und Beschichtungsverfahren. Je kleiner das Loch ist, desto länger dauert das Bohren und desto mehr kann der Bohrer aus der Mitte wandern. Wenn die Bohrtiefe mehr als das Sechsfache des Bohrdurchmessers beträgt, ist es außerdem schwierig, eine gleichmäßige Verkupferung der Lochwand zu gewährleisten. Eine normale sechslagige Leiterplatte hat zum Beispiel eine Dicke (Durchkontaktierungstiefe) von etwa 50 mil. Unter diesen Bedingungen kann der Leiterplattenhersteller in der Regel bis zu einem Mindestdurchmesser von etwa 8 mm bohren.
Parasitäre Kapazität eines Durchgangslochs
Ein Via hat eine parasitäre Kapazität gegen Erde. Wenn wir wissen, dass der Durchmesser des Erdungslochs auf der ebenen Schicht D2 ist, der Durchmesser des Via-Pads D1 ist, die Leiterplattendicke T ist und die Dielektrizitätskonstante des Leiterplattensubstrats ε ist, dann ist die ungefähre parasitäre Kapazität des Vias:
C = 1,41 × ε × T × D1 / (D2 - D1)
Diese Formel liefert eine vernünftige Schätzung für die Durchgangskapazität. Die parasitäre Kapazität verlängert vor allem die Signalanstiegszeit und senkt damit die Geschwindigkeit der Schaltung.
Lassen Sie uns ein konkretes Beispiel verwenden. Nehmen wir an, die Plattendicke beträgt 50 mil. Der Innendurchmesser des Vias beträgt 10 mm und der Durchmesser des Pads 20 mm. Der Abstand zwischen dem Pad und dem geschliffenen Kupferbereich beträgt 32 mil. Unter Verwendung der obigen Formel und der Annahme von ε = 4,4 erhalten wir:
C = 1,41 × 4,4 × 0,050 × 0,020 / (0,032 - 0,020) ≈ 0,517 pF
Dieser Kapazitätsbetrag verändert die Anstiegszeit. Wenn die charakteristische Impedanz 55 Ohm beträgt, ist die durch diese Kapazität verursachte Änderung der 10%-90%-Anstiegszeit ungefähr:
T10-90 = 2,2 × C × (Z0 / 2) ≈ 2,2 × 0,517 × (55 / 2) ≈ 31,28 ps
Anhand dieser Zahlen sehen wir, dass die parasitäre Kapazität eines einzelnen Vias nur einen geringen Einfluss auf die Anstiegszeit hat. Wenn aber ein Signal beim Lagenwechsel viele Durchkontaktierungen durchquert, summiert sich der Effekt. Dann muss der Entwickler sorgfältig darüber nachdenken.
Parasitäre Induktivität eines Durchgangs
Neben der parasitären Kapazität hat ein Via auch eine parasitäre Induktivität. Beim digitalen Hochgeschwindigkeitsdesign ist der Schaden durch die parasitäre Induktivität des Vias oft größer als der durch die parasitäre Kapazität. Die Serieninduktivität des Vias kann die Wirkung von Bypass-Kondensatoren schwächen und die Filterleistung des gesamten Stromversorgungssystems verringern.
Eine einfache Näherungsformel für die Durchgangsinduktivität lautet:
L = 5,08 × h × [ ln(4h / d) + 1 ]
wo:
- L ist die Durchgangsinduktivität,
- h ist die Länge des Durchgangs,
- d ist der mittlere Bohrerdurchmesser.
Aus der Formel geht hervor, dass der Via-Durchmesser nur einen geringen Einfluss auf die Induktivität hat, während die Via-Länge den größten Einfluss hat. Anhand des obigen Beispiels mit h = 0,050 und d = 0,010 erhalten wir:
L = 5,08 × 0,050 × [ ln(4 × 0,050 / 0,010) + 1 ] ≈ 1,015 nH
Wenn die Signalanstiegszeit 1 ns beträgt, ist die äquivalente induktive Reaktanz:
XL = π × L / T10-90 ≈ π × 1,015 nH / 1 ns ≈ 3,19 Ω
Bei hochfrequenten Strömen kann eine Impedanz dieser Größenordnung nicht ignoriert werden. Beachten Sie auch, dass ein Bypass-Kondensator, der die Versorgungslage und die Masselage verbindet, in der Regel zwei Durchkontaktierungen benötigt. Das bedeutet, dass die Durchgangsinduktivität für diesen Bypass-Pfad verdoppelt wird.
Was dies für das Hochgeschwindigkeitsdesign bedeutet
Aus der obigen Analyse der Via-Parasitics geht hervor, dass ein scheinbar einfaches Via bei einer Hochgeschwindigkeitsleiterplatte große negative Auswirkungen haben kann. Um diese Probleme zu verringern, können Designer die folgenden Maßnahmen ergreifen.
- Wählen Sie eine vernünftige Via-Größe
Denken Sie sowohl an die Kosten als auch an die Signalqualität. Für Speichermodul-Leiterplatten mit 6 bis 10 Lagen eignet sich beispielsweise ein 10/20 mil (drill/pad) Via. Für einige kleine Leiterplatten mit hoher Dichte können Sie Durchkontaktierungen mit 8/18 mil wählen. Nach dem heutigen Stand der Technik ist es schwierig, Durchkontaktierungen kleiner als diese zu machen. Für Stromversorgungs- oder Massedurchkontaktierungen sollten Sie größere Größen verwenden, um die Impedanz zu senken. - Verwenden Sie nach Möglichkeit ein dünneres Brett
Wie die Formeln zeigen, hilft eine dünnere Platine, sowohl die Durchgangskapazität als auch die Induktivität zu verringern. - Vermeiden Sie unnötige Ebenenwechsel
Versuchen Sie, Signale ohne Lagenwechsel zu leiten. Mit anderen Worten: Verwenden Sie so wenig Durchkontaktierungen wie möglich. - Platzieren Sie Strom- und Erdungsstifte in der Nähe von Durchkontaktierungen
Bringen Sie Stromversorgungs- und Erdungsstifte nahe an ihren Durchkontaktierungen an. Halten Sie die Leitungen zwischen dem Via und dem Stift so kurz wie möglich, da lange Leitungen die Induktivität erhöhen. Verwenden Sie dickere Leiterbahnen für Strom und Masse, um die Impedanz zu senken. - Platzieren Sie Erdungsvias in der Nähe von Signalschichtwechsel-Vias
Legen Sie Massebohrungen in der Nähe von Bohrungen an, an denen Signale die Schicht wechseln. Dadurch erhält das Signal einen nahe gelegenen Rückweg. Sie können bei Bedarf auch viele zusätzliche Massebohrungen einfügen. Seien Sie jedoch flexibel. Das zuvor besprochene Via-Modell geht von einem Pad auf jeder Lage aus. In manchen Fällen können Sie Pads auf einigen internen Lagen reduzieren oder entfernen. Wenn die Via-Dichte sehr hoch ist, können große Pads auf einem Kupferguss eine unterbrochene Schleife bilden. Um dies zu beheben, können Sie einige Durchkontaktierungen verschieben oder die Größe der Pads auf bestimmten Lagen verringern.
Via-Design für Hochgeschwindigkeits-Leiterplatten - praktische Vorschläge
Hochgeschwindigkeits-Leiterplatten bestehen in der Regel aus mehreren Lagen, und Durchkontaktierungen sind ein wichtiger Faktor im Design. Ein Durchkontaktierungsloch in einer Leiterplatte besteht aus drei Teilen: dem Loch selbst, dem Pad um das Loch herum und der Isolationszone der Stromversorgungsebene (der Abstand auf den Stromversorgungs- und Erdungsebenen um das Durchkontaktierungsloch).
Hier einige praktische Hinweise für Hochgeschwindigkeits-Multilayer-Platten:
- Über Größenempfehlungen
Für allgemeine mehrlagige Leiterplatten mit mäßiger Dichte ist eine Durchkontaktierung mit den Abmessungen 0,25 mm / 0,51 mm / 0,91 mm (Bohrer / Pad / Leistungsisolierung) eine gute Wahl. Für Leiterplatten mit hoher Dichte können 0,20 mm / 0,46 mm / 0,86 mm verwendet werden. In einigen Designs können nicht plattierte Durchkontaktierungen verwendet werden. Für Stromversorgungs- oder Erdungsdurchführungen sollten Sie größere Abmessungen in Betracht ziehen, um die Impedanz zu senken. - Stromtrennungszone
Je größer der Bereich der Leistungsisolierung ist, desto besser. Berücksichtigen Sie die Durchkontaktierungsdichte auf der Ebene. Häufig wird D1 = D2 + 0,41 als Richtwert verwendet, d. h. der Pad-Durchmesser entspricht dem Durchmesser des Ebenenabstandes plus 0,41 mm. Dies trägt dazu bei, dass der Abstand zur Ebene groß genug ist. - Ebenenwechsel minimieren
Reduzieren Sie Durchkontaktierungen, indem Sie unnötige Lagenwechsel beim Signalrouting vermeiden. - Dünnere Bretter verwenden
Dünnere Leiterplatten verringern sowohl die Kapazität als auch die Induktivität von Durchkontaktierungen. - Kurze und breite Strom-/Masseanschlüsse
Halten Sie die Leitung vom Via zum Stromversorgungs- oder Erdungsstift kurz. Verlegen Sie die Leiterbahnen für Strom oder Masse so breit wie möglich, um die induktive Impedanz zu verringern. - Erdungsvias in der Nähe von Schichtwechsel-Vias
Fügen Sie Erdungslöcher in der Nähe von Löchern ein, an denen ein Signal zwischen den Schichten verläuft. Dadurch erhält das Signal einen kurzen Rückweg.
Beachten Sie auch, dass die Via-Länge ein wichtiger Faktor für die Via-Induktivität ist. Bei Durchkontaktierungen in der oberen und unteren Lage entspricht die Via-Länge der gesamten Plattendicke. Mit zunehmender Lagenzahl kann die Plattendicke 5 mm überschreiten. Bei Hochgeschwindigkeitsdesigns wird die Via-Länge in der Regel unter 2,0 mm gehalten, um durch Vias bedingte Probleme zu verringern. Bei Via-Längen von mehr als 2,0 mm kann eine Vergrößerung des Via-Durchmessers helfen, die Impedanzkontinuität wiederherzustellen. Wenn die Via-Länge 1,0 mm oder weniger beträgt, ist der beste Via-Durchmesser etwa 0,20 mm bis 0,30 mm.
Backdrilling in der PCB-Produktion
1. Was ist Backdrilling?
Backdrilling ist ein spezieller Bohrschritt, der bei Deep-Hole-Boards verwendet wird. Bei der Herstellung einer 12-Lagen-Platine möchten wir zum Beispiel die Lage 1 mit der Lage 9 verbinden. Normalerweise bohren wir einmal ein Durchgangsloch und dann eine Platte. Die Durchkontaktierung verläuft dann von Lage 1 zu Lage 12, aber wir brauchen nur eine Verbindung zwischen Lage 1 und Lage 9. Der zusätzliche Abschnitt von Schicht 10 bis Schicht 12 wirkt wie eine Stichleitung. Diese Stichleitung beeinträchtigt die Signalwege und kann bei Kommunikationssignalen zu Problemen mit der Signalintegrität führen. Um diesen zusätzlichen Stummel zu entfernen, bohren wir ihn von der Rückseite aus auf - ein zweiter Bohrschritt. Dies wird als Backdrilling bezeichnet. In der Praxis bohren die Hersteller nicht jeden einzelnen Stummel heraus, da bei späteren Schritten etwas Kupfer entfernt wird und der Bohrer eine verjüngte Spitze hat. Daher lässt der Hersteller in der Regel einen sehr kleinen Stummel übrig. Die verbleibende Stumpflänge wird als B-Wert bezeichnet, und ein guter B-Wert liegt normalerweise zwischen 50 μm und 150 μm.
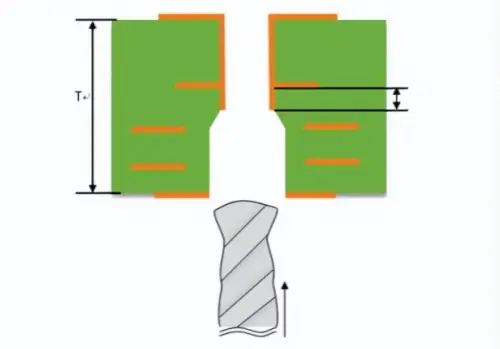
2. Warum rückwärts bohren?
Backdrilling bietet mehrere Vorteile:
- Es reduziert Rauschen und Störungen.
- Sie verbessert die Signalintegrität.
- Es kann einen lokalen Bereich der Platte dünner machen.
- Es reduziert den Bedarf an vergrabenen oder blinden Durchkontaktierungen und verringert so die Komplexität der Leiterplatte.
3. Was bewirkt das Backdrilling?
Beim Backdrilling wird der Via-Abschnitt entfernt, der nicht zur Verbindung oder Signalübertragung beiträgt. Dadurch werden Reflexionen, Streuungen, Verzögerungen und andere Effekte, die Signalverzerrungen verursachen, vermieden. Die Forschung zeigt, dass Durchkontaktierungen neben dem Design, dem Leiterplattenmaterial, den Übertragungsleitungen, den Steckverbindern und der Chipverpackung einen großen Einfluss auf die Signalintegrität haben.
4. Funktionsprinzip des Backdrilling
Beim Backdrilling wird ein Bohrer verwendet, der durch Abtasten der Leiterplattenoberfläche positioniert wird. Wenn die Bohrerspitze die Kupferfolie auf der Leiterplattenoberfläche berührt, wird ein Mikrostrom erzeugt. Dieser Strom teilt der Maschine die Höhe der Leiterplattenoberfläche mit. Die Maschine bohrt dann bis zur eingestellten Tiefe und hält dann an.
5. Backdrilling-Prozessschritte
Ein typischer Backdrilling-Prozess kann folgendermaßen ablaufen:
a. Versehen Sie die Leiterplatte mit Passbohrungen. Verwenden Sie diese Löcher für den ersten Bohrschritt (die Durchgangsbohrung).
b. Nach der ersten Bohrung werden die Löcher beschichtet. Verwenden Sie vor der Beschichtung eine trockene Folie, um die Registrierungslöcher zu schützen, falls erforderlich.
c. Erstellen Sie das Muster der äußeren Schicht auf der beschichteten Platte.
d. Führen Sie die Musterplattierung durch. Behandeln Sie vor der Musterplattierung die Registrierlöcher erneut mit Trockenfilm, falls erforderlich.
e. Verwenden Sie die Passbohrungen aus der ersten Bohrung, um die Platte zum Nachbohren zu positionieren. Verwenden Sie einen Bohrer, um die plattierten Abschnitte, die nachgebohrt werden müssen, wegzubohren.
f. Waschen Sie nach dem Hinterbohren die hinterbohrten Löcher, um Bohrstaub und Rückstände zu entfernen.
6. Technische Merkmale von hinterbohrten Platten
Typische technische Merkmale sind:
- Die meisten hinterbohrten Platten sind starre Platten.
- Die Anzahl der Schichten liegt in der Regel zwischen 8 und 50 Schichten.
- Die Plattenstärke beträgt oft 2,5 mm oder mehr.
- Das Verhältnis von Dicke zu Durchmesser ist relativ groß.
- Die Bretter sind groß.
- Der anfängliche Mindestdurchmesser des Bohrers beträgt in der Regel ≥ 0,3 mm.
- Es gibt nur wenige Leiterbahnen auf der Außenlage; die Platine verwendet häufig eine Quetschanordnung für Einpresslöcher.
- Backdrill-Löcher sind in der Regel 0,2 mm größer als die zu entfernenden Löcher.
- Die Toleranz der Bohrtiefe beträgt etwa ±0,05 mm.
- Wenn das Backdrilling bis zur Schicht M reichen muss, dann muss die dielektrische Dicke von Schicht M bis Schicht M-1 mindestens 0,17 mm betragen.

7. Typische Anwendungen für hinterbohrte Platten
Hinterbohrte Leiterplatten werden hauptsächlich in Bereichen eingesetzt, die eine sehr gute Signalintegrität und große Strukturen erfordern. Häufige Bereiche sind Kommunikationsgeräte, große Server, medizinische Elektronik, Militär und Luft- und Raumfahrt. Da es sich bei Militär und Luft- und Raumfahrt um sensible Bereiche handelt, werden Backplanes für diese Bereiche oft von Forschungsinstituten, F&E-Zentren oder Leiterplattenherstellern mit einem starken Hintergrund in diesen Bereichen hergestellt. In China kommt der größte Teil der Nachfrage nach Backplanes aus der Kommunikationsindustrie, die schnell wächst.
Zusammenfassung
Kurz gesagt, Durchkontaktierungen sind einfach, aber wichtig. Sie verbinden Schichten, und sie fügen auch parasitäre Kapazitäten und Induktivitäten hinzu. Diese Störgrößen beeinflussen sowohl die Signalanstiegszeit als auch die Funktionsfähigkeit von Bypass-Kondensatoren. Die Länge der Durchkontaktierung bestimmt hauptsächlich die Induktivität. Via-Größe, Pad-Größe und Abstand beeinflussen die Kapazität. Für Hochgeschwindigkeitsdesigns sollten Sie die folgende Checkliste verwenden:
- Wählen Sie eine Größe, die der Plattendichte und den Kosten entspricht. Für viele Leiterplatten sind 10/20 mil gut; für dichtere Leiterplatten sollten Sie 8/18 mil wählen. Für Stromversorgungs-/Masse-Durchkontaktierungen sollten Sie größere Größen wählen.
- Verwenden Sie nach Möglichkeit eine dünne Platine. Dies reduziert die Durchgangsparasitik.
- Vermeiden Sie unnötige Ebenenwechsel. Behalten Sie das Routing nach Möglichkeit auf derselben Ebene.
- Legen Sie Stromversorgungs- und Erdungsstifte in die Nähe von Durchkontaktierungen und halten Sie die Verbindungen kurz und breit.
- Fügen Sie in der Nähe von Signaldurchkontaktierungen, die die Lage wechseln, Erdungslöcher ein, um einen kurzen Rückweg zu schaffen.
- Bei langen Durchkontaktierungen oder tiefen Leiterplatten sollten Sie das Backdrilling in Betracht ziehen, um Stubs zu entfernen, die Hochgeschwindigkeitssignale beeinträchtigen.
- Wenn die Via-Dichte sehr hoch ist, sollten Sie die Größe der Pads auf einigen internen Lagen reduzieren, um ein Brechen der Kupferschichten zu vermeiden.
Befolgen Sie diese Regeln und denken Sie an das gesamte System, nicht nur an ein einzelnes Via. Beim Hochgeschwindigkeitsdesign summieren sich die kleinen Details. Durch eine sorgfältige Planung der Durchkontaktierung wird Ihre Leiterplatte besser funktionieren, das Risiko reduziert und später bei der Fehlersuche Zeit gespart.




