1. Panorama reciente del problema de las fugas de PCB
Recientemente nos hemos enfrentado a un problema de fugas en la placa de circuito impreso. El producto es de bajo consumo. Todo el dispositivo consume normalmente una corriente de nivel de microamperios (µA). Tras un tiempo de envejecimiento a temperatura normal, observamos que su consumo de energía aumentaba. Algunas muestras alcanzaron incluso el nivel de miliamperios (mA).
Descartamos cuidadosamente los fallos de los componentes. Al final encontramos un nodo de 5 V. Cuando el producto estaba en reposo, este nodo debería ser de 0 V, pero tenía una caída de 1,8 V.
Cortamos cuidadosamente las trazas de la PCB. Para nuestra sorpresa, se podían medir dos vías que no tenían conexión eléctrica en la placa de circuito impreso y mostraban una resistencia de varios cientos de ohmios entre ellas. Comprobamos los archivos de diseño. Se trata de una placa de dos capas. Espaciado entre vías y entre pads > 6 mil. Espaciado entre orificios y paredes > 18 mil. Este diseño es normal para el taladrado estándar en la industria de las placas de circuito impreso.
Retiramos la máscara de soldadura para descartar contaminación conductiva en la máscara o en la superficie de la vía. La resistencia medida entre las vías seguía existiendo. Durante un tiempo no pudimos explicarlo. Entonces descubrimos que la fuga estaba causada por el “efecto CAF”.”
2. Qué es el CAF
CAF significa Filamentación Anódica Conductiva. Se trata de un comportamiento de fuga dentro de un circuito impreso en el que los iones de cobre se desplazan desde el ánodo (tensión más alta) a lo largo de canales de microfisuras entre fibras de vidrio hacia el cátodo (tensión más baja). Durante este proceso, el cobre y las sales de cobre provocan fugas.
En la imagen, tras esmerilar longitudinalmente dos vías adyacentes y observarlas con un microscopio electrónico a 100×, el laminado parece oscuro. Las zonas doradas brillantes son de cobre. Se pueden ver manchas de cobre y filamentos de cobre entre las dos vías.
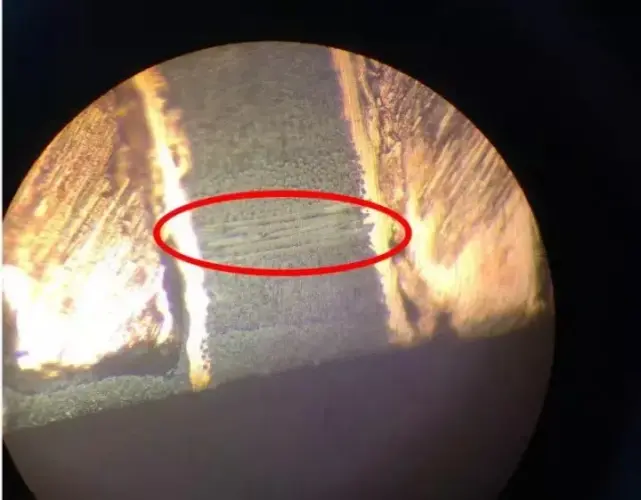
3. Cómo se forma el CAF (mecanismo)
Normal fr4 Laminado PCB se fabrica tejiendo fibras de vidrio en forma de tela, mojándolas después con resina epoxi y semicurándolas. Si la adherencia entre la resina y la fibra de vidrio es deficiente, o la resina no moja completamente el vidrio, pueden aparecer huecos entre ellas. Durante el procesamiento mecánico, como el taladrado, la tracción tangencial y el choque axial pueden dañar aún más la unión de la resina. Esto puede aflojar o separar los haces de fibras y crear huecos.
Cuando el ambiente es cálido y húmedo, la adherencia entre el epoxi y la fibra de vidrio se degrada más. Los agentes de acoplamiento de silano en la superficie de la fibra de vidrio pueden hidrolizarse. Esto crea caminos a lo largo del refuerzo de fibra de vidrio que permiten la migración de electrones.
En estas condiciones, si dos vías cercanas tienen una diferencia de potencial, el cobre del ánodo de mayor tensión puede oxidarse y convertirse en iones de cobre. Bajo el campo eléctrico, los iones de cobre se desplazan hacia el cátodo de menor tensión. Durante la migración, se combinan con iones de impureza en el laminado o con OH- para formar sales conductoras insolubles, que se depositan. Como resultado, la separación eléctrica entre las dos vías aislantes disminuye bruscamente. En casos graves, pueden incluso formar una vía conductora directa y provocar un cortocircuito.
Reacciones en el ánodo y el cátodo (según lo observado):
Ánodo:
Cu → Cu²⁺ + 2 e-
H₂O → H⁺ + OH-.
Cátodo:
2 H⁺ + 2 e- → H₂
Cu²⁺ + 2 OH- → Cu(OH)₂
Cu(OH)₂ → CuO + H₂O
CuO + H₂O → Cu(OH)₂ → Cu²⁺ + 2 OH-.
Cu²⁺ + 2 e- → Cu
4. Notas de nuestra experiencia
Antes de saber que la causa era CAF, estábamos desconcertados por la resistencia entre dos vías aisladas. Tras buscar en la bibliografía, descubrimos que muchos compañeros habían sufrido el mismo problema. El CAF se ha convertido en un notable problema de fiabilidad en la industria de las placas de circuito impreso.
5. Cómo prevenir o reducir el CAF
Mejorar la resistencia del laminado a CAF. Para el proceso de sustrato de PCB, aumentar la pureza iónica del material. Utilizar resinas de baja absorción de humedad. Asegúrese de que la tela de vidrio esté totalmente humedecida por la resina y se adhiera bien.
Tenga cuidado con los procesos de taladrado o láser. La perforación o el láser pueden producir un elevado calor local. Si la temperatura supera la Tg de la placa, la resina puede fundirse y formar residuos. Los residuos en las paredes de los orificios pueden provocar un mal contacto durante el metalizado. Por lo tanto, elimine los residuos antes del metalizado. Nota: el remojo durante la eliminación de residuos puede erosionar los orificios pasantes y provocar contaminación por cobre, lo que puede facilitar la posterior migración del cobre.
Aumentar la distancia entre vías en Diseño de PCB. Además, los canales CAF suelen seguir el mismo haz de fibra de vidrio. Escalonar o desplazar las vías vecinas ayuda a reducir el riesgo de CAF.
Limpie las superficies de los PCBA. Por ejemplo, utilice una pistola de aire a alta presión para eliminar el polvo y evitar residuos de impurezas que podrían provocar una electroquímica no deseada. Aplique un revestimiento de conformación a la superficie del PCBA para evitar la entrada de humedad, especialmente en entornos cálidos y húmedos.




