A continuación figura la traducción al inglés. He utilizado una redacción clara y sencilla y palabras de enlace básicas (and, but, so, then, because). Mantuve la precisión de los términos técnicos y las cifras. El texto es largo (más de 1.800 palabras), como usted solicitó.
Proceso básico de fabricación de tarjetas HDI con vías ciegas y enterradas
1. Visión general
HDI son las siglas de High Density Interconnect (interconexión de alta densidad). Es una tecnología de PCB que surgió a finales del siglo XX. La principal ventaja es el uso del taladrado láser. El taladrado mecánico tradicional está limitado por las brocas. Cuando el tamaño del agujero alcanza los 0,15 mm, el coste aumenta mucho y la optimización es difícil. Los orificios láser de HDI pueden ser de sólo 3-5 mil (0,076-0,127 mm). La anchura del trazo puede ser de 3-4 mil (0,076-0,10 mm). El tamaño de los pads es mucho menor. Caben más trazas en la misma superficie. Esto permite realizar interconexiones de alta densidad.
HDI permite a los diseñadores utilizar paquetes densos como BGA y QFP. El HDI de primer nivel es común ahora para BGA con paso de 0,5. A medida que el encaminamiento de los BGA pasa del escape de esquina al escape central, el primer nivel IDH ya no puede satisfacer algunas necesidades. La IDH de segundo nivel se convierte en el centro de atención de la I+D y la producción. Las vías ciegas láser HDI de primer nivel sólo conectan la superficie con la capa interna adyacente. El HDI de segundo nivel puede perforar desde la superficie hasta la tercera capa, o desde la superficie a través de la segunda capa hasta la tercera capa. Esto es mucho más difícil que el HDI de primer nivel.
2. Materiales
2.1 Tipos de material
- Lámina de cobre: el material básico con el que se fabrican los patrones conductores.
- Núcleo (CORE): la columna vertebral de la placa. Es una placa revestida de cobre de doble cara que se utiliza para hacer capas internas.
- Prepreg: lámina de resina semicurada que se utiliza como pegamento para placas multicapa y como aislante.
- Tinta de máscara de soldadura: se utiliza para la máscara de soldadura, el aislamiento y la protección contra la corrosión.
- Tinta de leyenda (serigrafía): se utiliza para marcas y etiquetas.
- Materiales de acabado superficial: incluyen aleaciones de estaño-plomo, níquel-oro, plata, OSP, y otros.
2.2 Materiales aislantes laminados
2.2.1 Laminados comunes
Entre los materiales comunes de alta Tg se incluyen MICA/EG-150T, SYST/S1141, Grace/MTC-97 y HITACHI/MCL-HD-67. Se utilizan cuando se necesita una mayor resistencia al calor.
2.2.2 Materiales aislantes específicos para IDH
Tipos y especificaciones habituales:
- Materiales RCC: 80T18, 60T12, 65T12, 80T12, 60T18.
- fr4 (LDP): 1080, 106.
Nota: He utilizado “fr4” para FR-4 como prefieras.
2.3 Material especial: CCR explicado
RCC significa Resin Coated Copper (cobre recubierto de resina). Se trata de una lámina de cobre recubierta con una película de resina especial. La película cubre totalmente las trazas interiores y actúa como aislante. El RCC se presenta principalmente en dos tipos: Etapa B (Mitsui) y Etapa B+C (Polyclad).
Características principales:
- No hay capa de fibra de vidrio en la película de resina. Esto facilita la formación de microvías mediante láser o plasma.
- Capa dieléctrica fina y alta resistencia al pelado.
- Buena tenacidad y superficie lisa, buena para grabar trazos muy estrechos.
- Los taladros láser para HDI se realizan a menudo en CCR. Los orificios láser tienen forma de trapecio invertido, no de cilindro como los orificios mecánicos. El tamaño típico de los orificios es de 0,076-0,10 mm.
Otros materiales de IDH (núcleo, preimpregnado, láminas de cobre) no son especiales. Normalmente, el grosor del cobre interior es fino: capas interiores de 1 onza, capas exteriores de 0,5 onzas de cobre base chapado a 1 onza. Toda la placa es más fina. Como el RCC no tiene fibra de vidrio, su dureza y resistencia son inferiores a las de otros PCB del mismo grosor.
3. Proceso de fabricación (ejemplo: placa de ocho capas 2+4+2)
A continuación enumero los pasos principales y los puntos clave. Utilizo palabras sencillas y un orden claro.
3.1 Corte de la materia prima (CUT)
El corte convierte grandes planchas revestidas de cobre en tamaños que se adaptan a las máquinas de producción. Hay que tener claros tres conceptos básicos:
- UNIDAD: una unidad de diseño en la maqueta del cliente.
- CONJUNTO: varias UNIDADES unidas, incluido el borde de proceso y el utillaje.
- PANEL: varios SETs unidos con bordes de herramientas para hacer un panel de producción. Los tamaños más comunes son 36,5 × 48,5 pulgadas, 40,5 × 48,5 pulgadas y 42,5 × 48,5 pulgadas. El rendimiento depende del diseño y del uso del panel.

3.2 Proceso de película seca de capa interior (INNER DRY FILM)
El paso de película seca interior transfiere los patrones de la capa interior. Los pasos incluyen la laminación de la película fotorresistente, la exposición, el revelado, el grabado y el decapado:
- Laminado: pegar una película fotosensible sobre el cobre. La luz endurece las partes expuestas para formar una capa protectora.
- Exponer y revelar: exponer la película. Las partes iluminadas se endurecen. Las partes oscuras permanecen blandas. El revelado elimina la película blanda.
- Grabado y decapado: grabe el cobre expuesto. A continuación, se retira la película protectora endurecida. Se forman las trazas de la capa interna.
Consejos de diseño: controle la anchura mínima de las trazas, el espaciado y la uniformidad. Si el espaciado es demasiado pequeño, puede producirse un cortocircuito durante el laminado. Si las trazas son demasiado finas, la adherencia de la película puede fallar y las trazas abrirse. Deje márgenes de seguridad para la producción.
3.3 Oxidación negra o marrón (OXIDACIÓN NEGRA)
Una vez realizados los trazos interiores, realice una oxidación negra o marrón antes de la laminación. Objetivos principales:
- Eliminar el aceite y los contaminantes de la superficie de cobre.
- Aumenta la superficie de cobre para mejorar la adhesión a la resina.
- Convertir la superficie de cobre no polar en CuO y Cu₂O polares para mejorar el enlace químico.
- Mejoran la resistencia a la humedad a alta temperatura y reducen el riesgo de delaminación entre el cobre y la resina.
Si el producto principal es Cu₂O, se denomina oxidación marrón (color rojo). Si el producto principal es CuO, se denomina oxidación negra (color negro).
3.4 Laminación (PRENSADO)
La laminación une todas las capas utilizando preimpregnado de fase B. Pasos principales:
- Apilado: disponga las láminas de cobre, el preimpregnado, los núcleos interiores, las placas de acero inoxidable, las placas separadoras, el papel kraft y las placas de prensa exteriores. Para placas con seis o más capas, es necesario el apilado previo.
- Prensa caliente: se coloca la pila en una prensa caliente al vacío. El calor funde la resina y une la pila, rellenando los huecos.
Consejos: mantenga la laminación simétrica. Si la tensión no está equilibrada en ambos lados, se producirá alabeo. Controle la distribución del cobre para evitar diferencias de flujo de resina que provoquen espesores desiguales. Planifique con antelación las vías ciegas y enterradas.
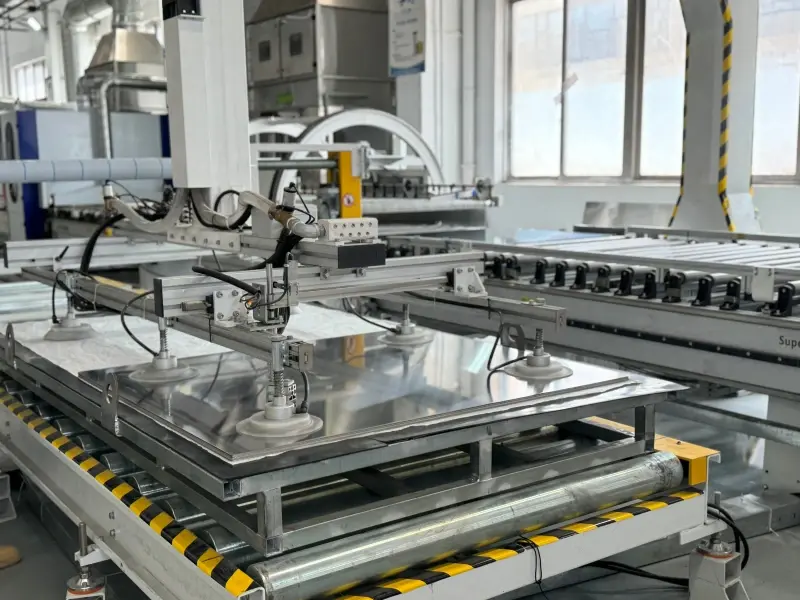
3.5 Perforación de vías ciegas y enterradas (DRILLING)
En la producción de placas de circuito impreso, el taladrado mecánico es el método principal para agujeros pasantes de más de 8 mil aproximadamente. El taladrado mecánico determina dónde no pueden cruzarse las vías ciegas y enterradas. En una placa de ocho capas, por ejemplo, se pueden crear vías enterradas para las capas 3-6, vías ciegas para las capas 1-2 y vías ciegas para las capas 7-8 al mismo tiempo. Pero no se pueden diseñar vías enterradas que se crucen, como las de las capas 3-5 y 4-6, porque no se pueden hacer. Los patrones de vías enterradas asimétricas (como 3-5 y 4-6) aumentan enormemente la dificultad y la tasa de desechos. El coste puede ser seis veces superior al de las vías enterradas simétricas.

3.6 Deposición y revestimiento de cobre (vía metalización)
La metalización por vía cubre la pared del orificio perforado con cobre uniforme y resistente al calor. Tres pasos:
- Eliminar los restos del taladro.
- Deposición química de cobre.
- Galvanoplastia completa para espesar el cobre.
Parámetro clave: relación de aspecto (grosor del cartón/diámetro del orificio). A medida que aumenta el grosor de la placa y disminuye el diámetro del orificio, los productos químicos no pueden llegar fácilmente al centro del orificio. Esto puede hacer que el metalizado sea fino en el centro y provocar fallos de microapertura. Los diseñadores deben conocer los límites del proceso de la fábrica de placas. Tanto las vías ciegas/enterradas como los orificios pasantes deben tener en cuenta los límites de la relación de aspecto.
3.7 Película seca de segunda capa interior
Después de metalizar las vías enterradas para las capas 3-6, rellene los agujeros con tinta de resina y vuelva a los pasos de la película seca interior para hacer las trazas de las capas 3 y 6. Una vez terminadas, vuelva a realizar la oxidación negra/marrón y, a continuación, envíe a realizar una segunda laminación. Esta segunda laminación sigue el mismo proceso que la primera.
3,8 Segunda laminación (prensa HDI)
Los tableros HDI tienen capas aislantes finas, por lo que el prensado es más difícil. Para el mismo grosor, la resistencia del LDP es mejor que la del RCC. El LDP fluye más lentamente, por lo que el control es más fácil.
Notas de diseño:
- En las zonas interiores con vías ciegas/enterradas, las trazas exteriores deben evitar las ubicaciones de las vías para evitar circuitos abiertos causados por depresiones.
- Demasiadas vías enterradas entre la segunda y la penúltima capa pueden crear canales que diluyan el dieléctrico. Reduzca estas vías siempre que sea posible.
Para las vías ciegas de CO₂ de HDI, un método común es la técnica de máscara conformada. Se transfieren los patrones al cobre exterior, se graban pequeñas ventanas que coincidan con las posiciones de las vías láser y, a continuación, se utiliza un láser de mayor potencia en esas coordenadas. Esto es adecuado para la fabricación sustractiva multicapa.
3.9 Máscara conformada (láser mediante preprocesado)
La máscara conformada tiene dos partes: Máscara conforme1 y Máscara conforme2:
- Máscara conformada1: almohadillas de grabado que se alinean con la vía ciega a ambos lados de la subplaca y objetivos de alineación de grabado para la máquina de autoexposición. Esto facilita el procesamiento posterior y el taladrado láser.
- Máscara conformada2: grabar ventanas en el cobre superior e inferior de la placa que sean ligeramente más grandes que el orificio del láser. Esto prepara para el procesamiento láser de CO₂.
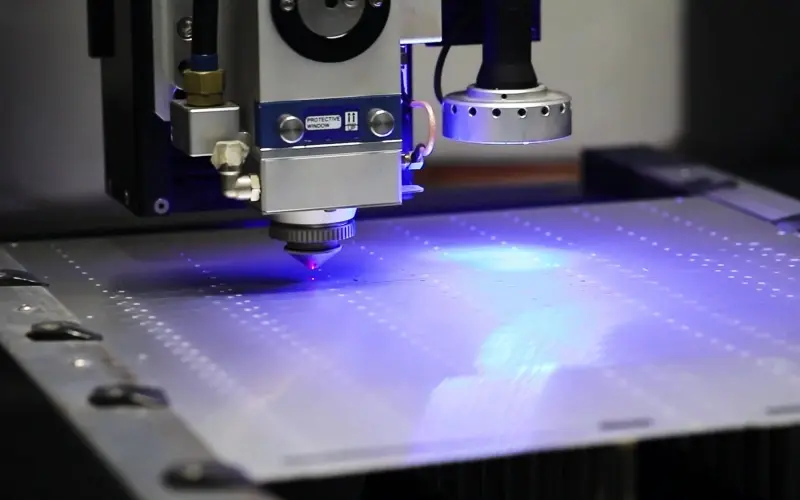
3.10 Taladrado láser (LASER DRILLING)
El taladrado láser utiliza energía láser para quemar resina y formar vías ciegas. La energía láser decae de arriba abajo, por lo que el diámetro del orificio se reduce con la profundidad. El tamaño típico de los orificios es de 0,10-0,15 mm (4-6 mil). Según IPC6016, los orificios ≤0,15 mm se denominan microvías.
Los agujeros de más de 0,15 mm necesitan perforación en espiral. La velocidad disminuye y el coste aumenta rápidamente. Las herramientas láser convencionales utilizan ahora el taladrado de tres disparos. La velocidad es de 100-200 agujeros por segundo. Los agujeros más pequeños pueden ser más rápidos (agujero de 0,100 mm ~120 agujeros/seg; agujero de 0,076 mm ~170 agujeros/seg).
3.11 Metalización por láser
Los orificios láser queman la pared del orificio y dejan carbonilla. La segunda capa de cobre puede oxidarse. Se necesita un lavado con agua a alta presión para eliminar los residuos de perforación. La carbonilla de la microvía es difícil de eliminar. El HDI apilado de dos niveles necesita un revestimiento especial de la vía ciega y un relleno de cobre (RELLENO DE COBRE). Esto es costoso y se utiliza para productos de gama alta.
3.12 Tercera película seca interior
Después de la metalización por láser, hacer una segunda máscara Conformal1. A continuación, volver a los pasos de película seca interior para hacer las capas 2 y 7 trazas. Después de hacer las trazas, hacer la oxidación negro/marrón y una tercera laminación. A continuación, hacer la tercera ciega a través de etch paso 1 y la segunda ciega a través de etch paso 2 para prepararse para la segunda perforación láser.
El IDH de segundo nivel necesita muchas alineaciones. Los errores pueden acumularse. Esto hace que la tasa de desechos sea mayor. De más fácil a más difícil en combinaciones de vías:
1-2 + 2-3 vías < sólo 1-3 vías < 1-2 + 1-3 vías < 2-3 + 1-3 vías < 1-2 + 2-3 + 1-3 vías.
Las vías HDI deben diseñarse simétricamente.
3.13 Segunda perforación láser
Realice el segundo paso de perforación láser según lo previsto para HDI de dos niveles. Sigue reglas similares a las del primer taladrado láser, pero requiere una cuidadosa alineación y planificación de la vía.
3.14 Taladrado mecánico (taladrar agujeros pasantes)
Después de los pasos del láser, realice el taladrado mecánico para los agujeros pasantes. Este paso taladra agujeros que atraviesan todo el panel.
3.15 Eliminación de residuos de perforación y revestimiento por vía (P.T.H)
Chapar las vías ciegas y los agujeros pasantes juntos para que todas las vías estén metalizadas. En este punto finaliza el flujo especial de IDH. A partir de este momento, la placa sigue los pasos estándar de acabado de PCB.
3.16 Film seco de capa exterior y metalizado de patrones (FILM SECO & CHAPADO DE PATRONES)
La transferencia del patrón exterior es similar a la de las capas interiores. La principal diferencia es el método de chapado:
- Método sustractivo: utilizar película negativa. La película seca endurecida queda como circuito. Grabe y pele la película para mantener el circuito.
- Método aditivo/normal: utilizar película positiva. La película seca endurecida cubre las zonas sin circuito. Realice un chapado de patrón (cobre y luego estaño), luego retire la película, realice un grabado alcalino, retire el estaño y conserve el circuito.
3.17 Máscara de soldadura de película húmeda (WET FILM SOLDER MASK)
La máscara de soldadura recubre la superficie de la placa. Evita que una soldadura incorrecta, la humedad o los productos químicos provoquen cortocircuitos, y protege las trazas de daños físicos. Esto mantiene estable el funcionamiento de la placa de circuito impreso.
Proceso: prelimpieza → recubrimiento → prehorneado → exposición → revelado → curado UV → curado térmico. Puntos clave de control: alineación de la máscara de soldadura, tamaño del puente de la máscara, producción de vías y grosor de la máscara. La calidad de la tinta afecta al acabado superficial posterior, al montaje SMT y a la vida útil de la placa.
3.18 Oro selectivo por inmersión (IMMERSION GOLD)
El niquelado/dorado químico es un acabado superficial posterior a la máscara de soldadura. Es adecuado para placas de circuito impreso con un paso de traza pequeño y muchas piezas de montaje superficial. Favorece la coplanaridad y planitud de los pads. El oro es estable y protector. Especificaciones del chapado: níquel ~5 μm, oro 0,05-0,1 μm. El oro demasiado grueso puede agrietarse y debilitar las juntas de soldadura. El oro demasiado fino ofrece poca protección. ENIG es menos soldable en algunos casos y puede mostrar defectos oscuros en las almohadillas.
3.19 Impresión de leyendas (IMPRESIÓN C/M)
Imprima las leyendas y marcas con tinta para leyendas. Esto facilita el montaje y el mantenimiento posteriores.
3.20 Fresado y perfilado (PROFILING)
Cortar el panel acabado a tamaño UNIT o SET con fresadoras CNC. Realice el recorte de bordes y el fresado de ranuras. Si es necesario el corte en V, añada los pasos correspondientes. Parámetros clave: tolerancia del perfil, tamaño del chaflán, radio de la esquina interior. Deje una distancia de seguridad entre los patrones y el borde del tablero.
3.21 Prueba eléctrica (E-TEST)
Se trata de la prueba de continuidad y aislamiento. Los métodos principales son la prueba del lecho de clavos y la prueba de la sonda volante:
- Lecho de clavos: fijaciones genéricas o personalizadas. Los genéricos son más caros, pero sirven para muchas placas. Las fijaciones personalizadas son más baratas por pieza, pero sólo para placas de circuito impreso específicas.
- Sonda voladora: desplaza las sondas hasta las redes de prueba. Es flexible y sirve para muchas tiradas pequeñas.
3.22 OSP (Conservante orgánico de soldabilidad)
La OSP forma una película orgánica sobre las pastillas de cobre desnudo y los orificios pasantes tras la prueba eléctrica y la comprobación visual. El grosor de la película es de 0,3-0,5 μm. La temperatura de descomposición es de unos 300 °C.
Principales ventajas: revestimiento plano que se adapta a placas de circuito impreso de paso pequeño; proceso sencillo, baja contaminación, bajo coste y buena soldabilidad. Inconvenientes: la película es fina y fácil de rayar. La vida útil es corta.
Hoy en día, las combinaciones ENIG + OSP se utilizan para placas de alta precisión. Proporcionan protección y soldabilidad y son una opción sin plomo para sustituir al HASL en algunos casos. El coste es más elevado.

3.23 Auditoría final (FINAL AUDIT)
Inspeccione el aspecto, el tamaño, el rendimiento eléctrico y la calidad del chapado de las placas de circuito impreso. Asegúrese de que todo cumple las normas industriales y de diseño.
3.24 Embalaje (PACKING)
Empaquete las placas de circuito impreso pasajeras para evitar la humedad y los arañazos. Proteja las placas durante el envío y guárdelas bien para su uso posterior.




