세라믹 기판은 구리 호일을 산화물 또는 세라믹 시트의 표면에 고온에서 직접 접착하여 만든 특수한 유형의 기판입니다. 구리는 고온 공정으로 세라믹에 결합되어 금속과 세라믹이 회로를 위한 안정적인 기반을 형성합니다.
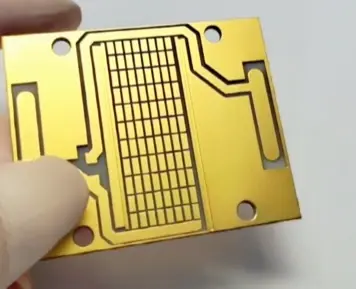
세라믹 PCB의 특성
기계적 특성(회로 트레이스가 형성되는 방식)
a. 기계적 강도가 높습니다. 부품을 고정하고 지지 구조물 역할을 할 수도 있습니다.
b. 가공이 용이합니다. 정확한 치수를 유지합니다. 여러 레이어로 만들 수 있습니다.
c. 표면이 매끈합니다. 뒤틀리거나 구부러지거나 작은 균열이 보이지 않습니다.
b. 가공이 용이합니다. 정확한 치수를 유지합니다. 여러 레이어로 만들 수 있습니다.
c. 표면이 매끈합니다. 뒤틀리거나 구부러지거나 작은 균열이 보이지 않습니다.
전기적 특성
a. 절연 저항이 높고 항복 전압이 높습니다. 따라서 회로를 단락 및 고전압 손상으로부터 안전하게 보호합니다.
b. 유전 상수가 낮고 유전 손실이 적습니다. 따라서 신호가 손실 없이 통과하는 데 도움이 됩니다.
c. 고온 다습한 환경에서도 안정적인 성능을 유지합니다. 이는 열악한 사용 환경에서도 안정성을 보장하는 데 도움이 됩니다.
b. 유전 상수가 낮고 유전 손실이 적습니다. 따라서 신호가 손실 없이 통과하는 데 도움이 됩니다.
c. 고온 다습한 환경에서도 안정적인 성능을 유지합니다. 이는 열악한 사용 환경에서도 안정성을 보장하는 데 도움이 됩니다.
열 속성
a. 열전도율이 높습니다. 이는 뜨거운 부품에서 열을 멀리 이동시키는 데 도움이 됩니다.
b. 열팽창 계수는 관련 재료, 특히 실리콘과 일치할 수 있습니다. 이 매칭은 부품이 가열 및 냉각될 때 스트레스를 줄여줍니다.
c. 내열성이 우수합니다. 고온에서도 안정적으로 유지됩니다.
b. 열팽창 계수는 관련 재료, 특히 실리콘과 일치할 수 있습니다. 이 매칭은 부품이 가열 및 냉각될 때 스트레스를 줄여줍니다.
c. 내열성이 우수합니다. 고온에서도 안정적으로 유지됩니다.
기타 속성
a. 화학적으로 안정적입니다. 금속화하기 쉽습니다. 회로 패턴이 잘 붙습니다.
b. 수분을 흡수하지 않습니다. 기름과 화학 물질 공격에 저항합니다. 방사선을 거의 방출하지 않습니다.
c. 사용된 물질은 무해하며 독성이 없습니다. 결정 구조는 작동 온도 범위에서 변하지 않습니다.
d. 원자재가 풍부합니다. 기술이 성숙합니다. 만들기 쉽고 가격이 저렴합니다.
b. 수분을 흡수하지 않습니다. 기름과 화학 물질 공격에 저항합니다. 방사선을 거의 방출하지 않습니다.
c. 사용된 물질은 무해하며 독성이 없습니다. 결정 구조는 작동 온도 범위에서 변하지 않습니다.
d. 원자재가 풍부합니다. 기술이 성숙합니다. 만들기 쉽고 가격이 저렴합니다.
세라믹 기판을 만드는 방법
세라믹을 소성하기 전에 네 가지 일반적인 성형 방법이 있습니다. 분말 프레스(몰드 프레스 또는 등방성 프레스일 수 있음), 압출, 테이프 주조, 사출 성형이 그것입니다. 이 중 테이프 주조는 여러 층을 쉽게 만들 수 있고 생산 효율이 높기 때문에 최근 LSI 패키지 및 하이브리드 회로 기판에 더 자주 사용됩니다.
일반적인 프로세스 경로는 이 세 가지입니다:
- 레이어 쌓기 - 핫 프레스 - 바인더 제거 - 베이스 시트 소성 - 회로 패턴 형성 - 회로 소성.
- 레이어 쌓기 - 표면에 회로 패턴 인쇄 - 핫 프레스 - 바인더 제거 - 공동 소성.
- 인쇄 회로 패턴 - 스택 - 핫 프레스 - 바인더 제거 - 공동 소성.
세라믹 PCB의 금속화
a. 두꺼운 필름 방식:
후막 방식에서는 스크린 인쇄를 통해 세라믹 위에 도체(회로 트레이스)와 저항을 형성합니다. 인쇄 후 부품을 소결하여 회로와 접촉 패드를 형성합니다. 인쇄된 금속을 고정하는 데 사용되는 바인더에는 유리형, 산화물형, 유리-산화물 혼합형 등이 있습니다.
b. 박막 방식:
박막은 증착, 이온 도금 또는 스퍼터링과 같은 진공 방법을 사용하여 금속을 도포합니다. 박막은 기체 상태에서 금속을 증착하기 때문에 원칙적으로 모든 금속을 증착할 수 있습니다. 또한 원칙적으로 모든 기판도 이러한 방식으로 금속화할 수 있습니다. 그러나 금속 필름과 세라믹 기판의 열팽창은 가능한 한 일치해야 합니다. 또한 금속층과 세라믹의 접착력을 높이는 것도 중요합니다.
c. 공동 소성 방법:
소성하기 전에 Mo, W 및 유사한 금속의 내화성 금속 페이스트를 소성되지 않은 세라믹 시트에 스크린 인쇄합니다. 그런 다음 세라믹과 금속이 하나의 일체형 구조를 형성하도록 스택의 결합을 해제하고 소성합니다. 이 방법에는 다음과 같은 특징이 있습니다:
매우 미세한 회로선을 형성할 수 있고 여러 층을 쉽게 만들 수 있어 고밀도 배선이 가능합니다.
절연체와 도체가 함께 형성되어 있기 때문에 패키지의 밀폐 밀봉이 가능합니다.
올바른 조성, 성형 압력, 소결 온도를 선택하면 소결 수축을 제어할 수 있습니다. 특히 평면 내 수축이 제로인 기판을 만들면 BGA, CSP 및 베어 칩 고밀도 패키징에 사용할 수 있습니다.
매우 미세한 회로선을 형성할 수 있고 여러 층을 쉽게 만들 수 있어 고밀도 배선이 가능합니다.
절연체와 도체가 함께 형성되어 있기 때문에 패키지의 밀폐 밀봉이 가능합니다.
올바른 조성, 성형 압력, 소결 온도를 선택하면 소결 수축을 제어할 수 있습니다. 특히 평면 내 수축이 제로인 기판을 만들면 BGA, CSP 및 베어 칩 고밀도 패키징에 사용할 수 있습니다.
세라믹 기판의 종류
알루미나 기판(Al₂O₃)
a. 원료: Al₂O₃는 종종 다음에서 만들어집니다. 바이엘 프로세스. 이 방법에서 원료는 수화 알루미늄 산화물 및 관련 화합물을 포함하는 보크사이트입니다.
b. 만들기: Al₂O₃ 세라믹은 일반적으로 소성되지 않은 시트를 쌓아서 형성합니다. 폴리비닐부티랄(PVB)과 같은 바인더가 자주 사용됩니다. 소성 온도는 소결 보조제에 따라 다르며 일반적으로 1550~1600°C입니다. Al₂O₃의 금속화 방법은 주로 후막 방식과 공소성 방식이 있습니다. 페이스트와 공정 기술은 성숙해졌습니다. 오늘날 많은 응용 분야의 요구를 충족합니다.
c. 애플리케이션: 하이브리드 집적 회로용 기판, LSI 패키지 기판, 다층 회로 기판.
b. 만들기: Al₂O₃ 세라믹은 일반적으로 소성되지 않은 시트를 쌓아서 형성합니다. 폴리비닐부티랄(PVB)과 같은 바인더가 자주 사용됩니다. 소성 온도는 소결 보조제에 따라 다르며 일반적으로 1550~1600°C입니다. Al₂O₃의 금속화 방법은 주로 후막 방식과 공소성 방식이 있습니다. 페이스트와 공정 기술은 성숙해졌습니다. 오늘날 많은 응용 분야의 요구를 충족합니다.
c. 애플리케이션: 하이브리드 집적 회로용 기판, LSI 패키지 기판, 다층 회로 기판.

뮬라이트 기판(3Al₂O₃-2SiO₂)
멀라이트는 Al₂O₃-SiO₂ 시스템에서 가장 안정적인 결정상 중 하나입니다. 뮬라이트는 Al₂O₃에 비해 기계적 강도가 약간 낮고 열전도율이 낮지만 유전 상수가 더 낮습니다. 이 낮은 유전 상수는 신호 속도를 향상시키는 데 도움이 될 수 있습니다. 열팽창 계수도 낮기 때문에 실장된 LSI의 열 스트레스를 줄여줍니다. 또한 Mo 및 W와 같은 도체 금속과의 팽창 차이가 작기 때문에 공소결 시 금속과 세라믹 사이에 응력이 덜 발생합니다.
질화 알루미늄 기판(AlN)
a. 원재료: AlN은 천연 광물이 아닙니다. 1800년대에 처음 합성된 인공 물질입니다. 일반적인 AlN 분말은 환원 질화 또는 직접 질화 방식으로 만들어집니다. 환원 질화 방식은 Al₂O₃에서 시작하여 고순도 탄소를 사용하여 환원시킨 다음 질소와 반응하여 AlN을 형성합니다. 직접 질화법은 Al 분말을 N₂와 반응시켜 직접 AlN을 형성합니다.
b. 만들기: Al₂O₃ 기판에 사용되는 것과 동일한 성형 방법을 AlN에도 사용할 수 있습니다. 가장 많이 사용되는 경로는 소성되지 않은 시트를 쌓는 것입니다. 이를 위해 AlN 분말, 유기 바인더, 용매 및 계면활성제를 혼합하여 세라믹 슬러리를 만듭니다. 이 슬러리를 테이프 캐스트, 스택, 열간 프레스, 디바인딩, 소성하여 AlN 기판을 만듭니다.
c. AlN 기판의 특징: AlN은 Al₂O₃보다 열전도율이 10배 이상 높습니다. 열팽창 계수(CTE)는 실리콘과 비슷합니다. Al₂O₃에 비해 AlN은 절연 저항과 항복 전압이 더 높습니다. 유전 상수도 더 낮습니다. 이러한 특성으로 인해 AlN은 패키지 기판에 매우 유용합니다.
d. 애플리케이션: VHF 대역 전력 증폭기 모듈, 고전력 장치 및 레이저 다이오드 기판에 사용됩니다.
b. 만들기: Al₂O₃ 기판에 사용되는 것과 동일한 성형 방법을 AlN에도 사용할 수 있습니다. 가장 많이 사용되는 경로는 소성되지 않은 시트를 쌓는 것입니다. 이를 위해 AlN 분말, 유기 바인더, 용매 및 계면활성제를 혼합하여 세라믹 슬러리를 만듭니다. 이 슬러리를 테이프 캐스트, 스택, 열간 프레스, 디바인딩, 소성하여 AlN 기판을 만듭니다.
c. AlN 기판의 특징: AlN은 Al₂O₃보다 열전도율이 10배 이상 높습니다. 열팽창 계수(CTE)는 실리콘과 비슷합니다. Al₂O₃에 비해 AlN은 절연 저항과 항복 전압이 더 높습니다. 유전 상수도 더 낮습니다. 이러한 특성으로 인해 AlN은 패키지 기판에 매우 유용합니다.
d. 애플리케이션: VHF 대역 전력 증폭기 모듈, 고전력 장치 및 레이저 다이오드 기판에 사용됩니다.

실리콘 카바이드 기판(SiC)
a. 원재료: SiC는 천연 광물이 아닙니다. 실리카, 코크스, 약간의 소금을 분말로 혼합하여 만듭니다. 이 혼합물을 2000°C 이상의 흑연로에서 가열하여 반응하여 α-SiC를 형성합니다. 그런 다음 승화를 통해 SiC를 정제하여 짙은 녹색의 다결정 물질 블록을 얻을 수 있습니다.
b. 만들기: SiC는 화학적 및 열적 안정성이 매우 높기 때문에 일반적인 소성 방법으로는 치밀화가 어렵습니다. 소결 보조제와 특수 소성 방법이 필요합니다. 진공 열간 프레스가 일반적으로 사용됩니다.
c. SiC 특징: 주요 특징은 매우 큰 열확산 계수입니다. 심지어 구리보다 더 클 수도 있습니다. 열팽창은 실리콘에 더 가깝습니다. 하지만 SiC에는 몇 가지 단점이 있습니다. 유전율이 상대적으로 높고 항복 전압이 다른 세라믹에 비해 좋지 않습니다.
d. 애플리케이션: SiC 기판은 높은 열 확산이 필요하고 전압이 높지 않은 곳에 사용됩니다. VLSI 방열 패키지, 방열판이 있는 고속 및 고집적 로직 LSI, 대형 컴퓨터, 광통신용 레이저 다이오드 기판 등에 사용됩니다.
b. 만들기: SiC는 화학적 및 열적 안정성이 매우 높기 때문에 일반적인 소성 방법으로는 치밀화가 어렵습니다. 소결 보조제와 특수 소성 방법이 필요합니다. 진공 열간 프레스가 일반적으로 사용됩니다.
c. SiC 특징: 주요 특징은 매우 큰 열확산 계수입니다. 심지어 구리보다 더 클 수도 있습니다. 열팽창은 실리콘에 더 가깝습니다. 하지만 SiC에는 몇 가지 단점이 있습니다. 유전율이 상대적으로 높고 항복 전압이 다른 세라믹에 비해 좋지 않습니다.
d. 애플리케이션: SiC 기판은 높은 열 확산이 필요하고 전압이 높지 않은 곳에 사용됩니다. VLSI 방열 패키지, 방열판이 있는 고속 및 고집적 로직 LSI, 대형 컴퓨터, 광통신용 레이저 다이오드 기판 등에 사용됩니다.
베릴리아 기판(BeO)
BeO는 Al₂O₃의 몇 배에 달하는 열전도율을 가지고 있습니다. 고전력 회로에 잘 작동합니다. 유전율이 낮기 때문에 고주파 회로에 적합합니다. BeO 기판은 일반적으로 건식 프레스로 만들어집니다. 또한 MgO 또는 Al₂O₃를 소량 첨가하여 소성되지 않은 시트 경로로 만들 수도 있습니다. BeO 분말은 독성이 있기 때문에 BeO 제품은 환경과 건강에 대한 우려를 불러일으킵니다. 일본에서는 BeO 기판 생산이 허용되지 않으며 미국과 같은 곳에서 BeO를 수입해야 합니다.
일부 세라믹 소재 및 기판 유형 비교
세라믹 기판은 구조와 제작 방식에 따라 HTCC, LTCC, TFC, DBC, DPC 등으로 분류할 수 있습니다. 세라믹 기판은 열전도율, 내열성, 절연성, 낮은 열팽창, 비용 절감 등의 장점으로 인해 전자 패키징과 IGBT(절연 게이트 바이폴라 트랜지스터), LD(레이저 다이오드), 고출력 LED, CPV(집광형 태양전지)와 같은 전력 전자제품에 점점 더 많이 사용되고 있습니다.
일반적인 세라믹 기본 재료는 BeO, Al₂O₃, AlN 및 Si₃N₄입니다. 이 중 Si₃N₄은 전기 절연성과 화학적 안정성이 매우 높습니다. 또한 열 안정성이 우수하고 기계적 강도가 높습니다. 고밀도 및 고집적 회로 기판에 사용할 수 있습니다.
고온 공화 세라믹 멀티레이어(HTCC)
HTCC는 고온 소성 세라믹 기판입니다. HTCC를 만들기 위해 먼저 Al₂O₃ 또는 AlN과 같은 세라믹 분말을 유기 바인더와 혼합합니다. 혼합물을 페이스트로 만든 다음 닥터 블레이드 또는 이와 유사한 방법으로 시트를 형성합니다. 건조된 시트는 녹색 몸체가 됩니다. 비아를 위한 구멍을 뚫고 배선 및 비아 충전을 위해 도체 페이스트를 스크린 인쇄합니다. 그런 다음 녹색 시트를 쌓아 약 1600°C의 고온 용광로에 넣어 소결합니다. 소결 온도가 높기 때문에 도체 금속의 선택이 제한됩니다. 텅스텐, 몰리브덴, 망간 등 녹는점은 높지만 전도도가 낮은 금속이 사용됩니다. 비용이 높고 열전도율이 약 20-200W/(m-°C) 정도입니다.
저온 공조 세라믹 PCB(LTCC)
LTCC는 저온 공화 세라믹입니다. 제작 단계는 HTCC와 유사합니다. 차이점은 Al₂O₃ 분말에 저융점 유리의 질량으로 30-50%가 포함되어 있다는 것입니다. 이렇게 하면 소성 온도가 약 850-900°C로 낮아집니다. 소성 온도가 낮기 때문에 금이나 은과 같이 전도성이 좋은 전도성 금속을 전극과 트레이스에 사용할 수 있습니다. LTCC는 금속 라인에 스크린 인쇄를 사용합니다. 이 방식은 메시가 늘어나기 때문에 정렬 오류가 발생할 수 있습니다. 또한 여러 층을 적층하고 함께 소성할 때 서로 다른 수축이 발생하여 수율이 저하될 수 있습니다. LTCC 열 전도성을 높이기 위해 부품 영역에 열 비아 또는 전도성 비아를 추가할 수 있지만 비용이 증가합니다.
후막 세라믹 기판(TFC)
LTCC 및 HTCC에 비해 TFC는 소성 후 세라믹 기판입니다. 스크린 인쇄를 사용하여 세라믹 베이스 표면에 금속 페이스트를 도포합니다. 건조 후 고온(700-800°C)에서 부품을 소성합니다. 금속 페이스트는 금속 분말, 유기 수지 및 유리로 만들어집니다. 소성 후 수지는 연소되고 남은 층은 대부분 세라믹 표면에 유리 접착제로 결합된 금속입니다. 소성된 금속 층의 두께는 일반적으로 10~20μm이며 최소 선폭은 약 0.3mm입니다. 기술이 성숙하고 공정이 간단하며 비용이 저렴하기 때문에 패턴 정밀도가 높지 않은 곳에 TFC가 사용됩니다.
직접 본딩 구리 세라믹 PCB(DBC)
DBC는 구리 호일을 고온(약 1065°C)에서 세라믹 시트에 공소결합 또는 유텍본딩하여 만듭니다. 본딩 후 에칭을 통해 회로 패턴을 형성합니다. 구리 호일은 전기 및 열전도가 우수하고 Al₂O₃는 Cu-Al₂O₃-Cu 복합체의 팽창을 제어할 수 있기 때문에 DBC는 알루미나에 가까운 열팽창을 갖습니다. DBC는 열전도가 우수하고 절연성이 강하며 신뢰성이 높습니다. IGBT, 레이저 다이오드 및 CPV 패키징에 널리 사용됩니다. DBC에는 단점이 있습니다. Cu와 Al₂O₃ 사이의 고온 공융 반응은 장비와 공정에 대한 엄격한 제어가 필요하므로 비용이 더 높습니다. Al₂O₃와 Cu 사이에 미세 기공이 형성되어 열충격 저항성이 낮아질 수 있습니다. 구리 호일은 고온에서 휘어질 수 있으므로 DBC의 구리 두께는 일반적으로 100μm 이상입니다. 또한 패턴을 형성하기 위해 에칭이 사용되므로 최소 선폭은 일반적으로 100μm 이상입니다.

직접 도금 구리 세라믹 PCB(DPC)
DPC는 세라믹 시트를 세척하고 전처리하는 것으로 시작됩니다. 그런 다음 기판 표면에 진공 스퍼터링으로 Ti/Cu 시드 층을 증착합니다. 포토리소그래피, 현상 및 에칭을 사용하여 회로 패턴을 형성합니다. 그런 다음 전기 도금 또는 화학 도금을 사용하여 회로 두께를 늘립니다. 포토레지스트를 제거하면 기판이 완성됩니다. DPC는 저온 공정(300°C 이하)을 통해 재료와 회로에 고온의 단점을 피하고 제조 비용을 낮출 수 있다는 장점이 있습니다. 박막과 포토리소그래피를 사용하면 기판의 금속 라인이 더 미세해집니다. 따라서 DPC는 높은 정렬 정확도가 필요한 패키지에 적합합니다. 하지만 DPC에도 단점이 있습니다. 전기 도금된 구리 두께는 제한되어 있으며, 전기 도금 폐액은 오염을 유발할 수 있습니다. 금속층과 세라믹 사이의 접착력이 낮아 제품 신뢰성이 떨어질 수 있습니다.
사용 및 선택 시 참고 사항
세라믹 기판을 선택할 때는 애플리케이션의 요구 사항에 맞게 재료를 선택하세요. 높은 열전도율과 실리콘에 가까운 열팽창이 필요한 경우 AlN 또는 SiC가 가장 적합할 수 있습니다. 비용과 성숙한 공정이 중요하다면 Al₂O₃를 선택하는 것이 좋습니다. 미세한 라인과 저온 처리가 필요한 경우 DPC와 LTCC가 적합합니다. 고밀도 다층 배선 및 밀폐 밀봉이 필요한 경우 공동 소결 금속을 사용한 LTCC 또는 HTCC와 같은 공동 소결 경로가 적합할 수 있습니다.
일반적인 응용 분야로는 전력 모듈, RF 전력 증폭기, 레이저 다이오드 모듈, 고출력 LED 및 고밀도 LSI 패키징이 있습니다. 세라믹 기판은 열을 잘 이동시키고 열 스트레스 하에서도 절연성과 기계적 강도를 유지하기 때문에 전력 전자기기의 이점을 제공합니다. RF 장치는 낮은 유전체 손실과 안정적인 유전체 특성으로 이점을 얻습니다. 고밀도 패키징은 공정에 적합한 경우 미세한 선을 만들고 우수한 정렬 제어로 많은 레이어를 쌓을 수 있다는 이점이 있습니다.
제조상의 장단점 및 실용적인 포인트
모든 세라믹 유형과 공정에는 장단점이 있습니다. HTCC는 높은 소성 온도를 사용하므로 전도체에 내화성 금속을 사용합니다. 이로 인해 전도성이 제한되고 비용이 상승하지만, HTCC는 고온에서 매우 견고할 수 있습니다. LTCC는 유리를 추가하여 소성 온도를 낮추므로 더 나은 도체를 사용할 수 있지만, 다층에서 수축 문제와 정렬 문제가 발생할 수 있습니다. TFC는 저렴하고 간단하지만 매우 미세한 패턴을 구현할 수 없습니다. DBC는 두꺼운 구리로 뛰어난 열 확산을 제공하지만 패터닝 한계와 제조 비용이 문제가 될 수 있습니다. DPC는 미세 패터닝과 저온 가공이 가능하지만 접착력과 폐기물 관리에 주의가 필요합니다.
공동 소성 대 소성 후 금속화
공소성은 녹색 세라믹에 금속 페이스트를 인쇄하고 모든 것을 함께 소성하는 것을 의미합니다. 이를 통해 매우 작은 피처와 진정한 다층 배선을 만들 수 있습니다. 또한 세라믹과 금속이 하나의 일체형 바디가 되어 밀폐에 도움이 됩니다. 하지만 공소결은 수축과 소결을 일치시키기 위해 재료를 세심하게 제어해야 합니다. 소성 후 금속화는 소성된 세라믹에 두꺼운 필름이나 얇은 필름을 씌우는 것과 같이 공소결 수축 문제를 방지합니다. 단일 레이어 또는 간단한 이중 레이어 요구 사항에 더 용이할 수 있습니다. 그러나 소성 후 방법은 동일한 배선 밀도에 도달하지 못할 수 있으며 접착력이나 열적 특성이 다를 수 있습니다.
일반적인 프로세스 흐름 예시(짧은 요약)
- 공소성 다층 기판의 경우: 세라믹 슬러리 만들기, 테이프 캐스팅, 그린 테이프에 비아 드릴링, 스크린으로 도체 페이스트 인쇄, 테이프 쌓기, 프레스 및 디바인딩, 소성 순으로 진행합니다. 소성 후 필요한 경우 패드 금속화 및 회로 에칭과 같은 최종 처리를 수행합니다.
- 세라믹에 두꺼운 필름을 씌우는 경우: 세라믹 기판, 스크린 인쇄 도체 및 저항 페이스트를 사용하고 700-800°C에서 소성한 다음 저항을 다듬고 최종 금속 패드를 추가합니다.
- DPC의 경우: 세라믹 세척, 스퍼터로 Ti/Cu 시드 증착, 포토레지스트 패턴, 패턴을 만들기 위한 에칭 시드, 구리 성장을 위한 전착, 레지스트 스트립, 최종 세척.
요약
세라믹 PCB는 전자 패키징에 고유한 강점을 제공하는 기판 재료의 한 종류입니다. 세라믹은 우수한 열 경로, 온도에서 안정적인 전기적 거동, 우수한 기계적 강도를 제공합니다. 다양한 세라믹 선택과 다양한 금속화 경로를 통해 설계자는 비용, 열 성능, 전기 성능 및 미세 라인 패턴 요구 사항의 균형을 맞출 수 있습니다. 이 때문에 세라믹 기판은 전력 전자 장치, RF 모듈, 레이저 및 다이오드 패키지, 고출력 LED 및 다양한 고밀도 패키징 분야에서 널리 사용됩니다.
자주 묻는 질문
가장 일반적인 것은 일반적인 용도의 알루미나(Al₂O₃)와 높은 열 전도성을 위한 질화 알루미늄(AlN)이며, 그 외 특수 세라믹(예: 탄화규소)은 고출력 또는 고온의 틈새 수요에 사용됩니다.
세라믹 PCB는 후막 인쇄, 박막 증착, 레이저 가공, 금속화(구리 또는 은) 등의 공정을 거친 후 소성 및 마감 처리를 통해 만들어집니다.
주요 장점: 훨씬 뛰어난 열 전도성(방열), 낮은 열팽창 계수(CTE), 높은 내열성, 우수한 전기 절연성으로 LED, 전력 전자 장치, RF/고주파 애플리케이션에 이상적입니다.
예 - 재료 비용과 특수 공정(소성, 레이저 가공, 금속화)으로 인해 세라믹 PCB는 일반적으로 표준 FR-4보다 가격이 비싸지만, 고전력 또는 고신뢰성 설계의 경우 성능과 수명을 개선하여 시스템 비용을 절감할 수 있습니다.
예. 세라믹 기판은 안정적인 유전체 특성과 고주파에서 낮은 손실을 제공하므로 RF 및 마이크로파 회로 부품에 적합한 선택입니다.
비용 효율적이고 일반적인 용도로 사용하려면 알루미나를 선택하고, 고전력 애플리케이션을 위해 더 높은 열 전도성과 더 나은 열 관리가 필요한 경우 AlN을 선택하세요. 열, 기계 및 예산 요구 사항을 반영하여 선택해야 합니다.


