비아는 다층 인쇄 회로 기판(PCB)의 핵심 부품 중 하나입니다. 많은 보드에서 드릴링 비용은 보드 제작 비용의 약 30%에서 40%를 차지합니다. 간단히 말해, PCB의 모든 구멍을 비아라고 부를 수 있습니다. 비아의 역할은 크게 두 가지로 나뉘는데, 하나는 레이어 간에 전기 연결을 하는 것이고 다른 하나는 부품을 고정하거나 위치를 지정하는 것입니다.
제조 공정을 살펴보면 비아는 블라인드 비아, 매립 비아, 스루 비아(스루홀 비아)의 세 가지 유형으로 분류할 수 있습니다. 블라인드 비아는 PCB의 상단 또는 하단 표면에서 시작하여 일부 내부 레이어까지 내려갑니다. 일정한 깊이를 가지며 표면 트레이스를 내부 레이어 트레이스로 연결하는 데 사용됩니다. 블라인드 비아의 깊이는 일반적으로 구멍 직경에 대한 특정 비율을 초과하지 않습니다. 매립형 비아는 내부 레이어만 연결하는 구멍으로, 보드의 어떤 표면에도 닿지 않습니다. 블라인드 비아와 매립 비아 모두 라미네이션 전에 보드 내부에 만들어지며, 형성 과정에서 여러 내부 레이어가 겹칠 수 있습니다. 세 번째 유형은 스루 비아입니다. 이 구멍은 보드 전체를 관통합니다. 내부 상호 연결 또는 부품의 장착 또는 위치 지정 구멍으로 사용할 수 있습니다. 스루 비아는 만들기가 더 쉽고 저렴하기 때문에 대부분의 인쇄 회로 기판은 블라인드 비아 또는 매립 비아 대신 사용합니다. 이 글의 나머지 부분에서는 달리 명시하지 않는 한 “비아”라는 단어는 스루 비아를 의미합니다.
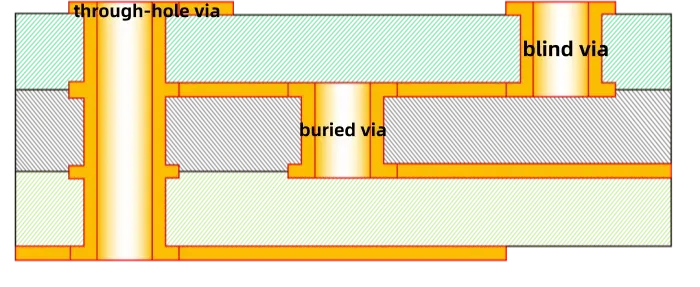
비아 구조와 크기가 중요한 이유
디자인 관점에서 비아는 크게 두 부분으로 구성됩니다. 하나는 중앙 드릴 구멍입니다. 다른 하나는 드릴 구멍 주변의 패드 영역입니다. 이 두 부분의 크기에 따라 비아 크기가 결정됩니다. PCB에 고속 및 고밀도가 필요한 경우 설계자는 비아를 가능한 한 작게 만들기를 원합니다. 비아가 작을수록 보드에 라우팅을 위한 공간이 더 많이 남습니다. 또한 비아가 작을수록 기생 커패시턴스가 낮기 때문에 고속 회로에 더 적합합니다.
하지만 비아를 작게 만들면 비용이 증가합니다. 또한 비아 크기를 무한정 줄일 수도 없습니다. 드릴링과 도금 공정에서 한계가 있습니다. 구멍이 작을수록 드릴링 시간이 길어지고 드릴이 중심을 벗어날 가능성이 높아집니다. 또한 구멍 깊이가 드릴 직경의 6배가 넘으면 구멍 벽에 균일한 구리 도금이 이루어지기가 어렵습니다. 예를 들어, 일반적인 6층 PCB의 두께(비아 깊이)는 약 50밀리미터입니다. 이 조건에서 PCB 공장은 일반적으로 최소 직경 약 8밀리미터까지 드릴링할 수 있습니다.
비아의 기생 커패시턴스
비아에는 접지에 대한 기생 커패시턴스가 있습니다. 평면 레이어의 접지 간극 구멍의 지름이 D2, 비아 패드 지름이 D1, PCB 기판 두께가 T, 기판 유전율이 ε인 경우 비아의 대략적인 기생 커패시턴스는 다음과 같습니다:
C = 1.41 × ε × T × D1 / (D2 - D1)
이 공식은 비아 커패시턴스에 대한 합리적인 추정치를 제공합니다. 기생 커패시턴스는 주로 신호 상승 시간을 길게 만들어 회로 속도를 낮춥니다.
구체적인 예를 들어보겠습니다. 보드 두께가 50밀리미터라고 가정합니다. 비아 내경은 10밀리미터이고 패드 내경은 20밀리미터입니다. 패드와 접지 구리 영역 사이의 거리는 32밀리입니다. 위의 공식을 사용하고 ε = 4.4를 취하면 다음과 같습니다:
C = 1.41 × 4.4 × 0.050 × 0.020 / (0.032 - 0.020) ≈ 0.517pF
이 커패시턴스 양에 따라 상승 시간이 달라집니다. 특성 임피던스가 55옴인 경우, 이 커패시턴스로 인한 10%-90% 상승 시간의 변화는 대략 다음과 같습니다:
T10-90 = 2.2 × C × (Z0 / 2) ≈ 2.2 × 0.517 × (55 / 2) ≈ 31.28 ps
이 수치에서 단일 비아의 기생 커패시턴스가 상승 시간에 미치는 영향은 미미하다는 것을 알 수 있습니다. 그러나 레이어를 변경할 때 신호가 여러 비아를 통과하면 그 효과는 합산됩니다. 따라서 설계자는 이에 대해 신중하게 생각해야 합니다.
비아의 기생 인덕턴스
비아에는 기생 커패시턴스와 함께 기생 인덕턴스도 있습니다. 고속 디지털 설계에서 비아의 기생 인덕턴스로 인한 피해는 기생 커패시턴스로 인한 피해보다 더 큰 경우가 많습니다. 비아의 직렬 인덕턴스는 바이패스 커패시터의 효과를 약화시키고 전체 전력 시스템의 필터링 성능을 저하시킬 수 있습니다.
비아 인덕턴스의 간단한 대략적인 공식은 다음과 같습니다:
L = 5.08 × h × [ ln(4h/d) + 1 ]입니다.
어디에:
- L은 비아 인덕턴스입니다,
- h는 비아 길이입니다,
- d는 중앙 드릴 직경입니다.
공식에서 비아 직경은 인덕턴스에 미치는 영향이 작고 비아 길이가 가장 큰 영향을 미친다는 것을 알 수 있습니다. 위의 예에서 h = 0.050, d = 0.010을 사용하면 다음과 같은 결과를 얻을 수 있습니다:
L = 5.08 × 0.050 × [ ln(4 × 0.050 / 0.010) + 1 ] ≈ 1.015 nH
신호 상승 시간이 1ns인 경우 등가 유도 리액턴스는 다음과 같습니다:
XL = π × L / T10-90 ≈ π × 1.015 nH / 1 ns ≈ 3.19 Ω
고주파 전류가 있는 경우 이 수준의 임피던스는 무시할 수 없습니다. 또한 전원 레이어와 접지 레이어를 연결하기 위해 배치된 바이패스 커패시터에는 일반적으로 두 개의 비아가 필요합니다. 즉, 이 바이패스 경로의 경우 비아 인덕턴스가 두 배가 됩니다.
고속 디자인에 대한 의미
위의 비아 기생 분석에서 단순해 보이는 비아가 고속 PCB에서 큰 부정적인 영향을 미칠 수 있음을 알 수 있습니다. 이러한 문제를 줄이기 위해 설계자는 다음과 같은 방법을 시도해 볼 수 있습니다.
- 합리적인 비아 크기 선택
비용과 신호 품질을 모두 고려하세요. 예를 들어, 6~10층으로 구성된 메모리 모듈 PCB의 경우 10/20 mil(드릴/패드) 비아를 선택하는 것이 효과적입니다. 일부 고밀도 소형 보드의 경우 8/18 mil 비아를 사용해 볼 수 있습니다. 현재 기술로는 그보다 작은 비아를 만들기가 어렵습니다. 전원 또는 접지 비아의 경우 임피던스를 낮추기 위해 더 큰 크기를 사용하세요. - 가능하면 더 얇은 보드 사용
공식에서 알 수 있듯이 기판이 얇을수록 비아 커패시턴스와 인덕턴스를 모두 줄이는 데 도움이 됩니다. - 불필요한 레이어 변경 방지
레이어를 전환하지 않고 신호를 라우팅하세요. 즉, 가능한 한 비아를 적게 사용하세요. - 전원 및 접지 핀을 비아 근처에 배치합니다.
전원 및 접지 핀을 비아에 가깝게 배치합니다. 선이 길면 인덕턴스가 증가하므로 비아와 핀 사이의 선은 가능한 한 짧게 유지하세요. 임피던스를 낮추려면 전원 및 접지에 더 두꺼운 트레이스를 사용합니다. - 신호 레이어 변경 비아 근처에 접지 비아 배치
신호가 레이어를 변경하는 비아 근처에 접지 비아를 배치합니다. 이렇게 하면 신호가 가까운 반환 경로를 확보할 수 있습니다. 필요한 경우 접지 비아를 여러 개 추가할 수도 있습니다. 하지만 유연하게 대처하세요. 앞서 설명한 비아 모델은 모든 레이어에 패드가 있다고 가정했습니다. 경우에 따라 일부 내부 레이어에서 패드를 줄이거나 제거할 수 있습니다. 비아 밀도가 매우 높으면 구리 타설의 큰 패드가 끊어진 루프를 형성할 수 있습니다. 이 문제를 해결하려면 일부 비아를 이동하거나 특정 레이어에서 패드 크기를 줄일 수 있습니다.
고속 PCB를 위한 비아 설계 - 실용적인 제안
고속 PCB는 일반적으로 여러 레이어를 사용하며 비아는 설계의 주요 요소입니다. PCB의 비아는 구멍 자체, 구멍 주변의 패드, 전원 레이어 절연 영역(비아 주변의 전원 및 접지면의 간극)의 세 부분으로 구성됩니다.
다음은 고속 멀티 레이어 보드에 대한 몇 가지 실용적인 사항입니다:
- 사이즈 권장 사항을 통해
밀도가 중간 정도인 일반 다층 보드의 경우 0.25mm / 0.51mm / 0.91mm(드릴/패드/전력 절연) 크기의 비아를 선택하는 것이 좋습니다. 고밀도 보드의 경우 0.20mm / 0.46mm / 0.86mm가 적합할 수 있습니다. 일부 설계에서는 비도금 비아를 사용할 수 있습니다. 전원 또는 접지 비아의 경우 임피던스를 낮추기 위해 더 큰 크기를 고려하세요. - 전원 절연 구역
전원 절연 영역이 클수록 좋습니다. 평면의 비아 밀도를 고려하세요. 일반적으로 D1 = D2 + 0.41이 가이드라인으로 사용되는데, 이는 패드 직경이 평면 간극 직경에 0.41mm를 더한 값과 같다는 의미입니다. 이렇게 하면 평면 간격을 충분히 넓게 유지하는 데 도움이 됩니다. - 레이어 변경 최소화
신호 라우팅에서 불필요한 레이어 변경을 방지하여 비아를 줄입니다. - 더 얇은 보드 사용
기판이 얇을수록 비아의 커패시턴스와 인덕턴스가 모두 낮아집니다. - 짧고 넓은 전원/접지 연결
비아에서 전원 또는 접지 핀까지의 리드를 짧게 유지하세요. 유도 임피던스를 줄이기 위해 전원 또는 접지용 트레이스를 가능한 한 넓게 만드세요. - 레이어 변경 비아 근처의 스티칭을 통한 접지
신호가 레이어 사이를 이동하는 비아에 가까운 접지 비아를 추가합니다. 이렇게 하면 신호의 리턴 경로가 짧아집니다.
또한 비아 길이는 비아 인덕턴스의 주요 요소입니다. 상단 및 하단 레이어 비아의 경우 비아 길이는 전체 보드 두께와 같습니다. 레이어 수가 증가하면 보드 두께가 5mm를 초과할 수 있습니다. 고속 설계에서는 비아 관련 문제를 줄이기 위해 비아 길이를 일반적으로 2.0mm 미만으로 유지합니다. 비아 길이가 2.0mm보다 긴 경우 비아 직경을 늘리면 임피던스 연속성을 복원하는 데 도움이 될 수 있습니다. 비아 길이가 1.0mm 이하인 경우 최적의 비아 직경은 약 0.20mm ~ 0.30mm입니다.
PCB 생산의 백드릴링
1. 백드릴링이란 무엇인가요?
백드릴링은 깊은 구멍이 있는 보드에 사용되는 특수 드릴링 단계입니다. 예를 들어 12층 보드를 만들 때 레이어 1과 레이어 9를 연결해야 할 수 있습니다. 일반적으로는 관통 구멍을 한 번 뚫은 다음 플레이팅합니다. 이 관통 구멍은 레이어 1에서 레이어 12까지 연결되지만, 여기서는 레이어 1과 레이어 9 사이만 연결하면 됩니다. 레이어 10에서 레이어 12까지의 추가 섹션은 스텁처럼 작동합니다. 이 스텁은 신호 경로에 영향을 미치고 통신 신호의 신호 무결성 문제를 일으킬 수 있습니다. 이 여분의 스텁을 제거하기 위해 두 번째 드릴링 단계인 뒷면에서 드릴을 뚫습니다. 이를 백드릴링이라고 합니다. 실제로 제조업체는 이후 단계에서 일부 구리를 제거하고 드릴 비트의 끝이 가늘어지기 때문에 마지막 비트까지 모두 드릴링하지는 않습니다. 따라서 공장에서는 보통 아주 작은 스텁을 남깁니다. 남은 스텁의 길이를 B 값이라고 하며, 좋은 B 값은 일반적으로 50μm에서 150μm 사이입니다.
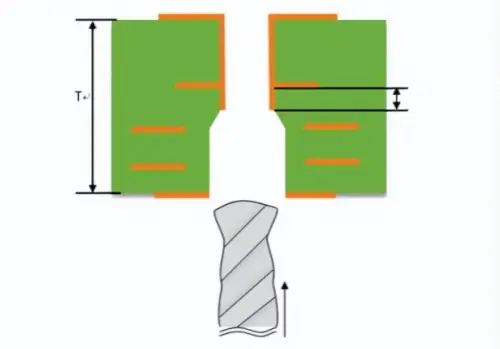
2. 왜 백드릴을 해야 하나요?
백드릴링은 여러 가지 이점을 제공합니다:
- 노이즈와 간섭을 줄입니다.
- 신호 무결성을 개선합니다.
- 보드의 국소 영역을 더 얇게 만들 수 있습니다.
- 매립형 또는 블라인드 비아의 필요성을 줄여 보드 복잡성을 낮춥니다.
3. 백드릴링의 기능은 무엇인가요?
백드릴링은 연결이나 신호 전송에 도움이 되지 않는 비아 섹션을 제거합니다. 이렇게 하면 반사, 산란, 지연 및 신호 “왜곡”을 유발하는 기타 영향을 방지할 수 있습니다. 연구에 따르면 설계, 보드 재료, 전송선, 커넥터, 칩 패키징 외에도 비아도 신호 무결성에 큰 영향을 미치는 것으로 나타났습니다.
4. 백드릴링 작동 원리
백드릴링은 PCB 표면을 감지하여 위치를 지정하는 드릴 비트를 사용합니다. 드릴 비트 팁이 기판 표면의 구리 호일에 닿으면 미세 전류가 생성됩니다. 이 전류는 기계에 기판 표면 높이를 알려줍니다. 그러면 기계가 설정된 깊이까지 드릴링한 후 멈춥니다.
5. 백드릴링 프로세스 단계
일반적인 백드릴링 프로세스는 다음과 같이 진행될 수 있습니다:
a. PCB에 등록 구멍을 제공합니다. 이 구멍을 사용하여 첫 번째 드릴링 단계(관통 구멍)를 수행합니다.
b. 첫 번째 드릴링 후 구멍을 도금합니다. 도금하기 전에 필요에 따라 드라이 필름을 사용하여 등록 구멍을 보호합니다.
c. 도금된 보드에 외층 패턴을 만듭니다.
d. 패턴 도금을 합니다. 패턴 도금 전에 필요한 경우 등록 구멍을 다시 드라이 필름으로 처리합니다.
e. 첫 번째 드릴의 등록 구멍을 사용하여 백드릴링할 보드의 위치를 지정합니다. 드릴 비트를 사용하여 백드릴링이 필요한 도금 섹션을 드릴링합니다.
f. 백 드릴링 후에는 백 드릴링한 구멍을 세척하여 드릴 먼지와 잔여물을 제거합니다.
6. 백 드릴 보드의 기술적 특징
일반적인 기술적 특징은 다음과 같습니다:
- 대부분의 백드릴 보드는 리지드 보드입니다.
- 레이어 수는 일반적으로 8개에서 50개까지 다양합니다.
- 보드 두께는 보통 2.5mm 이상입니다.
- 두께 대 직경 비율이 상대적으로 큽니다.
- 보드 크기가 큽니다.
- 초기 드릴 최소 직경은 일반적으로 0.3mm 이상입니다.
- 보드에는 압입 구멍에 핀치 어레이를 사용하는 경우가 많기 때문에 외부 레이어 흔적이 거의 없습니다.
- 백드릴 구멍은 일반적으로 제거할 구멍보다 0.2mm 더 큽니다.
- 백드릴 깊이 허용 오차는 약 ±0.05mm입니다.
- 백드릴링이 M 레이어까지 도달해야 하는 경우, M 레이어에서 M-1 레이어까지의 유전체 두께는 최소 0.17mm여야 합니다.

7. 백드릴 보드의 일반적인 애플리케이션
백드릴 보드는 주로 신호 무결성이 매우 우수하고 대형 구조가 필요한 분야에서 사용됩니다. 일반적인 분야는 통신 장비, 대형 서버, 의료 전자, 군사 및 항공 우주 분야입니다. 군사 및 항공 우주 분야는 민감한 분야이기 때문에 이러한 분야의 백플레인은 해당 분야에 대한 배경 지식을 갖춘 연구 기관, R&D 센터 또는 PCB 제조업체에서 제작하는 경우가 많습니다. 중국에서는 백플레인에 대한 대부분의 수요가 빠르게 성장하고 있는 통신 산업에서 발생합니다.
요약
간단히 말해 비아는 간단하지만 매우 중요합니다. 비아는 레이어를 연결하고 기생 커패시턴스와 인덕턴스를 추가합니다. 이러한 기생은 신호 상승 시간과 바이패스 커패시터의 작동 방식에 모두 영향을 미칩니다. 비아 길이는 주로 인덕턴스를 결정합니다. 비아 크기, 패드 크기 및 간격은 커패시턴스에 영향을 줍니다. 고속 설계의 경우 다음 체크리스트를 사용하세요:
- 보드 밀도와 비용에 맞는 크기를 선택하세요. 많은 보드의 경우 10/20 mil이 좋으며, 밀도가 높은 보드의 경우 8/18 mil을 사용하세요. 전원/접지 비아의 경우 더 큰 크기를 선택하세요.
- 가능하면 얇은 보드를 사용하세요. 이렇게 하면 기생충이 줄어듭니다.
- 불필요한 레이어 변경을 피하세요. 가능하면 동일한 레이어에서 라우팅을 유지하세요.
- 전원 및 접지 핀을 비아 근처에 배치하고 연결을 짧고 넓게 유지하세요.
- 짧은 리턴 경로를 제공하기 위해 레이어를 변경하는 신호 비아 근처에 접지 비아를 추가합니다.
- 긴 비아 또는 깊은 보드의 경우 고속 신호를 방해하는 스텁을 제거하기 위해 백드릴링을 고려하세요.
- 비아 밀도가 매우 높은 경우, 구리 타설이 깨지지 않도록 일부 내부 레이어의 패드 크기를 줄이는 것이 좋습니다.
이 규칙을 따르고 하나의 경유지가 아닌 전체 시스템에 대해 생각하세요. 고속 설계에서는 작은 디테일이 모여 큰 효과를 냅니다. 신중한 비아 계획은 보드의 작동을 개선하고 위험을 줄이며 나중에 디버깅 시간을 절약할 수 있습니다.




