以下はその英訳である。明確でシンプルな表現と基本的な連結語(and、but、so、then、because)を使った。専門用語と数字は正確にしました。ご要望の通り、文章は長め(1800語以上)です。.
ブラインド・ビアおよびバリア付きHDI基板の基本プロセス
1.概要
HDIはHigh Density Interconnectの略。20世紀後半に登場したPCB技術である。主な利点はレーザードリルによる穴あけです。従来の機械的な穴あけは、ドリルビットによって制限される。穴の大きさが0.15mmに達すると、コストが大幅に上昇し、最適化も難しくなる。HDIレーザーの穴はわずか3~5mil(0.076~0.127mm)です。トレース幅は3~4mil(0.076~0.10mm)。パッドサイズはかなり小さくなる。同じ面積により多くのトレースが収まる。これにより、高密度相互接続が可能になる。.
HDIを使用すると、設計者は次のような高密度パッケージを使用できます。 BGA およびQFPに使用される。現在、0.5 ピッチの BGA ではファーストレベル HDI が一般的です。BGAの配線がコーナーエスケープからセンターエスケープに移行するにつれて、ファーストレベル エッチディーアイ は、もはや一部のニーズを満たすことはできない。第2レベルHDIが研究開発と生産の焦点となる。第1レベルHDIのレーザーブラインド・ビアは、表面と隣接する内層を接続するだけである。第2レベルHDIは、表面から第3層まで、あるいは表面から第2層を通って第3層まで穴を開けることができる。これはファーストレベルHDIよりはるかに難しい。.
2.材料
2.1 素材の種類
- 銅箔:導電性パターンを作る基本材料。.
- コア(CORE):ボードのバックボーン。両面銅張りの基板で、内層に使用される。.
- プリプレグ:多層ボードの接着剤や断熱材として使用される半硬化樹脂シート。.
- ソルダーマスクインク:ソルダーマスク、絶縁、腐食防止に使用される。.
- レジェンド・インク(シルクスクリーン):マーキングやラベルに使用。.
- 表面仕上げ材:錫-鉛合金、ニッケル-金、銀など、, せいやくじゅうそくもんだい, などがある。.
2.2 ラミネート断熱材
2.2.1 一般的なラミネート
一般的な高Tg材料には、MICA/EG-150T、SYST/S1141、Grace/MTC-97、HITACHI/MCL-HD-67などがある。これらは、より高い耐熱性が必要な場合に使用される。.
2.2.2 HDI専用絶縁材料
一般的なタイプとスペック:
- RCC材料:80t18、60t12、65t12、80t12、60t18。.
- fr4(自民党):1080, 106.
注:FR-4はお好みで “fr4 ”とした。.
2.3 特別な材料RCCの説明
RCCとはResin Coated Copperの略。銅箔を特殊な樹脂フィルムでコーティングしたもの。フィルムは内部トレースを完全に覆い、絶縁の役割を果たす。RCCには主に2つのタイプがある:Bステージ(三井物産)とB+Cステージ(ポリクラッド)がある。.
主な特徴
- 樹脂フィルム中にガラス繊維層がない。このため、レーザーやプラズマによるマイクロビアの形成が容易になる。.
- 誘電体層が薄く、剥離強度が高い。.
- 良好な靭性と滑らかな表面は、非常に狭いトレースのエッチングに適している。.
- HDI用のレーザー穴あけは、RCCを対象とすることが多い。レーザーの穴は、機械的な穴のような円柱ではなく、逆台形のような形をしている。一般的な穴のサイズは0.076~0.10mm。.
その他のHDI素材(コア、プリプレグ、銅箔)は特別なものではない。通常、内層銅の厚さは薄く、内層1オンス、外層0.5オンスのベース銅を1オンスにメッキする。基板全体が薄くなる。RCCにはガラス繊維がないため、同じ厚さの他のPCBに比べて硬度と強度が低い。.
3.製造工程(例:2+4+2の8層基板)
以下に、主なステップと重要なポイントを列挙する。簡単な言葉を使い、順序を明確にする。.
3.1 原材料の切断(CUT)
銅張りの大きな板を、生産機械に合うサイズに切断する。つの核となるコンセプトを明確にしなければなりません:
- UNIT:お客様のレイアウトにおける1デザイン単位。.
- SET:プロセスエッジやツーリングを含む、複数のUNITを結合したもの。.
- PANEL: 複数のSETをツール・ボーダーで組み合わせ、1枚のパネルにしたもの。一般的な購入サイズは36.5インチ×48.5インチ、40.5インチ×48.5インチ、42.5インチ×48.5インチ。歩留まり率はデザインとパネルの用途によって異なる。.

3.2 内層ドライフィルムプロセス(INNER DRY FILM)
内層ドライフィルムステップでは、内層パターンを転写する。フォトレジストフィルムのラミネート、露光、現像、エッチング、剥離などの工程がある:
- ラミネート:銅の上に感光性フィルムを貼り付ける。光で露光部分を硬化させ、保護層を形成する。.
- 露光・現像:フィルムを露光する。明るい部分は固まる。暗い部分は柔らかいまま。現像で柔らかいフィルムを取り除く。.
- エッチングと剥離:露出した銅をエッチングする。その後、硬化した保護膜を剥離する。内層トレースが形成される。.
設計のヒント:最小トレース幅、間隔、均一性を管理する。間隔が狭すぎると、ラミネート時にショートすることがある。トレースが薄すぎると、フィルムの接着がうまくいかず、トレースが開いてしまうことがあります。生産には安全なマージンを残すこと。.
3.3 黒色または褐色の酸化(BLACK OXIDATION)
インナートレースを行った後、ラミネートの前に黒または茶色の酸化処理を行う。主な目的
- 銅の表面の油や汚れを取り除く。.
- 銅の表面積を増やし、樹脂との接着性を高める。.
- 非極性銅表面を極性CuOおよびCu₂Oに変換し、化学結合を改善する。.
- 高温での耐湿性を向上させ、銅と樹脂間の剥離のリスクを低減する。.
Cu₂Oが主生成物の場合、褐色酸化(赤色)と呼ばれる。CuOが主な生成物である場合、これは黒色酸化(黒色)と呼ばれる。.
3.4 ラミネート加工(プレス加工)
ラミネーションは、Bステージプリプレグを使用してすべての層を接着する。主な工程
- スタックアップ:銅箔、プリプレグ、インナーコア、ステンレス板、セパレーターボード、クラフト紙、外側のプレス板を並べる。6層以上のボードの場合は、プレスタックが必要。.
- ホットプレス:スタックを真空ホットプレスに入れる。熱で樹脂が溶けてスタックを接着し、空隙を埋める。.
ヒント:ラミネートは左右対称に。左右の応力が釣り合わないと反りが生じます。厚みムラの原因となる樹脂の流れの違いを避けるため、銅の配分をコントロールする。ブラインド・ビアや埋設ビアは前もって計画しておくこと。.
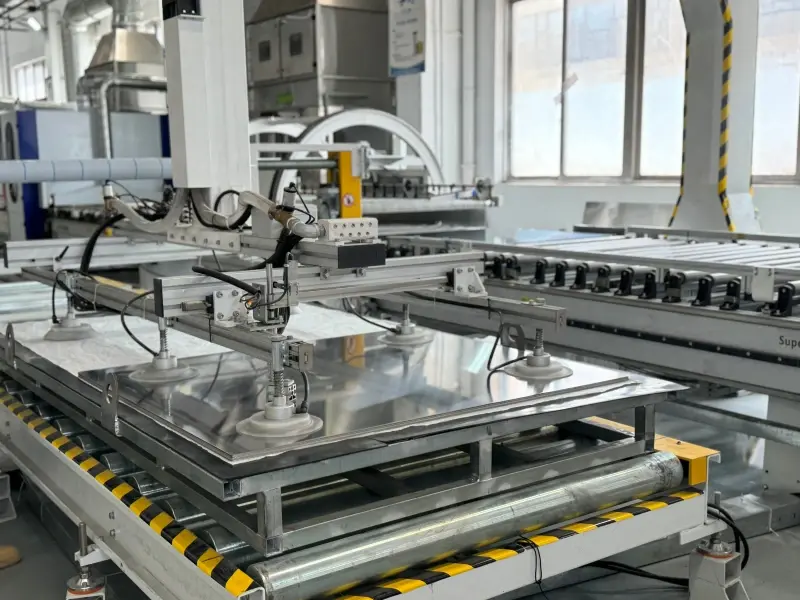
3.5 ブラインドビアと埋設ビアの穴あけ (DRILLING)
PCB製造において、約8mil以上のスルーホールはメカニカルドリルが主な方法である。メカニカル・ドリルでは、ブラインド・ビアとベ ルド・ビアが交差できない場所が決まります。8層ボードの例では、3-6層用の埋設ビア、1-2層用のブラインド・ビア、7-8層用のブラインド・ビアを同時に作ることができます。しかし、3-5と4-6のような交差する埋設ビアは作れないので設計できない。3-5や4-6のような非対称の埋設ビアパターンは、難易度とスクラップ率を大幅に上げる。コストは対称的な埋設ビアコストの6倍以上になるかもしれない。.

3.6 銅析出とめっき(メタライゼーション経由)
ビアメタライゼーションは、均一で耐熱性のある銅でドリル穴の壁を覆う。3つのステップ
- ドリルの残渣を取り除く。.
- 化学銅蒸着。.
- 銅を厚くするフルパネル電気メッキ。.
重要なパラメータ:アスペクト比(基板の厚さと穴の直径)。板厚が厚くなり、穴径が小さくなると、薬液が穴の中心に届きにくくなる。そのため、中心部のメッキが薄くなり、マイクロオープン不良が発生する可能性がある。設計者は、ボードハウスのプロセス限界を知る必要がある。ブラインド・ビアもスルー・ホールも、アスペクト比の制限を考慮しなければならない。.
3.7 第二内層ドライフィルム
レイヤー3~6の埋設ビアをメタライズした後、樹脂インクで穴を埋め、内側のドライフィルムのステップに戻ってレイヤー3と6のトレースを作る。これらが終わったら、もう一度黒/茶色の酸化を行い、2回目のラミネーションに出す。この2回目のラミネーションも1回目と同じ工程を踏む。.
3.8 セカンドラミネーション(HDIプレス)
HDIボードは絶縁層が薄いので、プレスが難しい。同じ厚さなら、RCCよりLDPの方が強度が高い。LDPは流れが遅いので、コントロールが容易。.
デザインノート
- ブラインド/埋没ビアのある内側エリアでは、窪みによるオープン回路を避けるため、外側トレースはビア位置を避けなければならない。.
- 第2層と最終層の間に埋設ビアが多すぎると、誘電体を薄くするチャネルができる。そのようなビアは可能な限り減らしてください。.
HDI CO₂レーザーブラインドビアでは、一般的な方法はコンフォーマルマスク技術です。パターンを外側の銅に転写し、レーザー・ビア位置に一致する小窓をエッチングし、その座標で高出力レーザーを使用する。これは減法多層製造に適している。.
3.9 コンフォーマルマスク(前処理によるレーザー)
コンフォーマルマスクには2つの部分がある:コンフォーマルマスク1とコンフォーマルマスク2だ:
- コンフォーマルマスク1:サブ基板の両側のブラインド・ビアにアライメントするエッチング・パッドと、自動露光機のエッチング・アライメント・ターゲット。後の加工やレーザー穴あけに役立つ。.
- コンフォーマルマスク2:基板の上下の銅に、レーザー穴より少し大きい窓をエッチングする。CO₂レーザー加工に備える。.
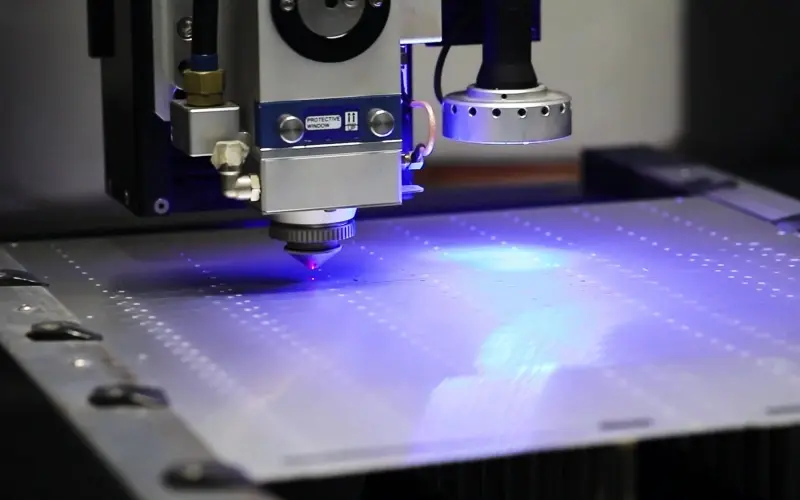
3.10 レーザー穴あけ (LASER DRILLING)
レーザー穴あけは、レーザーエネルギーで樹脂を焼き、ブラインドビアを形成する。レーザーエネルギーは上から下へ減衰するため、穴の直径は深さとともに狭くなります。一般的な穴径は4~6mil(0.10~0.15mm)です。IPC6016では、0.15mm以下の穴はマイクロビアと呼ばれています。.
0.15mm以上の穴はスパイラル加工が必要。速度は低下し、コストは急上昇する。現在主流となっているレーザー加工機では、3ショット穴あけ加工を採用している。速度は100~200穴/秒。小さい穴はもっと速くできる(0.100 mm穴~120穴/秒、0.076 mm穴~170穴/秒)。.
3.11 レーザービアメタライゼーション
レーザー穴は穴壁を焼き、炭化物を残す。第二銅層は酸化する可能性がある。ドリル残渣の除去には高圧水洗浄が必要。マイクロ・ビア・チャーの除去は難しい。積層2層HDIは特別なブラインドビアめっきと銅フィリング(COPPER FILLING)が必要。これはコストが高く、高級品に使われる。.
3.12 第3ドライフィルム
レーザービアメタライゼーション後、2回目のコンフォーマルマスク1を行う。その後、内側のドライフィルムのステップに戻り、レイヤー2と7のトレースを作る。トレースが終わったら、黒/茶色の酸化を行い、3回目のラミネーションを行う。その後、2回目のレーザー穴あけに備えて、3回目のブラインド・ヴィア・エッチング・ステップ1と2回目のブラインド・ヴィア・エッチング・ステップ2を行う。.
セカンドレベルHDIは多くのアライメントを必要とする。エラーは積み重なる。そのため、スクラップ率が高くなる。ビアの組み合わせで簡単なものから難しいものまである:
1-2+2-3ビア<1-3ビアのみ<1-2+1-3ビア<2-3+1-3ビア<1-2+2-3+1-3ビア。.
HDIビアは対称に設計すべきである。.
3.13 セカンド・レーザー・ドリル
2段階目のレーザー穴あけステップを、2レベルHDIの計画通りに実行する。これは最初のレーザー穴あけと同様のルールに従うが、慎重なアライメントとビアプランニングが必要である。.
3.14 メカニカル・ドリル(貫通穴)
レーザー・ステップの後、貫通穴のメカニカル・ドリルを行う。このステップでは、パネル全体を貫通する穴を開ける。.
3.15 ドリル残渣除去とビアめっき(P.T.H.)
すべてのビアがメタライズされるように、ブラインド・ビアとスルー・ホールを一緒にメッキする。この時点で特別なHDIフローは終了します。以降、基板は標準的なPCB仕上げ工程に従います。.
3.16 外層ドライフィルムとパターンめっき (DRY FILM & PATTERN PLATING)
外側のパターン転写は内側の層と似ている。主な違いはメッキ方法である:
- 減法:ネガフィルムを使う。硬化したドライフィルムが回路として残る。フィルムをエッチングして剥がし、回路を残す。.
- 添加剤/通常法:ポジフィルムを使用。硬化したドライフィルムで回路以外の部分を覆う。パターンメッキ(銅→錫)を行い、フィルムを剥がし、アルカリエッチングを行い、錫を除去し、回路を維持する。.
3.17 湿式ソルダーマスク (WET FILM SOLDER MASK)
ソルダーマスクは基板表面を覆う。間違ったはんだ付け、湿気や化学物質によるショートを防ぎ、物理的なダメージからトレースを保護します。これにより、PCBの機能が安定します。.
工程:プレ洗浄→コート→プリベーク→露光→現像→UV硬化→熱硬化。主な管理ポイント:ソルダーマスクのアライメント、マスクブリッジのサイズ、ビアの製造、マスクの厚さ。インクの品質は、後の表面仕上げ、SMT実装、基板寿命に影響する。.
3.18 選択的無電解金(IMMERSION GOLD)
化学ニッケル/金めっきは、ソルダーマスク後の表面仕上げです。トレースピッチが小さく、表面実装部品が多いプリント基板に適しています。パッドのコプラナリティと平坦性を助けます。金メッキは安定した保護効果があります。メッキ仕様:ニッケル~5μm、金0.05~0.1μm。金が厚すぎるとクラックが入り、はんだ接合部が弱くなる。金は薄すぎると保護力が弱い。ENIGは、場合によってははんだ付け性が悪く、パッドの黒ずみが目立つことがある。.
3.19 凡例印刷(C/M PRINTING)
凡例インクを使って凡例やマーキングを印刷する。これは後の組み立てや修理に役立ちます。.
3.20 フライス加工とプロファイリング (PROFILING)
完成したパネルをCNCルーターでUNITまたはSETサイズにカットする。エッジトリミングとスロット加工を行う。V-CUTが必要な場合は、それに応じてステップを追加する。主なパラメーター:プロファイル公差、面取りサイズ、内角半径。パターンとボードエッジの間に安全な距離をとる。.
3.21 電気テスト(E-TEST)
これは導通および絶縁試験である。主な方法は、ベッド・オブ・ネイルズ・テストとフライング・プローブ・テストである:
- ベッド・オブ・ネイル:汎用フィクスチャかカスタムフィクスチャか。汎用フィクスチャはコストが高いですが、多くのPCBに適合します。カスタムフィクスチャは部品単価は安いですが、特定のPCBにしか使えません。.
- フライング・プローブ:プローブをテストネットに移動させる。フレキシブルで小回りが利く。.
3.22 OSP(有機はんだ付け性保存剤)
OSPは、電気テストと目視チェックの後、裸銅パッドとスルーホールに有機膜を形成する。膜厚は0.3~0.5μm。分解温度は約300℃。.
主な利点:小さなピッチのプリント基板に適合する平坦なメッキ;シンプルなプロセス、低汚染、低コスト、良好なはんだ付け性。欠点:フィルムが薄く、傷がつきやすい。賞味期限が短い。.
今日、ENIGとOSPの組み合わせは高精度基板に使用されている。これらは保護とはんだ付け性を与え、場合によってはHASLに代わる鉛フリーの選択肢となる。コストは高くなる。.

3.23 最終監査(FINAL AUDIT)
PCBの外観、サイズ、電気的性能、メッキの品質を検査します。すべてが設計と業界標準に適合していることを確認します。.
3.24 パッキング(PACKING)
通過するプリント基板は、湿気や傷を防ぐために梱包してください。輸送中に基板を保護し、後で使用するためによく保管する。.




