Vorwort
Die Forschung zur BGA-Technologie begann in den 1960er Jahren. IBM in den Vereinigten Staaten verwendete sie zuerst. Praktisch wurde BGA aber erst Anfang der 1990er Jahre.
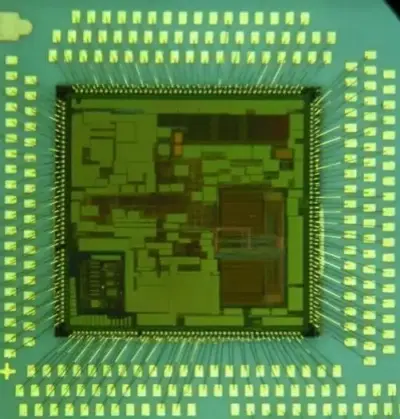
In den 1980er Jahren wollte man kleinere elektronische Schaltungen und mehr E/A-Pins. Oberflächenmontagetechnik (SMT) gab der Schaltungsmontage die Eigenschaften leicht, dünn, kurz und klein zu sein. Die SMT-Technik stellte auch höhere Anforderungen an die Pinabstände und die Koplanarität von Teilen mit vielen Anschlüssen. Aufgrund von Einschränkungen bei der Bearbeitungsgenauigkeit, der Herstellbarkeit, den Kosten und dem Montageverfahren lag die Grenze für den Pitch von QFP-Bauteilen (Quad Flat Pack) im Allgemeinen bei 0,3 mm. Diese Grenze schränkte die Entwicklung von Baugruppen mit hoher Dichte stark ein. Außerdem erforderten QFP-Bauteile mit kleinem Raster strenge Montageverfahren. Das schränkte ihre Verwendung ein. Aus diesem Grund konzentrierten sich einige US-Unternehmen auf die Entwicklung und Verwendung von BGA-Bauteilen. Sie waren der Ansicht, dass BGA-Bauteile den QFP-Bauteilen bei hoher Packungsdichte überlegen waren.
Was ist BGA?
BGA steht für Ball Grid Array. In diesem Gehäuse sind die Lötkugeln in einem Gitter auf der Unterseite des Gehäusesubstrats angeordnet. Diese Kugeln dienen als E/A-Verbindungen zwischen dem Gerät und der Leiterplatte (PCB). Die mit dieser Methode verpackten Teile sind oberflächenmontierte Bauteile. Frühe CPUs verwendeten DIP-Gehäuse, wie einige sehr einfache Mikrocontroller heute.
Mit dem schnellen Wachstum der Elektronikindustrie sind Computer und Mobiltelefone heute weit verbreitet. Die Menschen wollen mehr Funktionen und eine höhere Leistung von elektronischen Produkten, aber sie wollen auch eine geringere Größe und ein geringeres Gewicht. Dies führt dazu, dass die Produkte mehr Funktionen, höhere Leistung und geringere Größe aufweisen müssen. Um dieses Ziel zu erreichen, müssen die IC-Chips kleiner und komplexer werden. Dadurch steigt die Anzahl der Schaltkreis-E/A und die E/A-Dichte des Gehäuses nimmt zu. Um diesem Trend gerecht zu werden, wurden fortschrittliche Verpackungstechnologien mit hoher Packungsdichte entwickelt. Das BGA-Gehäuse ist eine dieser Technologien.
Von allen IC-Gehäusetypen verzeichnete BGA zwischen 1996 und 2001 das schnellste Wachstum. Im Jahr 1999 betrug die BGA-Produktion etwa 1 Milliarde Stück. Bis heute wird diese Technologie hauptsächlich für Geräte mit hoher Dichte und hoher Leistung eingesetzt. Die Entwicklung geht weiter zu feineren Abständen und höheren E/A-Zahlen. BGA-Gehäuse werden hauptsächlich für PC-Chipsätze, Mikroprozessoren/Controller, ASICs, Gate-Arrays, Speicher, DSPs, PDAs, PLDs und ähnliche Geräte verwendet.
BGA-Typen nach Gehäusematerial
Je nach Gehäusematerial umfassen BGA-Bauelemente hauptsächlich:
PBGA (Kunststoff-BGA)
CBGA (Keramisches BGA)
CCBGA (Keramisches Säulen-BGA)
TBGA (Tape BGA)
CSP (Chip Scale Package oder μBGA)
PBGA - Kunststoff-Kugel-Gitter-Array
PBGA verwendet BT-Harz/Glas-Laminat als Substrat. Das Gehäuse ist mit Kunststoff (einer Epoxidformmasse) versiegelt. Die Lötkugeln können aus bleihaltigen Legierungen (z. B. 63Sn37Pb, 62Sn36Pb2Ag) oder bleifreien Legierungen (z. B. Sn96,5Ag3Cu0,5) bestehen. Die Lötkugeln und der Gehäusekörper werden ohne Zugabe von zusätzlichem Lot zusammengefügt.
Einige PBGA-Gehäuse haben einen Hohlraum. Es gibt sie in den Versionen “Hohlraum oben” und “Hohlraum unten”. Diese PBGA-Gehäuse mit Hohlraum verbessern die Wärmeableitung und werden als thermisch verbesserte BGA oder EBGA bezeichnet. Manche nennen sie auch CPBGA (Cavity Plastic BGA).
Vorteile von PBGA:
Gute thermische Anpassung an die Leiterplatte. Das BT-Harz/Glas-Laminat in PBGA hat einen Wärmeausdehnungskoeffizienten (CTE) von etwa 14 ppm/°C. Viele PCBs haben einen CTE von etwa 17 ppm/°C. Die beiden Werte liegen nahe beieinander. Die thermische Anpassung ist also gut.
Beim Reflow-Löten nutzt PBGA den Selbstausrichtungseffekt der Lotkugeln. Die Oberflächenspannung des geschmolzenen Lots hilft bei der Ausrichtung der Kugeln auf den Pads.
Geringe Kosten.
Gute elektrische Leistung.
Nachteil von PBGA:
Empfindlich gegen Feuchtigkeit. Nicht geeignet für Geräte, die eine hermetische Abdichtung oder sehr hohe Zuverlässigkeit erfordern.
CBGA - Keramisches Kugelgitter-Array
CBGA hat die längste Geschichte unter den BGA-Familien. Das Substrat ist eine mehrschichtige Keramik. Zum Schutz des Chips, der Drahtbindungen und der Pads ist ein Metalldeckel mit Lötmittel auf dem Substrat versiegelt. Das Lotkugelmaterial für das Gehäuse ist eine Hochtemperaturlegierung, die im Quellentext als 10Sn90Pb bezeichnet wird. Für die Verbindung zwischen den Kugeln und dem Gehäusekörper wird eine Niedrigtemperaturlegierung wie 63Sn37Pb verwendet.
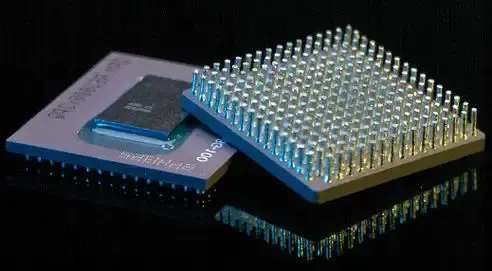
Vorteile von CBGA:
Gute Hermetizität und hohe Beständigkeit gegen Feuchtigkeit. Das gibt eine hohe langfristige Zuverlässigkeit.
Bessere elektrische Isolierung als PBGA.
Höhere Packungsdichte als PBGA.
Bessere Wärmeableitung als PBGA.
Nachteile von CBGA:
Der WAK von Keramiksubstrat und PCB ist sehr unterschiedlich. Die thermische Fehlanpassung ist schlecht. Ermüdung der Lötstellen ist eine der Hauptfehlerarten.
Höhere Kosten als PBGA.
Die Ausrichtung der Lötkugeln in der Nähe der Gehäusekante wird schwieriger.
TBGA - Tape Ball Grid Array
TBGA ist ein Hohlraumgehäuse. Bei TBGA gibt es zwei Möglichkeiten, den Chip mit dem Substrat zu verbinden: Flip-Chip-Lötung und Drahtbonden. Beim Flip-Chip-Bonden wird der Chip auf ein mehrlagiges flexibles Verdrahtungsband gebondet. Die Lötkugeln des Peripherie-Arrays, die als E/A-Anschlüsse dienen, werden unter dem flexiblen Band angebracht. Ein dicker Dichtungsdeckel dient sowohl als Kühlkörper als auch als Verstärkung. Dadurch werden die Lötkugeln unter dem flexiblen Substrat koplanarer. Der Chip ist mit einem Kupfer-Wärmespreizer im Hohlraum verbunden. Die Pads des Chips und die Pads des flexiblen Bandes sind durch Bonddrähte verbunden. Ein Dichtungsmittel umschließt das Die, die Drähte und die flexiblen Bandpads (durch Vergießen oder Beschichten).
Vorteile von TBGA:
Das flexible Band in der Verpackung passt sich besser an die Wärmeausdehnung der Leiterplatte an.
Beim Reflow-Löten kann der Selbstausrichtungseffekt des Lots genutzt werden. Die Oberflächenspannung der geschmolzenen Kugeln hilft bei der Ausrichtung der Kugeln auf den Pads.
TBGA ist das wirtschaftlichste BGA-Gehäuse.
Bessere Wärmeableitung als PBGA.
Nachteile von TBGA:
Empfindlich gegen Feuchtigkeit.
Mehrere Materialschichten in der Verpackung können die Zuverlässigkeit verringern.
Andere BGA-Typen
Andere Paketformen sind:
MCM-PBGA (Mehrfach-Chip-Modul-PBGA)
μBGA (Mikro-BGA), ein Gehäuse im Chipmaßstab
SBGA (Stacked Ball Grid Array)
etBGA (extra dünnes BGA), bei dem die Gehäusehöhe etwa 0,5 mm beträgt, was der Chipdicke nahe kommt
CTBGA, CVBGA (Thin and Very Thin Chip Array BGA) - dünne und sehr dünne BGAs
Standard-Nacharbeit
Prinzip der Standard-SMD-Rework-Systeme:
Sie verwenden Heißluft, um die Hitze auf die Stifte und Pads von oberflächenmontierten Bauteilen (SMD) zu konzentrieren. Dadurch werden die Lötstellen geschmolzen oder die Lötpaste fließt zurück, so dass die Teile entfernt oder gelötet werden können. Die Rework-Systeme der verschiedenen Anbieter unterscheiden sich vor allem durch die Wärmequelle und das Strömungsmuster der Heißluft. Einige Düsen blasen Heißluft über die SMDs. Aus Sicht des Bauteilschutzes ist es besser, den Luftstrom um die Leiterplatte herum zirkulieren zu lassen. Um einen Verzug der Leiterplatte zu vermeiden, sollten Sie ein Rework-System wählen, das die Leiterplatte vorwärmen kann.
BGA-Nacharbeit
Dieser Abschnitt fasst die BGA-Rework-Schritte am Beispiel eines HT996-Systems zusammen.
Ausbauen des BGA
Reinigen und glätten Sie die Lotreste auf den Leiterplattenpads mit einem Lötkolben. Verwenden Sie bei Bedarf Entlötlitze und eine Lötkolbenspitze mit flacher Klinge. Achten Sie beim Reinigen darauf, dass Sie die Pads oder die Lötmaske nicht beschädigen.
Verwenden Sie einen speziellen Reiniger, um Flussmittelrückstände zu entfernen.
Dehydratisierung (Backen)
PBGA-Bauteile sind empfindlich gegenüber Feuchtigkeit. Prüfen Sie vor dem Zusammenbau, ob das Teil Feuchtigkeit aufgenommen hat. Wenn es feucht ist, führen Sie einen Backvorgang durch, um die Feuchtigkeit zu entfernen.
Lötpastendruck
Da sich bereits andere Bauteile auf der Platine befinden, verwenden Sie eine spezielle kleine BGA-Schablone. Die Schablonendicke und die Öffnungsgröße hängen vom Kugeldurchmesser und -abstand ab. Prüfen Sie nach dem Druck die Druckqualität. Wenn sie nicht gut ist, reinigen Sie die Leiterplatte und trocknen Sie sie, dann drucken Sie erneut. Bei CSP mit einem Pitch unter 0,4 mm kann der Druck der Lotpaste übersprungen werden. Tragen Sie in diesem Fall Flussmittelpaste direkt auf die Leiterplattenpads auf.
Legen Sie die Leiterplatte in den Reflow-Ofen, um das Teil zu entfernen. Starten Sie das Reflow-Programm. Verwenden Sie bei Erreichen der Spitzentemperatur einen Vakuumsauger, um das Bauteil zu entfernen. Lassen Sie die Leiterplatte abkühlen.
Pad-Reinigung
Verwenden Sie einen Lötkolben und eine Entlötlitze, um die Lötrückstände auf den Leiterplattenpads zu reinigen und zu beseitigen. Achten Sie darauf, dass Sie die Pads und die Lötmaske nicht beschädigen.
Dehydrierung (wieder)
Da PBGA feuchtigkeitsempfindlich ist, sollten Sie feuchte Teile vor dem Zusammenbau überprüfen und ausbacken.
Lötpastendruck (erneut)
Verwenden Sie wie zuvor eine kleine BGA-spezifische Schablone. Die Schablonendicke und die Öffnung müssen mit der Kugelgröße und dem Abstand übereinstimmen. Prüfen Sie nach dem Druck die Druckqualität. Wenn sie nicht akzeptabel ist, reinigen und trocknen Sie die Leiterplatte und drucken Sie erneut. Bei CSP mit einem Pitch unter 0,4 mm können Sie den Druck überspringen und Flussmittelpaste auf die Pads auftragen.
Platzierung des BGA
Wenn das BGA neu ist, prüfen Sie seinen Feuchtigkeitsgehalt. Wenn es feucht ist, backen Sie es vor dem Einsetzen.
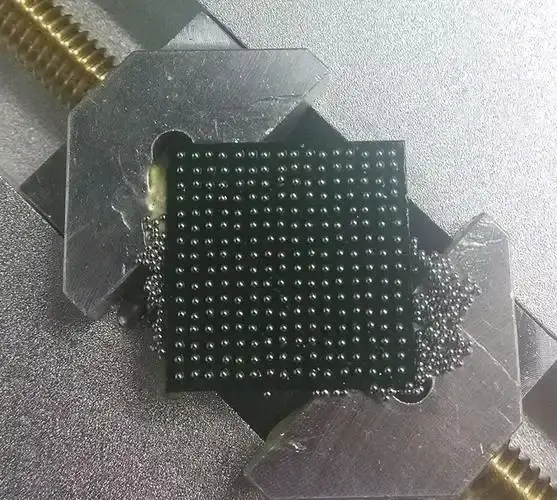
Im Allgemeinen können ausgebaute BGA-Teile wiederverwendet werden. Sie müssen jedoch zuerst wieder eingegossen werden. Schritte zur Platzierung eines BGA:
A. Legen Sie die Leiterplatte mit gedruckter Lotpaste auf die Werkbank.
B. Wählen Sie eine geeignete Düse und schalten Sie die Vakuumpumpe ein. Nehmen Sie das BGA mit der Düse auf, richten Sie die Unterseite des BGA an den Leiterplattenpads aus, senken Sie die Düse ab und platzieren Sie das BGA auf der Leiterplatte, schalten Sie dann das Vakuum aus.
Reflow-Löten
Stellen Sie das Reflow-Profil entsprechend der Bauteilgröße und der Leiterplattendicke ein. BGA-Reflow-Temperaturen sind im Allgemeinen etwa 15 °C höher als bei herkömmlichen SMD-Bauteilen.
Inspektion
Die Qualität von BGA-Lötstellen wird normalerweise mit Röntgen- oder Ultraschallgeräten geprüft. Wenn Sie nicht über diese Geräte verfügen, verwenden Sie Funktionstests oder erfahrene Sichtprüfungen.
Halten Sie die fertige Leiterplatte gegen ein Licht und prüfen Sie die BGA-Kanten. Achten Sie darauf, ob Licht durchkommt, ob der Spalt zwischen BGA und Leiterplatte an den Seiten gleichmäßig ist, ob die Lötpaste vollständig geschmolzen ist, ob die Form der Lötkugel gleichmäßig ist und wie stark die Kugel zusammenfällt.

Wenn die Verbindung nicht durchsichtig ist, kann es zu Überbrückungen oder Lötkugeln zwischen den Pads kommen.
Wenn die Kugelform unregelmäßig oder schief ist, kann die Temperatur zu niedrig sein. Unvollständiges Löten kann den Selbstausrichtungseffekt beim Reflow verhindern.
Die Höhe des Ball Collapse hängt von der Reflow-Temperatur, der Pastenmenge und der Pad-Größe ab. Bei korrektem Pad-Design beträgt der normale Kollaps nach dem Reflow etwa 1/5 bis 1/3 der Pre-Reflow-Kugelhöhe. Wenn der Kollaps zu groß ist, ist die Temperatur zu hoch und es kann zu Brückenbildung kommen.
Wenn der Abstand zwischen den BGA-Kanten und der Leiterplatte nicht gleichmäßig ist, ist die Temperatur um das Gehäuse herum nicht gleichmäßig.
Reballing-Verfahren (Lötkugelbefestigung)
Entfernen Sie Lötmittelreste auf den unteren BGA-Pads und reinigen Sie sie.
Verwenden Sie einen Lötkolben, um Lötmittelreste auf den Leiterplattenpads zu entfernen. Verwenden Sie Entlötlitze und eine flache Lötkolbenspitze. Achten Sie darauf, dass Sie die Pads oder die Lötmaske nicht beschädigen.
Verwenden Sie einen Spezialreiniger, um Flussmittelrückstände zu entfernen.

Flussmittel auf die unteren Pads des BGAs drucken
Verwenden Sie häufig hochviskose Flussmittel, da sie gut haften und das Löten erleichtern. Stellen Sie sicher, dass die gedruckten Flussmittelmuster klar sind und sich nicht ausbreiten. Manchmal wird anstelle von Flussmittel auch Lötpaste verwendet. Wenn Paste verwendet wird, muss die Metallzusammensetzung der Paste mit dem Metall der Lötkugel übereinstimmen.

Verwenden Sie zum Drucken eine kleine spezielle BGA-Schablone. Schablonendicke und -öffnung müssen dem Kugeldurchmesser und -abstand entsprechen. Prüfen Sie nach dem Druck die Druckqualität. Wenn sie nicht gut ist, reinigen und neu drucken.
Lotkugeln auswählen
Bei der Auswahl der Lötkugeln sollten Sie auf das Material und den Durchmesser der Kugeln achten. PBGA-Lötkugeln bestehen normalerweise aus 63Sn/37Pb, der gleichen Legierung wie Reflow-Lot. Wählen Sie also Kugeln mit der gleichen Legierung wie die Gerätekugeln.
Die Wahl der Kugelgröße ist wichtig. Wenn Sie hochviskoses Flussmittel verwenden, wählen Sie Kugeln mit demselben Durchmesser wie die Bauelementekugeln. Wenn Sie Lötpaste verwenden, wählen Sie Kugeln, die etwas kleiner sind als die Bauteilkugeln.
Befestigung der Kugel
Es gibt verschiedene Methoden, Bälle zu befestigen:
A) Methode mit der Kugelmühle
Wenn Sie eine Ball-Maschine haben, wählen Sie eine Schablone, die dem Layout des BGA-Pads entspricht. Die Öffnung der Schablone sollte 0,05-0,1 mm größer sein als der Kugeldurchmesser. Verteilen Sie die Kugeln gleichmäßig auf der Schablone. Schütteln Sie die Kugelmaschine, so dass zusätzliche Kugeln in die Auffangschale rollen und genau eine Kugel in jedem Loch verbleibt.
Legen Sie die Schablone auf die Werkbank. Nehmen Sie das gedruckte, mit Flussmittel oder Paste beschichtete BGA mit einer Vakuumdüse auf. Richten Sie das BGA auf den Kugeln in der Schablone aus und senken Sie es ab, so dass die Paste oder das Flussmittel die Kugeln auf den Bauteilpads hält. Verwenden Sie eine Pinzette, um den Rahmen des Bauteils zu halten, und schalten Sie das Vakuum aus. Legen Sie das Bauteil mit der Kugelseite nach oben auf den Arbeitstisch. Prüfen Sie, ob Kugeln fehlen, und fügen Sie sie bei Bedarf mit einer Pinzette hinzu.
B) Schablonenmethode
Legen Sie das mit Flussmittel oder Paste beschichtete BGA mit dem Flussmittel nach oben auf die Werkbank. Bereiten Sie eine Schablone vor, die dem Layout des BGA-Pads entspricht. Die Öffnung der Schablone sollte 0,05-0,1 mm größer als der Kugeldurchmesser sein. Stützen Sie die Schablone an den Rändern auf Unterlegscheiben ab, so dass der Abstand zum BGA gleich oder etwas geringer als der Kugeldurchmesser ist. Richten Sie die Schablone unter einem Mikroskop aus. Verteilen Sie die Kugeln gleichmäßig auf der Schablone. Überzählige Kugeln mit einer Pinzette entfernen, so dass in jedem Loch eine Kugel verbleibt. Entfernen Sie die Schablone und prüfen Sie, ob die fehlenden Kugeln noch vorhanden sind.
C) Manuelle Platzierung
Legen Sie das mit Flussmittel oder Paste beschichtete BGA auf die Werkbank. Verwenden Sie eine Pinzette oder einen Pick-up-Stift wie bei der normalen SMD-Bestückung, um die Kugeln einzeln zu platzieren.
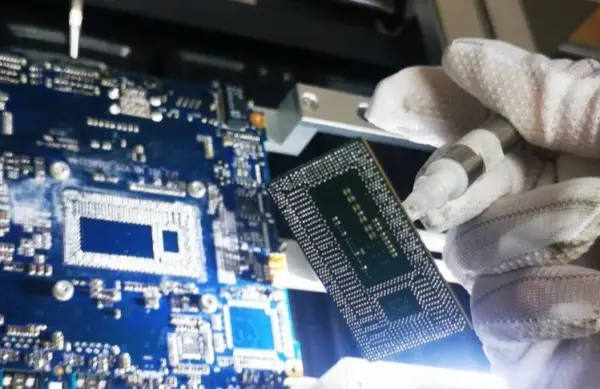
D) Lötpastendruckverfahren
Machen Sie die Schablone dicker und vergrößern Sie die Öffnung leicht. Drucken Sie Lotpaste direkt auf die BGA-Pads. Durch die Oberflächenspannung bilden sich nach dem Reflow Lötkugeln.
Reflow
Führen Sie das Reflow-Verfahren durch, um die Lötkugeln auf dem Bauteil zu fixieren.
Reinigung und Handhabung nach dem Löten
Reinigen Sie den BGA-Baustein nach dem Reballing gründlich. Montieren und löten Sie es dann so schnell wie möglich. Dadurch wird verhindert, dass die Lötkugeln oxidieren und das Bauteil Feuchtigkeit aufnimmt.
Zusammenfassung
Mit den ständigen Fortschritten in der Technologie ist das moderne Leben eng mit der Elektronik verbunden. Winzige Mobiltelefone, kleine Radios, tragbare Computer, Speicher, Festplatten, CD-Laufwerke und hochauflösende Fernsehgeräte erfordern alle eine Miniaturisierung und ein geringes Gewicht. Um dies zu erreichen, müssen wir an Produktionsprozessen und Komponenten arbeiten.
SMT (Surface Mount Technology) entsprach diesem Trend und legte den Grundstein für leichte, dünne, kurze und kleine elektronische Produkte. Seit die SMT in den 1990er Jahren ausgereift ist, haben die Trends bei elektronischen Produkten in Richtung Tragbarkeit, Miniaturisierung, Vernetzung und Multimedia die Montagetechnologie weiter vorangetrieben. Es entstanden neue Bestückungsmethoden mit hoher Packungsdichte. BGA ist eine dieser Methoden, die sich in der Praxis durchgesetzt hat. In diesem Artikel werden die Merkmale der BGA-Bestückung und die Qualitätskontrolle der Lötstellen vorgestellt.

