Lời nói đầu
Các nghiên cứu về công nghệ BGA bắt đầu từ những năm 1960. IBM tại Hoa Kỳ là đơn vị đầu tiên áp dụng công nghệ này. Tuy nhiên, BGA chỉ thực sự được ứng dụng rộng rãi vào đầu những năm 1990.
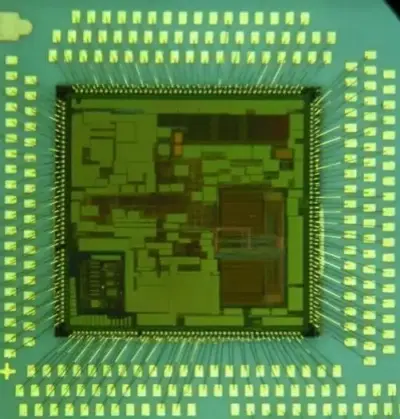
Vào những năm 1980, mọi người mong muốn có các mạch điện tử nhỏ gọn hơn và nhiều chân I/O hơn. Công nghệ lắp ráp bề mặt (SMT) đã mang lại cho việc lắp ráp mạch các đặc điểm như nhẹ, mỏng, ngắn và nhỏ gọn. SMT cũng đặt ra những yêu cầu cao hơn về khoảng cách chân cắm và độ đồng phẳng đối với các linh kiện có nhiều chân dẫn. Tuy nhiên, do những hạn chế về độ chính xác gia công, khả năng sản xuất, chi phí và quy trình lắp ráp, giới hạn khoảng cách chân cắm đối với các linh kiện QFP (Quad Flat Pack) thường được coi là 0,3 mm. Giới hạn này đã kìm hãm đáng kể sự phát triển của lắp ráp mật độ cao. Ngoài ra, các linh kiện QFP có khoảng cách chân nhỏ cần có quy trình lắp ráp nghiêm ngặt. Điều này đã hạn chế việc sử dụng chúng. Vì lý do đó, một số công ty của Mỹ đã tập trung vào việc phát triển và sử dụng các linh kiện BGA. Họ coi BGA là giải pháp vượt trội so với QFP cho các nhu cầu mật độ cao.
BGA là gì?
BGA là viết tắt của Ball Grid Array. Trong loại vỏ này, các quả cầu hàn được bố trí theo dạng lưới trên mặt dưới của đế vỏ. Các quả cầu này đóng vai trò là các điểm kết nối I/O giữa thiết bị và bảng mạch in (PCB). Các linh kiện được đóng gói theo phương pháp này thuộc loại linh kiện gắn bề mặt. Các bộ vi xử lý (CPU) thế hệ đầu tiên sử dụng vỏ DIP, giống như một số bộ vi điều khiển rất cơ bản hiện nay.
Ngày nay, với sự phát triển nhanh chóng của ngành công nghiệp điện tử, máy tính và điện thoại di động đã trở nên phổ biến. Người tiêu dùng mong muốn các sản phẩm điện tử có nhiều chức năng hơn và hiệu suất cao hơn, nhưng đồng thời cũng muốn kích thước nhỏ gọn và trọng lượng nhẹ hơn. Điều này thúc đẩy các sản phẩm hướng tới việc tích hợp nhiều chức năng hơn, hiệu suất cao hơn và kích thước nhỏ gọn hơn. Để đạt được mục tiêu này, các chip IC phải trở nên nhỏ gọn và phức tạp hơn. Từ đó, số lượng chân I/O của mạch tăng lên và mật độ chân I/O trên vỏ đóng gói cũng tăng theo. Để đáp ứng xu hướng này, các công nghệ đóng gói mật độ cao tiên tiến đã được phát triển. Đóng gói BGA là một trong những công nghệ đó.
Trong số tất cả các loại vỏ IC, BGA là loại có tốc độ tăng trưởng nhanh nhất trong giai đoạn 1996–2001. Năm 1999, sản lượng BGA đạt khoảng 1 tỷ đơn vị. Cho đến nay, công nghệ này vẫn chủ yếu được sử dụng cho các thiết bị có mật độ cao và hiệu suất cao. Công nghệ này tiếp tục phát triển theo hướng khoảng cách chân cắm nhỏ hơn và số lượng I/O cao hơn. Bao bì BGA chủ yếu được sử dụng cho chipset PC, vi xử lý/bộ điều khiển, ASIC, mảng cổng, bộ nhớ, DSP, PDA, PLD và các thiết bị tương tự.
Các loại BGA theo vật liệu vỏ
Tùy thuộc vào vật liệu đóng gói, các thiết bị BGA chủ yếu bao gồm:
PBGA (BGA nhựa)
CBGA (BGA gốm)
CCBGA (BGA cột gốm)
TBGA (BGA dạng băng)
CSP (Gói chip quy mô nhỏ hoặc μBGA)
PBGA — Mảng lưới bóng nhựa
PBGA sử dụng tấm composite nhựa BT/kính làm chất nền. Vỏ gói được bịt kín bằng nhựa (hợp chất đúc epoxy). Các hạt hàn có thể là hợp kim chứa chì (ví dụ: 63Sn37Pb, 62Sn36Pb2Ag) hoặc hợp kim không chì (ví dụ: Sn96.5Ag3Cu0.5). Các hạt hàn và thân vỏ được kết nối mà không cần thêm hàn.
Một số gói PBGA có khoang rỗng. Chúng có hai phiên bản là “khoang hướng lên” và “khoang hướng xuống”. Các gói PBGA có khoang rỗng này giúp cải thiện khả năng tản nhiệt và được gọi là BGA tăng cường tản nhiệt, hay EBGA. Một số người còn gọi chúng là CPBGA (Cavity Plastic BGA).
Ưu điểm của PBGA:
Khả năng tương thích nhiệt tốt với PCB. Lớp composite nhựa BT/thủy tinh trong PBGA có hệ số giãn nở nhiệt (CTE) khoảng 14 ppm/°C. Nhiều PCB có CTE khoảng 17 ppm/°C. Hai giá trị này khá gần nhau. Do đó, khả năng tương thích nhiệt là tốt.
Trong quá trình hàn nóng chảy, PBGA tận dụng hiệu ứng tự căn chỉnh của các hạt hàn. Lực căng bề mặt của chất hàn nóng chảy giúp căn chỉnh các hạt hàn với các điểm tiếp xúc.
Giá rẻ.
Hiệu suất điện tốt.
Nhược điểm của PBGA:
Dễ bị ảnh hưởng bởi độ ẩm. Không phù hợp với các thiết bị yêu cầu niêm phong kín hoàn toàn hoặc độ tin cậy rất cao.
CBGA — Mảng lưới bóng gốm
CBGA là loại có lịch sử lâu đời nhất trong các dòng BGA. Chất nền của nó là gốm nhiều lớp. Một nắp kim loại được hàn kín vào chất nền bằng chất hàn kín để bảo vệ chip, các mối hàn dây và các điểm tiếp xúc. Vật liệu của các quả cầu hàn cho gói sản phẩm là một hợp kim chịu nhiệt độ cao được ghi là 10Sn90Pb trong văn bản gốc. Kết nối giữa các quả cầu hàn và thân gói sản phẩm sử dụng một hợp kim có nhiệt độ thấp hơn, chẳng hạn như 63Sn37Pb.
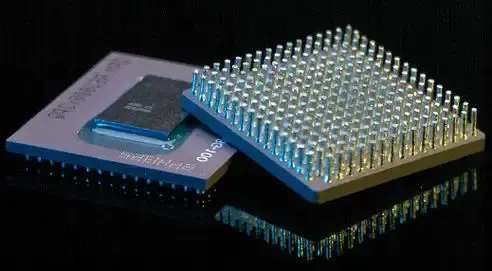
Ưu điểm của CBGA:
Khả năng kín khí tốt và khả năng chống ẩm cao. Điều này mang lại độ tin cậy cao trong thời gian dài.
Có khả năng cách điện tốt hơn so với PBGA.
Mật độ gói cao hơn so với PBGA.
Khả năng tản nhiệt tốt hơn so với PBGA.
Những nhược điểm của CBGA:
Hệ số dẫn nhiệt (CTE) của chất nền gốm và bảng mạch in (PCB) có sự chênh lệch lớn. Khả năng tương thích nhiệt kém. Mỏi mối hàn là nguyên nhân chính dẫn đến hỏng hóc.
Chi phí cao hơn so với PBGA.
Việc căn chỉnh các hạt hàn gần mép vỏ đóng gói trở nên khó khăn hơn.
TBGA — Mảng lưới bóng băng
TBGA là một loại vỏ đóng gói dạng khoang. Có hai phương pháp để kết nối chip với đế trong TBGA: hàn chip lật (flip-chip) và hàn dây (wire bonding). Trong phương pháp hàn chip lật, chip được gắn lên một dải băng linh hoạt nhiều lớp. Các quả cầu hàn ở mảng ngoại vi, đóng vai trò là các đầu nối I/O của mạch, được đặt bên dưới dải băng linh hoạt. Một nắp đậy dày đóng vai trò vừa là bộ tản nhiệt vừa là bộ gia cố. Điều này giúp các quả cầu hàn dưới đế linh hoạt nằm trên cùng một mặt phẳng hơn. Chip được hàn vào bộ tản nhiệt bằng đồng trong khoang rỗng. Các miếng đệm chip và miếng đệm băng dẻo được kết nối bằng dây hàn. Chất trám kín bao bọc chip, dây và miếng đệm băng dẻo (bằng cách đổ hoặc phủ).
Ưu điểm của TBGA:
Miếng băng dẻo trong gói sản phẩm phù hợp hơn với độ giãn nở nhiệt của bảng mạch in.
Hàn nóng chảy có thể tận dụng hiệu ứng tự căn chỉnh của chất hàn. Lực căng bề mặt của các giọt chất hàn nóng chảy giúp căn chỉnh các giọt này với các điểm tiếp xúc.
TBGA là loại vỏ BGA tiết kiệm chi phí nhất.
Khả năng tản nhiệt tốt hơn so với PBGA.
Những nhược điểm của TBGA:
Dễ bị ảnh hưởng bởi độ ẩm.
Các lớp vật liệu chồng lên nhau trong gói sản phẩm có thể làm giảm độ tin cậy.
Các loại BGA khác
Các dạng đóng gói khác bao gồm:
MCM-PBGA (Mô-đun nhiều chip PBGA)
μBGA (micro BGA), một loại vỏ đóng gói cỡ chip
SBGA (Mảng lưới bóng xếp chồng)
etBGA (BGA siêu mỏng) với chiều cao vỏ khoảng 0,5 mm, gần bằng độ dày của chip
CTBGA, CVBGA (BGA mảng chip mỏng và siêu mỏng) — các loại BGA mỏng và siêu mỏng
Sửa chữa theo tiêu chuẩn
Nguyên lý hoạt động của các hệ thống sửa chữa linh kiện SMD tiêu chuẩn:
Chúng sử dụng khí nóng để tập trung nhiệt vào các chân và điểm tiếp xúc của các linh kiện gắn bề mặt (SMD). Điều này làm chảy các mối hàn hoặc làm nóng chảy lại bột hàn để có thể tháo gỡ hoặc hàn các linh kiện. Các hệ thống sửa chữa của các nhà cung cấp khác nhau chủ yếu khác nhau về nguồn nhiệt và mô hình luồng khí nóng. Một số vòi phun thổi khí nóng lên trên SMD. Từ góc độ bảo vệ thiết bị, tốt hơn là nên để luồng khí lưu thông xung quanh PCB. Để ngăn ngừa hiện tượng cong vênh PCB, hãy chọn hệ thống sửa chữa có thể làm nóng trước PCB.
Sửa chữa BGA
Phần này tóm tắt các bước sửa chữa BGA, lấy hệ thống HT996 làm ví dụ.
Tháo BGA
Dùng mỏ hàn để làm sạch và làm phẳng phần hàn thừa trên các điểm hàn trên bảng mạch in. Sử dụng dây tháo hàn và đầu mỏ hàn phẳng khi cần thiết. Trong quá trình làm sạch, hãy cẩn thận để không làm hỏng các điểm hàn hoặc lớp phủ chống hàn.
Sử dụng chất tẩy rửa chuyên dụng để loại bỏ cặn chất hàn.
Quá trình khử nước (trong nướng bánh)
Các linh kiện PBGA rất nhạy cảm với độ ẩm. Trước khi lắp ráp, hãy kiểm tra xem linh kiện có bị hút ẩm hay không. Nếu linh kiện bị ẩm, hãy thực hiện bước sấy khô để loại bỏ độ ẩm.
In mực hàn
Vì các linh kiện khác đã được lắp sẵn trên bảng mạch, hãy sử dụng khuôn in BGA nhỏ chuyên dụng. Độ dày của khuôn in và kích thước lỗ in phụ thuộc vào đường kính và khoảng cách giữa các bóng hàn. Sau khi in, hãy kiểm tra chất lượng in. Nếu chất lượng không tốt, hãy làm sạch bảng mạch in (PCB) và lau khô, sau đó in lại. Đối với CSP có khoảng cách giữa các bóng hàn dưới 0,4 mm, có thể bỏ qua bước in bột hàn. Trong trường hợp đó, hãy bôi trực tiếp bột chất trợ hàn lên các điểm tiếp xúc trên bảng mạch in (PCB).
Đặt bảng mạch in (PCB) vào lò hàn lại để tháo linh kiện. Chạy chương trình hàn lại. Khi đạt đến nhiệt độ cao nhất, sử dụng dụng cụ hút chân không để tháo linh kiện. Để bảng mạch in nguội.
Vệ sinh miếng đệm
Sử dụng mỏ hàn và dây tháo hàn để làm sạch và làm phẳng các vết hàn còn sót lại trên các điểm hàn trên bảng mạch in. Hãy cẩn thận để không làm hỏng các điểm hàn hoặc lớp phủ chống hàn.
Mất nước (lại nữa)
Vì PBGA rất nhạy cảm với độ ẩm, nên hãy kiểm tra và sấy khô các bộ phận ẩm ướt trước khi lắp ráp.
In mực hàn (lần nữa)
Giống như trước đây, hãy sử dụng khuôn in nhỏ dành riêng cho BGA. Độ dày và kích thước lỗ của khuôn in phải phù hợp với kích thước bóng và khoảng cách giữa các bóng. Sau khi in, hãy kiểm tra chất lượng in. Nếu không đạt yêu cầu, hãy làm sạch và lau khô bảng mạch in (PCB) rồi in lại. Đối với CSP có khoảng cách giữa các bóng dưới 0,4 mm, bạn có thể bỏ qua bước in và bôi trực tiếp bột hàn lên các điểm tiếp xúc.
Lắp đặt BGA
Nếu BGA còn mới, hãy kiểm tra độ ẩm của nó. Nếu nó bị ẩm, hãy sấy khô trước khi lắp đặt.
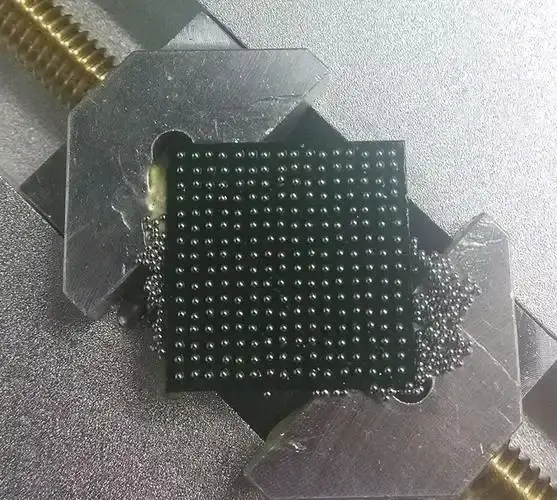
Thông thường, các linh kiện BGA đã tháo ra có thể được tái sử dụng. Tuy nhiên, trước tiên chúng phải được hàn lại các điểm tiếp xúc. Các bước để lắp đặt BGA:
A. Đặt bảng mạch in (PCB) đã được phủ keo hàn lên bàn làm việc.
B. Chọn đầu hút phù hợp và bật máy bơm chân không. Dùng đầu hút để nhấc BGA lên, căn chỉnh mặt dưới của BGA với các điểm tiếp xúc trên bảng mạch in (PCB), hạ đầu hút xuống và đặt BGA lên bảng mạch in, sau đó tắt máy bơm chân không.
Hàn nóng chảy
Cài đặt cấu hình hàn lại phù hợp với kích thước linh kiện và độ dày của bảng mạch in (PCB). Nhiệt độ hàn lại cho các linh kiện BGA thường cao hơn khoảng 15°C so với các linh kiện SMD truyền thống.
Kiểm tra
Chất lượng mối hàn BGA thường được kiểm tra bằng thiết bị X-quang hoặc siêu âm. Nếu không có các thiết bị này, hãy tiến hành kiểm tra chức năng hoặc kiểm tra bằng mắt thường dựa trên kinh nghiệm.
Giữ tấm PCB đã hoàn thiện trước ánh sáng và kiểm tra các cạnh của BGA. Kiểm tra xem ánh sáng có lọt qua được không, khe hở giữa BGA và PCB có đều đặn xung quanh các cạnh hay không, bột hàn có tan chảy hoàn toàn hay không, hình dạng của các hạt hàn có đều đặn không, và mức độ xẹp của các hạt hàn.

Nếu mối hàn không trong suốt, có thể có hiện tượng nối cầu hoặc các hạt hàn giữa các điểm tiếp xúc.
Nếu hình dạng của quả cầu không đều hoặc bị lệch, nhiệt độ có thể quá thấp. Việc hàn không hoàn toàn có thể cản trở hiệu ứng tự căn chỉnh trong quá trình nung lại.
Mức độ co lại của bóng phụ thuộc vào nhiệt độ hàn lại, lượng chất hàn và kích thước điểm tiếp xúc. Với thiết kế điểm tiếp xúc phù hợp, mức độ co lại bình thường sau khi hàn lại khoảng 1/5 đến 1/3 chiều cao ban đầu của bóng. Nếu mức độ co lại quá lớn, có nghĩa là nhiệt độ quá cao và có thể dẫn đến hiện tượng cầu nối.
Nếu khoảng cách giữa các cạnh của BGA và PCB không đồng đều, nhiệt độ xung quanh gói chip sẽ không đồng đều.
Quy trình hàn lại (gắn lại các hạt hàn)
Loại bỏ các vết hàn còn sót lại trên các điểm tiếp xúc phía dưới của BGA và làm sạch.
Dùng mỏ hàn để loại bỏ phần hàn thừa trên các điểm tiếp xúc của bảng mạch in. Sử dụng dây tháo hàn và đầu mỏ hàn phẳng. Hãy cẩn thận để không làm hỏng các điểm tiếp xúc hoặc lớp phủ chống hàn.
Sử dụng chất tẩy rửa chuyên dụng để loại bỏ cặn chất hàn.

In chất hàn lên các điểm tiếp xúc phía dưới của BGA
Thường sử dụng chất trợ hàn có độ nhớt cao nhờ tính năng bám dính và hỗ trợ hàn của nó. Đảm bảo các đường vân chất trợ hàn được in rõ ràng và không bị loang ra. Đôi khi người ta sử dụng bột hàn thay cho chất trợ hàn. Nếu sử dụng bột hàn, thành phần kim loại trong bột phải tương thích với kim loại của hạt hàn.

Khi in, hãy sử dụng khuôn in BGA chuyên dụng cỡ nhỏ. Độ dày và kích thước lỗ của khuôn in phải phù hợp với đường kính và khoảng cách giữa các bóng. Sau khi in, hãy kiểm tra chất lượng in. Nếu chất lượng không đạt yêu cầu, hãy làm sạch khuôn và in lại.
Chọn các viên hàn
Khi lựa chọn hạt hàn, cần xem xét chất liệu và đường kính của hạt. Hạt hàn PBGA thường sử dụng hợp kim 63Sn/37Pb, cũng là hợp kim được dùng trong quá trình hàn nóng chảy. Do đó, hãy chọn những hạt hàn có cùng hợp kim với các hạt hàn trên thiết bị.
Việc lựa chọn kích thước hạt hàn rất quan trọng. Nếu bạn sử dụng chất trợ hàn có độ nhớt cao, hãy chọn những hạt hàn có đường kính bằng với đường kính của các chip. Nếu bạn sử dụng bột hàn, hãy chọn những hạt hàn có đường kính nhỏ hơn một chút so với các chip.
Phụ kiện gắn bóng
Có một số cách để gắn quả bóng:
A) Phương pháp sử dụng máy bắn bóng
Nếu bạn có máy phân phối bi, hãy chọn một khuôn mẫu phù hợp với bố cục các điểm tiếp xúc BGA. Kích thước lỗ trên khuôn mẫu nên lớn hơn đường kính bi từ 0,05–0,1 mm. Rải đều các viên bi lên khuôn mẫu. Lắc máy phân phối bi để các viên bi thừa lăn vào khay thu gom, chỉ để lại đúng một viên bi trong mỗi lỗ.
Đặt khuôn lên bàn làm việc. Dùng đầu hút chân không nhấc miếng BGA đã được phủ keo hàn hoặc chất trợ hàn lên. Căn chỉnh và hạ miếng BGA xuống các chấm hàn trên khuôn sao cho keo hàn hoặc chất trợ hàn giữ các chấm hàn vào các điểm tiếp xúc trên thiết bị. Dùng kẹp nhíp giữ khung thiết bị và tắt chân không. Đặt thiết bị với mặt chấm hàn hướng lên trên bàn làm việc. Kiểm tra xem có chấm hàn nào bị thiếu không và dùng kẹp nhíp bổ sung nếu cần.
B) Phương pháp mẫu
Đặt BGA đã được phủ chất trợ hàn hoặc keo hàn lên bàn làm việc, mặt có chất trợ hàn hướng lên trên. Chuẩn bị một khuôn mẫu phù hợp với bố cục miếng đệm BGA. Kích thước lỗ khuôn mẫu phải lớn hơn đường kính bóng 0,05–0,1 mm. Đặt khuôn mẫu lên các miếng đệm xung quanh các cạnh để khoảng cách đến BGA bằng hoặc nhỏ hơn một chút so với đường kính bóng. Căn chỉnh dưới kính hiển vi. Rắc các bóng đều trên khuôn mẫu. Dùng nhíp loại bỏ các bóng thừa để mỗi lỗ chỉ còn lại một bóng. Tháo khuôn mẫu ra và kiểm tra, bổ sung các bóng bị thiếu.
C) Đặt thủ công
Đặt BGA đã được phủ chất trợ hàn hoặc keo dán lên bàn làm việc. Sử dụng kẹp hoặc bút gắp như khi lắp đặt linh kiện SMD thông thường để đặt các bóng hàn từng cái một.
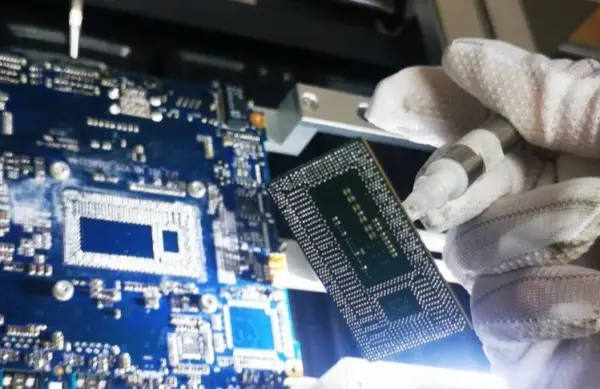
D) Phương pháp in bột hàn
Làm cho khuôn dày hơn và mở rộng lỗ một chút. In keo hàn trực tiếp lên các điểm tiếp xúc BGA. Lực căng bề mặt sẽ tạo thành các giọt hàn sau khi nung lại.
Quá trình hàn lại
Thực hiện quá trình nung lại để cố định các hạt hàn vào thiết bị.
Vệ sinh và xử lý sau khi hàn
Sau khi hàn lại, hãy làm sạch kỹ lưỡng thiết bị BGA. Sau đó, lắp ráp và hàn thiết bị càng sớm càng tốt. Điều này giúp ngăn chặn các hạt hàn bị oxy hóa và thiết bị bị hút ẩm.
Tóm tắt
Với những tiến bộ không ngừng của công nghệ, cuộc sống hiện đại ngày nay gắn bó mật thiết với các thiết bị điện tử. Từ những chiếc điện thoại di động nhỏ gọn, máy radio cỡ nhỏ, máy tính xách tay, bộ nhớ, ổ cứng, ổ đĩa CD cho đến tivi độ nét cao – tất cả đều đòi hỏi phải được thu nhỏ kích thước và giảm trọng lượng. Để đạt được điều này, chúng ta cần tập trung cải tiến các quy trình sản xuất và linh kiện.
Công nghệ lắp ráp bề mặt (SMT) đã bắt kịp xu hướng này và đặt nền móng cho sự ra đời của các sản phẩm điện tử nhẹ, mỏng, nhỏ gọn và có kích thước nhỏ. Kể từ khi công nghệ SMT phát triển hoàn thiện vào những năm 1990, xu hướng của các sản phẩm điện tử hướng tới tính di động, thu nhỏ kích thước, kết nối mạng và đa phương tiện đã thúc đẩy công nghệ lắp ráp tiến xa hơn. Các phương pháp lắp ráp mật độ cao mới đã xuất hiện. BGA là một trong những phương pháp lắp ráp mật độ cao đã được ứng dụng rộng rãi trong thực tế. Bài viết này giới thiệu các đặc điểm của quy trình lắp ráp BGA và việc kiểm soát chất lượng mối hàn.


