Πρόλογος
Η έρευνα για την τεχνολογία BGA ξεκίνησε τη δεκαετία του 1960. Η IBM στις Ηνωμένες Πολιτείες τη χρησιμοποίησε πρώτη. Αλλά η BGA έγινε πρακτική μόνο στις αρχές της δεκαετίας του 1990.
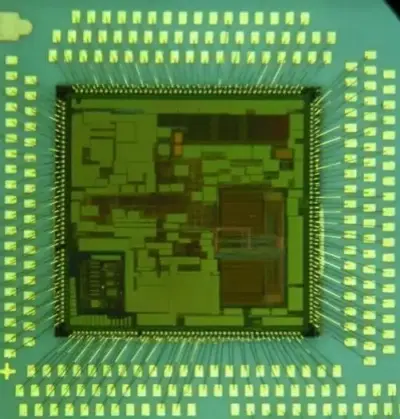
Στη δεκαετία του 1980, οι άνθρωποι ήθελαν μικρότερα ηλεκτρονικά κυκλώματα και περισσότερες ακίδες εισόδου/εξόδου. Τεχνολογία επιφανειακής τοποθέτησης (SMT) έδωσε στο συγκρότημα κυκλωμάτων τα χαρακτηριστικά του ελαφρού, λεπτού, μικρού και μικρού μεγέθους. Η SMT έφερε επίσης υψηλότερες απαιτήσεις για το βήμα των ακίδων και την ομοεπίπεδη διάταξη για εξαρτήματα με πολλά καλώδια. Ωστόσο, λόγω των περιορισμών στην ακρίβεια της κατεργασίας, την κατασκευασιμότητα, το κόστος και τη διαδικασία συναρμολόγησης, το όριο βήματος για τα εξαρτήματα QFP (Quad Flat Pack) θεωρούνταν γενικά 0,3 mm. Αυτό το όριο περιόριζε σε μεγάλο βαθμό την ανάπτυξη συναρμολόγησης υψηλής πυκνότητας. Επίσης, τα εξαρτήματα QFP με μικρό βήμα απαιτούσαν αυστηρές διαδικασίες συναρμολόγησης. Αυτό περιόριζε τη χρήση τους. Για το λόγο αυτό, ορισμένες αμερικανικές εταιρείες επικεντρώθηκαν στην ανάπτυξη και χρήση εξαρτημάτων BGA. Είδαν ότι το BGA ήταν ανώτερο από το QFP για τις ανάγκες υψηλής πυκνότητας.
Τι είναι η BGA;
BGA σημαίνει Ball Grid Array. Σε αυτή τη συσκευασία, οι μπάλες συγκόλλησης κατασκευάζονται σε ένα πλέγμα στο κάτω μέρος του υποστρώματος της συσκευασίας. Αυτές οι μπάλες λειτουργούν ως συνδέσεις I/O μεταξύ της συσκευής και της πλακέτας τυπωμένου κυκλώματος (PCB). Τα εξαρτήματα που συσκευάζονται με αυτή τη μέθοδο είναι συσκευές επιφανειακής τοποθέτησης. Οι πρώιμες CPU χρησιμοποιούσαν συσκευασίες DIP, όπως μερικοί πολύ βασικοί μικροελεγκτές σήμερα.
Σήμερα, με τη ραγδαία ανάπτυξη της βιομηχανίας ηλεκτρονικών ειδών, οι υπολογιστές και τα κινητά τηλέφωνα είναι κοινά. Οι άνθρωποι θέλουν περισσότερες λειτουργίες και ισχυρότερες επιδόσεις από τα ηλεκτρονικά προϊόντα, αλλά θέλουν επίσης μικρότερο μέγεθος και μικρότερο βάρος. Αυτό οδηγεί τα προϊόντα προς την κατεύθυνση περισσότερων λειτουργιών, υψηλότερων επιδόσεων και μικρότερου μεγέθους. Για να επιτευχθεί αυτός ο στόχος, τα τσιπ ολοκληρωμένων κυκλωμάτων πρέπει να γίνουν μικρότερα και πιο πολύπλοκα. Τότε ο αριθμός των κυκλωμάτων I/O αυξάνεται και η πυκνότητα I/O του πακέτου αυξάνεται. Για να ικανοποιηθεί αυτή η τάση, δημιουργήθηκαν προηγμένες τεχνολογίες συσκευασίας υψηλής πυκνότητας. Η συσκευασία BGA είναι μία από αυτές τις τεχνολογίες.
Μεταξύ όλων των τύπων συσκευασίας ολοκληρωμένων κυκλωμάτων, η BGA σημείωσε την ταχύτερη ανάπτυξη μεταξύ 1996 και 2001. Το 1999, η παραγωγή BGA ήταν περίπου 1 δισεκατοµµύριο µονάδες. Μέχρι σήµερα, η τεχνολογία αυτή εξακολουθεί να χρησιµοποιείται κυρίως για συσκευές υψηλής πυκνότητας και υψηλής απόδοσης. Συνεχίζει να κινείται σε λεπτότερο βήμα και υψηλότερους αριθμούς εισόδων/εξόδων. Η συσκευασία BGA χρησιμοποιείται κυρίως για chipsets PC, μικροεπεξεργαστές/ελεγκτές, ASICs, συστοιχίες πυλών, μνήμες, DSPs, PDAs, PLDs και παρόμοιες συσκευές.
Τύποι BGA ανά υλικό συσκευασίας
Ανάλογα με το υλικό συσκευασίας, οι διατάξεις BGA περιλαμβάνουν κυρίως:
PBGA (πλαστικό BGA)
CBGA (Κεραμικό BGA)
CCBGA (Κεραμική στήλη BGA)
TBGA (ταινία BGA)
CSP (Chip Scale Package ή μBGA)
PBGA - Πλαστική διάταξη πλέγματος σφαιρών
Το PBGA χρησιμοποιεί ως υπόστρωμα στρώμα ρητίνης BT/γυαλιού. Η συσκευασία σφραγίζεται με πλαστικό (εποξειδική ένωση χύτευσης). Οι σφαίρες συγκόλλησης μπορεί να είναι κράματα με μόλυβδο (για παράδειγμα 63Sn37Pb, 62Sn36Pb2Ag) ή κράματα χωρίς μόλυβδο (για παράδειγμα Sn96.5Ag3Cu0.5). Οι σφαίρες συγκόλλησης και το σώμα της συσκευασίας ενώνονται χωρίς την προσθήκη επιπλέον συγκόλλησης.
Ορισμένες συσκευασίες PBGA διαθέτουν κοιλότητα. Διατίθενται σε εκδόσεις με “κοιλότητα προς τα πάνω” και “κοιλότητα προς τα κάτω”. Αυτές οι συσκευασίες PBGA με κοιλότητα βελτιώνουν την απαγωγή θερμότητας και ονομάζονται θερμικά ενισχυμένες BGA ή EBGA. Ορισμένοι τα αποκαλούν επίσης CPBGA (Cavity Plastic BGA).
Πλεονεκτήματα της PBGA:
Καλή θερμική αντιστοίχιση με το PCB. Το έλασμα ρητίνης/γυαλιού BT στο PBGA έχει συντελεστή θερμικής διαστολής (CTE) περίπου 14 ppm/°C. Πολλά PCB έχουν CTE γύρω στα 17 ppm/°C. Οι δύο τιμές είναι πολύ κοντά. Επομένως, η θερμική αντιστοίχιση είναι καλή.
Κατά τη διάρκεια της συγκόλλησης επαναρροής, η PBGA χρησιμοποιεί το φαινόμενο αυτοευθυγράμμισης των σφαιρών συγκόλλησης. Η επιφανειακή τάση του λιωμένου συγκολλητικού βοηθά στην ευθυγράμμιση των σφαιρών στα μαξιλαράκια.
Χαμηλό κόστος.
Καλή ηλεκτρική απόδοση.
Μειονέκτημα της PBGA:
Ευαίσθητο στην υγρασία. Δεν είναι κατάλληλο για συσκευές που χρειάζονται ερμητική στεγανοποίηση ή πολύ υψηλή αξιοπιστία.
CBGA - Κεραμική συστοιχία πλέγματος σφαιρών
Η CBGA έχει τη μεγαλύτερη ιστορία μεταξύ των οικογενειών BGA. Το υπόστρωμά της είναι πολυστρωματικό κεραμικό. Ένα μεταλλικό καπάκι σφραγίζεται στο υπόστρωμα με συγκόλληση σφράγισης για την προστασία της μήτρας, των δεσμών καλωδίων και των μαξιλαριών. Το υλικό των σφαιρών συγκόλλησης για τη συσκευασία είναι ένα κράμα υψηλής θερμοκρασίας που χαρακτηρίζεται ως 10Sn90Pb στο αρχικό κείμενο. Η σύνδεση μεταξύ των σφαιρών και του σώματος της συσκευασίας χρησιμοποιεί κράμα χαμηλότερης θερμοκρασίας, όπως 63Sn37Pb.
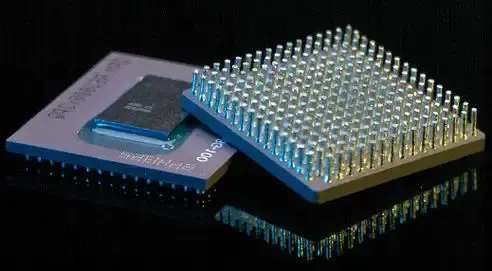
Πλεονεκτήματα της CBGA:
Καλή ερμητικότητα και υψηλή αντοχή στην υγρασία. Αυτό παρέχει υψηλή μακροπρόθεσμη αξιοπιστία.
Καλύτερη ηλεκτρική μόνωση από PBGA.
Υψηλότερη πυκνότητα συσκευασίας από την PBGA.
Καλύτερη απαγωγή θερμότητας από PBGA.
Μειονεκτήματα της CBGA:
Το CTE του κεραμικού υποστρώματος και του PCB διαφέρει πολύ. Η θερμική αναντιστοιχία είναι φτωχή. Η κόπωση της συγκολλητικής άρθρωσης είναι ένας κύριος τρόπος αστοχίας.
Υψηλότερο κόστος από PBGA.
Η ευθυγράμμιση των σφαιρών συγκόλλησης κοντά στην άκρη της συσκευασίας γίνεται δυσκολότερη.
TBGA - Συστοιχία πλέγματος μπάλας ταινίας
Η TBGA είναι μια συσκευασία με κοιλότητα. Υπάρχουν δύο τρόποι για τη σύνδεση της μήτρας με το υπόστρωμα στην TBGA: συγκόλληση με συγκόλληση flip-chip και συγκόλληση με σύρμα. Στο flip-chip, η μήτρα συγκολλάται πάνω σε μια πολυστρωματική εύκαμπτη ταινία καλωδίωσης. Οι μπάλες συγκόλλησης περιφερειακής συστοιχίας, οι οποίες λειτουργούν ως ακροδέκτες εισόδου/εξόδου κυκλώματος, τοποθετούνται κάτω από την εύκαμπτη ταινία. Ένα παχύ καπάκι σφράγισης χρησιμεύει τόσο ως ψύκτρα όσο και ως ενίσχυση. Αυτό καθιστά τις μπάλες συγκόλλησης κάτω από την εύκαμπτη ταινία πιο επίπεδες. Η μήτρα είναι συνδεδεμένη με έναν χάλκινο διανομέα θερμότητας στην κοιλότητα. Τα μαξιλαράκια της μήτρας και τα μαξιλαράκια της εύκαμπτης ταινίας συνδέονται με καλώδια συγκόλλησης. Ένα στεγανωτικό υλικό εγκιβωτίζει τη μήτρα, τα σύρματα και τα εύκαμπτα μαξιλαράκια ταινίας (με συγκόλληση ή επικάλυψη).
Πλεονεκτήματα της TBGA:
Η εύκαμπτη ταινία στη συσκευασία ταιριάζει καλύτερα με τη θερμική διαστολή της πλακέτας.
Η συγκόλληση ροής μπορεί να χρησιμοποιήσει το φαινόμενο αυτοευθυγράμμισης της κόλλησης. Η επιφανειακή τάση των λιωμένων σφαιρών βοηθά στην ευθυγράμμιση των σφαιρών με τα μαξιλαράκια.
Η TBGA είναι η πιο οικονομική συσκευασία BGA.
Καλύτερη απαγωγή θερμότητας από PBGA.
Μειονεκτήματα της TBGA:
Ευαίσθητο στην υγρασία.
Τα πολλαπλά στρώματα υλικού στη συσκευασία μπορούν να μειώσουν την αξιοπιστία.
Άλλοι τύποι BGA
Άλλες μορφές συσκευασίας περιλαμβάνουν:
MCM-PBGA (Μονάδα πολλαπλών τσιπ PBGA)
μBGA (micro BGA), συσκευασία κλίμακας chip
SBGA (Stacked Ball Grid Array)
etBGA (extra thin BGA) όπου το ύψος του πακέτου είναι περίπου 0,5 mm, κοντά στο πάχος του τσιπ
CTBGA, CVBGA (Thin and Very Thin Chip Array BGA) - λεπτές και πολύ λεπτές BGAs
Τυποποιημένη επανεπεξεργασία
Αρχή των τυποποιημένων συστημάτων επανεπεξεργασίας SMD:
Χρησιμοποιούν θερμό αέρα για τη συγκέντρωση θερμότητας στις ακίδες και τα μαξιλαράκια των διατάξεων επιφανειακής τοποθέτησης (SMD). Αυτό λιώνει τις ενώσεις συγκόλλησης ή επαναφέρει την πάστα συγκόλλησης ώστε να μπορούν να αφαιρεθούν ή να συγκολληθούν τα εξαρτήματα. Τα συστήματα επανεπεξεργασίας των διαφόρων προμηθευτών διαφέρουν κυρίως ως προς την πηγή θερμότητας και το μοτίβο ροής θερμού αέρα. Ορισμένα ακροφύσια διοχετεύουν θερμό αέρα πάνω από το SMD. Από την άποψη της προστασίας της συσκευής, είναι προτιμότερο η ροή του αέρα να κυκλοφορεί γύρω από την πλακέτα. Για να αποφύγετε την παραμόρφωση της πλακέτας PCB, επιλέξτε ένα σύστημα επανεπεξεργασίας που μπορεί να προθερμάνει την PCB.
Επεξεργασία BGA
Αυτή η ενότητα συνοψίζει τα βήματα επανεπεξεργασίας BGA χρησιμοποιώντας ως παράδειγμα ένα σύστημα HT996.
Αφαίρεση της BGA
Καθαρίστε και ισοπεδώστε τα υπολείμματα κόλλησης στα μαξιλαράκια της πλακέτας με ένα κολλητήρι. Χρησιμοποιήστε πλεξούδα αποκόλλησης και μύτη κολλητηριού με επίπεδη λεπίδα, όπως απαιτείται. Κατά τον καθαρισμό, προσέξτε να μην προκαλέσετε ζημιά στα μαξιλαράκια ή στη μάσκα συγκόλλησης.
Χρησιμοποιήστε ένα ειδικό καθαριστικό για να αφαιρέσετε τα υπολείμματα ροής.
Αφυδάτωση (ψήσιμο)
Τα εξαρτήματα PBGA είναι ευαίσθητα στην υγρασία. Πριν από τη συναρμολόγηση, ελέγξτε αν το εξάρτημα έχει απορροφήσει υγρασία. Εάν είναι υγρό, εκτελέστε ένα βήμα ψησίματος για να απομακρύνετε την υγρασία.
Εκτύπωση πάστας συγκόλλησης
Επειδή άλλα εξαρτήματα βρίσκονται ήδη στην πλακέτα, χρησιμοποιήστε ένα ειδικό μικρό στένσιλ BGA. Το πάχος του στένσιλ και το μέγεθος του ανοίγματος εξαρτώνται από τη διάμετρο και το βήμα της σφαίρας. Μετά την εκτύπωση, επιθεωρήστε την ποιότητα εκτύπωσης. Εάν δεν είναι καλή, καθαρίστε την πλακέτα και στεγνώστε την και, στη συνέχεια, εκτυπώστε ξανά. Για CSP με βήμα κάτω από 0,4 mm, η εκτύπωση πάστας συγκόλλησης μπορεί να παραλειφθεί. Σε αυτή την περίπτωση, εφαρμόστε πάστα ροής απευθείας στα μαξιλαράκια της πλακέτας.
Τοποθετήστε την πλακέτα PCB στο φούρνο επαναφοράς για να αφαιρέσετε το εξάρτημα. Εκτελέστε το πρόγραμμα επαναρροής. Στη μέγιστη θερμοκρασία, χρησιμοποιήστε μια αναρρόφηση κενού για να αφαιρέσετε το εξάρτημα. Αφήστε το PCB να κρυώσει.
Καθαρισμός μαξιλαριού
Χρησιμοποιήστε ένα κολλητήρι και μια πλεξούδα αποκόλλησης για να καθαρίσετε και να ισοπεδώσετε τα υπολείμματα κόλλησης στα μαξιλαράκια της πλακέτας. Προσέξτε να μην καταστρέψετε τα μαξιλαράκια ή τη μάσκα συγκόλλησης.
Αφυδάτωση (και πάλι)
Επειδή η PBGA είναι ευαίσθητη στην υγρασία, ελέγξτε και ψήστε τυχόν υγρά μέρη πριν από τη συναρμολόγηση.
Εκτύπωση πάστας συγκόλλησης (ξανά)
Όπως και προηγουμένως, χρησιμοποιήστε ένα μικρό στένσιλ ειδικά για BGA. Το πάχος του στένσιλ και το άνοιγμα πρέπει να ταιριάζουν με το μέγεθος και το βήμα της σφαίρας. Μετά την εκτύπωση, ελέγξτε την ποιότητα εκτύπωσης. Εάν δεν είναι αποδεκτή, καθαρίστε και στεγνώστε την πλακέτα και επανεκτυπώστε. Για CSP με βήμα κάτω από 0,4 mm, μπορείτε να παραλείψετε την εκτύπωση και να εφαρμόσετε πάστα ροής στα pads.
Τοποθέτηση του BGA
Εάν η BGA είναι καινούργια, ελέγξτε την περιεκτικότητά της σε υγρασία. Εάν είναι υγρή, ψήστε την πριν από την τοποθέτηση.
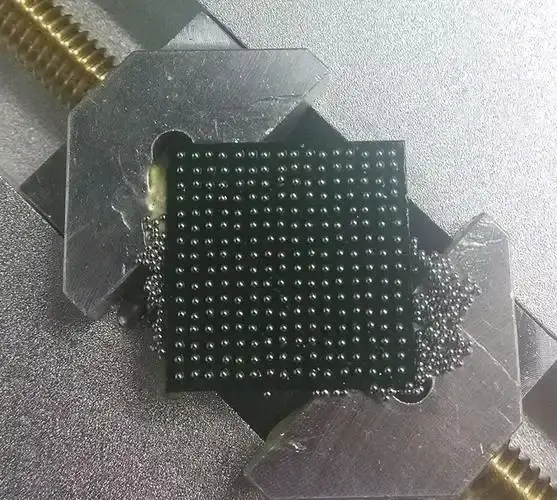
Γενικά, τα αφαιρούμενα εξαρτήματα BGA μπορούν να επαναχρησιμοποιηθούν. Αλλά πρέπει πρώτα να επανατοποθετηθούν. Βήματα για την τοποθέτηση μιας BGA:
A. Τοποθετήστε την πλακέτα PCB με την τυπωμένη πάστα συγκόλλησης στον πάγκο εργασίας.
B. Επιλέξτε ένα κατάλληλο ακροφύσιο και ενεργοποιήστε την αντλία κενού. Διαλέξτε την BGA με το ακροφύσιο, ευθυγραμμίστε το κάτω μέρος της BGA με τα μαξιλαράκια της πλακέτας, κατεβάστε το ακροφύσιο και τοποθετήστε την BGA στην πλακέτα και, στη συνέχεια, απενεργοποιήστε το κενό.
Συγκόλληση ροής
Ρυθμίστε το προφίλ επαναπλήρωσης ανάλογα με το μέγεθος της συσκευής και το πάχος της πλακέτας PCB. Οι θερμοκρασίες επαναπλήρωσης BGA είναι γενικά περίπου 15°C υψηλότερες από ό,τι για τα παραδοσιακά εξαρτήματα SMD.
Επιθεώρηση
Η ποιότητα της συγκολλητικής ένωσης BGA ελέγχεται συνήθως με εξοπλισμό ακτίνων Χ ή υπερήχων. Εάν δεν διαθέτετε αυτά τα εργαλεία, χρησιμοποιήστε λειτουργικές δοκιμές ή έμπειρους οπτικούς ελέγχους.
Κρατήστε την τελική πλακέτα PCB σε ένα φως και ελέγξτε τις άκρες BGA. Κοιτάξτε αν περνάει το φως, αν το διάκενο μεταξύ της BGA και της PCB είναι ομοιόμορφο στις πλευρές, αν η πάστα κόλλησης έλιωσε πλήρως, αν το σχήμα της μπάλας κόλλησης είναι κανονικό και η ποσότητα της κατάρρευσης της μπάλας.

Εάν η ένωση δεν είναι ημιδιαφανής, μπορεί να υπάρχουν γέφυρες ή μπάλες κόλλησης μεταξύ των μαξιλαριών.
Εάν το σχήμα της μπάλας είναι ακανόνιστο ή στραβό, η θερμοκρασία μπορεί να είναι πολύ χαμηλή. Η ελλιπής συγκόλληση μπορεί να αποτρέψει το φαινόμενο της αυτοευθυγράμμισης κατά την επαναρροή.
Το επίπεδο κατάρρευσης της σφαίρας εξαρτάται από τη θερμοκρασία επαναφοράς, την ποσότητα της πάστας και το μέγεθος του μαξιλαριού. Με το σωστό σχεδιασμό του μαξιλαριού, η κανονική κατάρρευση μετά την επαναρροή είναι περίπου το 1/5 έως το 1/3 του ύψους της σφαίρας πριν από την επαναρροή. Εάν η κατάρρευση είναι πολύ μεγάλη, η θερμοκρασία είναι πολύ υψηλή και μπορεί να εμφανιστεί γεφύρωση.
Εάν το διάκενο μεταξύ των άκρων της BGA και του PCB δεν είναι ομοιόμορφο, η θερμοκρασία γύρω από το πακέτο δεν ήταν ομοιόμορφη.
Διαδικασία επαναφοράς (προσάρτηση μπάλας συγκόλλησης)
Αφαιρέστε τα υπολείμματα κόλλησης στα κάτω μαξιλαράκια BGA και καθαρίστε τα.
Χρησιμοποιήστε ένα κολλητήρι για να αφαιρέσετε τα υπολείμματα κόλλησης στα μαξιλαράκια της πλακέτας. Χρησιμοποιήστε πλεξούδα αποκόλλησης και μια επίπεδη μύτη κολλητηριού. Προσέξτε να μην προκαλέσετε ζημιά στα μαξιλαράκια ή στη μάσκα συγκόλλησης.
Χρησιμοποιήστε ειδικό καθαριστικό για την αφαίρεση των υπολειμμάτων ροής.

Εκτύπωση ροής στα κάτω μαξιλαράκια του BGA
Συχνά χρησιμοποιείτε ροή υψηλού ιξώδους για τις ιδιότητες συγκόλλησης και υποβοήθησης της συγκόλλησης. Βεβαιωθείτε ότι τα τυπωμένα σχέδια ροής είναι καθαρά και δεν απλώνονται. Μερικές φορές χρησιμοποιείται πάστα συγκόλλησης αντί για ροή. Εάν χρησιμοποιείται πάστα, η σύνθεση του μετάλλου στην πάστα πρέπει να ταιριάζει με το μέταλλο της σφαίρας συγκόλλησης.

Για την εκτύπωση, χρησιμοποιήστε ένα μικρό ειδικό στένσιλ BGA. Το πάχος και το άνοιγμα του στένσιλ πρέπει να ταιριάζουν με τη διάμετρο και το βήμα της σφαίρας. Μετά την εκτύπωση, ελέγξτε την ποιότητα εκτύπωσης. Εάν δεν είναι καλή, καθαρίστε και επανεκτυπώστε.
Επιλέξτε μπάλες συγκόλλησης
Κατά την επιλογή των σφαιρών συγκόλλησης, λάβετε υπόψη το υλικό και τη διάμετρο της σφαίρας. Οι μπάλες συγκόλλησης PBGA χρησιμοποιούν συνήθως 63Sn/37Pb, το ίδιο κράμα που χρησιμοποιείται στις συγκολλήσεις επαναρροής. Επομένως, επιλέξτε μπάλες με το ίδιο κράμα με τις μπάλες της συσκευής.
Η επιλογή του μεγέθους της μπάλας έχει σημασία. Εάν χρησιμοποιείτε ροή υψηλού ιξώδους, επιλέξτε μπάλες με την ίδια διάμετρο με τις μπάλες της συσκευής. Εάν χρησιμοποιείτε πάστα συγκόλλησης, επιλέξτε μπάλες ελαφρώς μικρότερες από τις μπάλες της συσκευής.
Προσάρτημα μπάλας
Υπάρχουν διάφορες μέθοδοι για να συνδέσετε μπάλες:
Α) Μέθοδος μηχανής μπάλας
Εάν διαθέτετε μηχανή με μπίλιες, επιλέξτε ένα πρότυπο που να ταιριάζει με τη διάταξη των μαξιλαριών BGA. Το άνοιγμα του προτύπου πρέπει να είναι 0,05-0,1 mm μεγαλύτερο από τη διάμετρο της σφαίρας. Διασκορπίστε ομοιόμορφα τις μπάλες στο πρότυπο. Ανακινήστε το μηχάνημα με τις μπίλιες ώστε οι επιπλέον μπίλιες να κυλήσουν στο δίσκο συλλογής, αφήνοντας ακριβώς μία μπίλια σε κάθε τρύπα.
Τοποθετήστε το πρότυπο στον πάγκο εργασίας. Σηκώστε την εκτυπωμένη ροή ή την επικαλυμμένη με πάστα BGA με ακροφύσιο κενού. Ευθυγραμμίστε και χαμηλώστε την BGA πάνω στις μπάλες του προτύπου, έτσι ώστε η πάστα ή η ροή να συγκρατεί τις μπάλες στα μαξιλαράκια της διάταξης. Χρησιμοποιήστε λαβίδα για να κρατήσετε το πλαίσιο της διάταξης και απενεργοποιήστε το κενό. Τοποθετήστε τη συσκευή με την πλευρά των σφαιρών προς τα πάνω στον πάγκο. Ελέγξτε αν λείπουν σφαιρίδια και προσθέστε τα με λαβίδα αν χρειάζεται.
Β) Μέθοδος προτύπου
Τοποθετήστε το BGA με επικάλυψη ροής ή πάστας στον πάγκο, με τη ροή προς τα πάνω. Προετοιμάστε ένα πρότυπο που να ταιριάζει με τη διάταξη των ακροδεκτών BGA. Το άνοιγμα του προτύπου πρέπει να είναι 0,05-0,1 mm μεγαλύτερο από τη διάμετρο της σφαίρας. Υποστηρίξτε το πρότυπο γύρω από τις άκρες σε υποστυλώματα έτσι ώστε η απόσταση από την BGA να είναι ίση ή ελαφρώς μικρότερη από τη διάμετρο της σφαίρας. Ευθυγραμμίστε κάτω από μικροσκόπιο. Πασπαλίστε ομοιόμορφα τις μπίλιες στο πρότυπο. Αφαιρέστε τα επιπλέον σφαιρίδια με τσιμπιδάκι ώστε να παραμείνει ένα σφαιρίδιο σε κάθε οπή. Αφαιρέστε το πρότυπο και ελέγξτε, αναπληρώνοντας τυχόν σφαίρες που λείπουν.
C) Χειροκίνητη τοποθέτηση
Τοποθετήστε το BGA με επικάλυψη ροής ή πάστας στον πάγκο. Χρησιμοποιήστε τσιμπιδάκι ή στυλό συλλογής όπως με τη συνηθισμένη τοποθέτηση SMD για να τοποθετήσετε τις μπάλες μία προς μία.
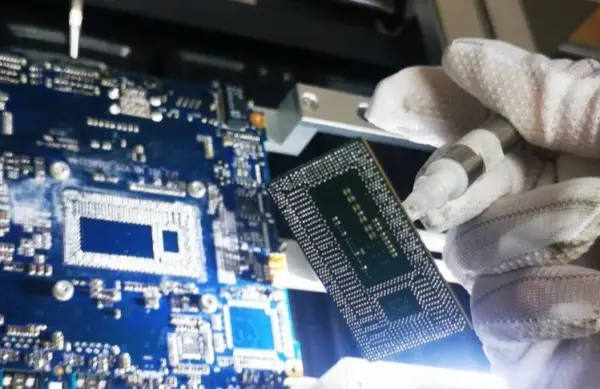
Δ) Μέθοδος εκτύπωσης πάστας συγκόλλησης
Κάντε το στένσιλ παχύτερο και διευρύνετε ελαφρώς το άνοιγμα. Εκτυπώστε πάστα συγκόλλησης απευθείας στα μαξιλαράκια BGA. Η επιφανειακή τάση θα σχηματίσει μπάλες συγκόλλησης μετά την επαναρροή.
Επαναρροή
Εκτελέστε επαναρροή για να στερεώσετε τις μπάλες συγκόλλησης στη συσκευή.
Καθαρισμός και χειρισμός μετά τη συγκόλληση
Μετά την εκ νέου σφαιροποίηση, καθαρίστε σχολαστικά τη διάταξη BGA. Στη συνέχεια, συναρμολογήστε και συγκολλήστε την το συντομότερο δυνατό. Με τον τρόπο αυτό αποφεύγεται η οξείδωση των σφαιρών συγκόλλησης και η απορρόφηση υγρασίας από τη συσκευή.
Περίληψη
Με τη συνεχή πρόοδο της τεχνολογίας, η σύγχρονη ζωή είναι στενά συνδεδεμένη με τα ηλεκτρονικά. Τα μικροσκοπικά κινητά τηλέφωνα, τα μικρά ραδιόφωνα, οι φορητοί υπολογιστές, οι μνήμες, οι σκληροί δίσκοι, οι μονάδες CD και οι τηλεοράσεις υψηλής ευκρίνειας απαιτούν μικρογραφία και μικρό βάρος. Για να το πετύχουμε αυτό, πρέπει να εργαστούμε σε διαδικασίες παραγωγής και εξαρτήματα.
Η τεχνολογία SMT (Surface Mount Technology) ανταποκρίθηκε σε αυτή την τάση και έθεσε τα θεμέλια για ελαφριά, λεπτά, μικρά και μικρού μεγέθους ηλεκτρονικά προϊόντα. Από τότε που η SMT ωρίμασε τη δεκαετία του 1990, οι τάσεις των ηλεκτρονικών προϊόντων προς τη φορητότητα, τη μικρογραφία, τη δικτύωση και τα πολυμέσα ώθησαν την τεχνολογία συναρμολόγησης περαιτέρω. Εμφανίστηκαν νέες μέθοδοι συναρμολόγησης υψηλής πυκνότητας. Η BGA είναι μια μέθοδος συναρμολόγησης υψηλής πυκνότητας που έχει φτάσει σε πρακτική χρήση. Αυτό το άρθρο εισήγαγε τα χαρακτηριστικά συναρμολόγησης BGA και τον ποιοτικό έλεγχο της συγκολλητικής άρθρωσης.


