ENIGとはElectroless Nickel Immersion Gold(無電解ニッケル浸金)の略。化学ニッケル浸漬金とも呼ばれる。プリント回路基板(PCB)に使用される表面仕上げです。よくENIGと略したり、ケミカル・ゴールド・ボードと呼んだりします。今日、多くの プリント基板 携帯電話内部の基板はENIGを使用している。 BGA キャリアボードもENIGを使用している。.
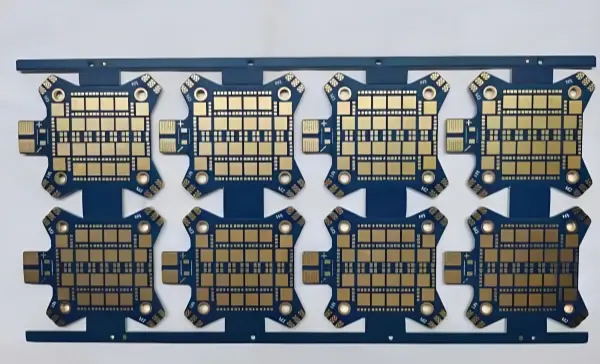
電解ニッケル-金めっきに比べ、ENIGはめっき工程で基板に電気を流す必要がありません。また、ニッケルと金をめっきするために各パッドにワイヤーを引く必要もない。工程が単純なため、生産者は多くの基板を素早く作ることができる。その結果、生産量が増え、コストが下がる。.
ENIGの生産フロー
一般的なプロダクション・シークエンスを2つ紹介しよう。ひとつは通常のENIGフロー。もうひとつは、より多くの金を必要とするパッド用の厚金フローである。.
典型的なENIGの流れ:
水平プレクリーン → 基板セット → 脱脂(油除去) → 水洗(×2) → マイクロエッチング → 水洗(×2) → 酸洗浄 → 純水洗(×2) → プレディップ → 活性化 → 純水洗(×3) → 化学ニッケル析出(Ni/P) → 純水洗(×2) → 無電解金 → 回収 → 純水洗(×2) → アンロード → 基板洗浄 → 基板検査
厚い金の流れ:
水平プレ洗浄 → 基板セット → 脱脂 → 水洗浄 (x2) → マイクロエッチング → 水洗浄 (x2) → 酸洗浄 → 純水洗浄 (x2) → プレディップ → 活性化 → 純水洗浄 (x3) → 化学ニッケル析出 (Ni/P) → 純水洗浄 (x2) → 金プレディップ → 厚膜金析出 → 回収 → 純水洗浄 (x2) → アンロード → 基板洗浄 → 基板検査
キー・ステップの説明 - シンプル
前処理:目的は銅をブラシやサンドブラストで磨き、酸化物を取り除くことです。これは銅の表面を荒らすことにもなります。粗くすることで、後でニッケルや金が密着しやすくなります。.
マイクロエッチング:過硫酸ナトリウムや硫酸を使って銅の酸化物を取り除く。マイクロエッチは、ブラッシングによる深い傷も軽減します。深いブラッシングの跡は、後に無電解ニッケルを金メッキが攻撃するのを助けます。.
活性化:銅はそれだけでは化学ニッケル析出を開始することができません。そこでまず、銅の上にパラジウム(Pd)の薄い層を置く。パラジウムはニッケル析出の触媒として働く。銅の方がパラジウムよりも活性が高いという事実を利用した化学反応である。パラジウムイオンはパラジウム金属に還元され、銅の表面に付着する。.
化学ニッケル(Ni/P):これはニッケル-リンの鉱床である。主な役割は、銅と金の間の移動と拡散を止めることである。また、はんだ付け中にはんだと反応して金属間化合物(IMC)を形成します。言い換えれば、ニッケル層は銅がはんだの中に移動しないようにし、はんだ接合を助けます。.
無電解ゴールド:金はニッケルを酸化から守ります。金ははんだ付けの化学反応に反応しない。金が多すぎると、はんだ接合強度が低下します。そのため、金層はニッケルを十分に覆い、酸化を防ぐ必要があります。チップオンボード(COB)のワイヤーボンディングを行う場合は、より厚い金層が必要です。ほとんどの表面パッドでは、0.05 µm (2 µ”) 前後の薄い層が一般的です。この薄い層は制御が容易で、電気メッキされたニッケル-金に比べてコストを下げることができます。.
ENIGの金が薄い理由とリスク
ENIGの金は非常に薄いため、ニッケルを空気と腐食から守るだけです。金が十分でない場合、ニッケルは空気と接触して腐食します。あるいは、酸性の金浴によって金が過剰にエッチングされることもあります。どちらの場合も「黒ニッケル」や「黒パッド」の原因となります。目視では金層はまだ光沢があるように見えるかもしれません。そのため、目視によるチェックは信頼できません。組立前にENIG PCBの品質をチェックすることは非常に重要です。.
黒ニッケル-どのように生成し、なぜ悪いのか
ニッケル層の品質は、化学蒸着中のニッケル浴の配合と温度管理に左右される。また、無電解金の工程も結果に影響します。化学ニッケルプロセスでは、次亜リン酸塩(次亜リン酸ナトリウム)とニッケル塩を自己触媒反応で使用します。析出物には若干のリン(P)が含まれる。研究によると、ニッケル析出物中の通常のリン含有量は 約7%~10%です。浴槽の保管状態が悪かったり、温度管理が 不十分であったりすると、リンの含有量はこの範囲 外となる。.

リンが低すぎると、ニッケル層が腐食しやすくなる。この腐食は、酸性の金浴がニッケルを攻撃することから始まることが多い。リンが高すぎると、析出物が硬くなります。これははんだ付け性を低下させる。また、信頼性の高いはんだ接合の形成にも支障をきたす。.
ニッケル析出物のリンが低く、無電解金めっきの工程がうまく処理されないと、金層が大きく割れることがある。後の洗浄の際、酸性の金浴は除去しにくい。露出したニッケルは、空気中でより早く腐食します。これは、黒パッドとも呼ばれる黒ニッケルにつながります。黒色パッドは、はんだ接合不良の原因となります。.
黒ニッケルが形成されると、基板表面の金層はまだ光沢のある金色に見えることがあります。そのため、そのパッドは問題ないと思われるかもしれません。高温のはんだ付けでは、金層ははんだペーストにすぐに溶け出します。腐食したニッケルは、溶融はんだと反応して金属間化合物(IMC)を作ることができません。これは、はんだ接合部の信頼性を低下させます。そして、接合部は小さな外力で簡単に割れてしまいます。.
リンが豊富な層 - 形成と害
ENIGでは、はんだと合金化する金属はニッケルである。典型的な金属間化合物 (IMC) は Ni3Sn4 である。ニッケル中のリンは金属化合物には結合しません。しかし、リンはニッケル析出物中に存在し、均等に広がっています。ニッケルが反応してIMCを形成すると、残ったリンが集まります。リンはIMCの端に集中し、リンに富む層を形成する。.
リンを多く含む層が厚すぎると、強度が低くなる。はんだ接合部に応力がかかると、最も弱い部分が最初に壊れます。多くの場合、リンを多く含む層がその弱点となる。そして、はんだ接合部の信頼性が低下する。.

これは高熱の鉛フリープロセスでは悪化する。プロセス管理が悪いと、IMCが厚くなる。IMCが厚くなるということは、残留リンが多くなるということです。つまり、リンの多い層が厚くなるのです。その結果、はんだ接合不良のリスクが高まります。リンを多く含む層は、IMCとニッケルの間の暗黒の帯として見ることができます。エネルギー分散型X線分光法(EDS)により、この帯はリンの含有量が非常に高いことがわかります。多くの不良事例では、リンを多く含む層が接合部の割れを引き起こしています。.
黒ニッケルとリンの多い層を防ぐには
黒ニッケルもリンを多く含む層も、隠れた欠陥である。通常の目視検査では見逃してしまうこともある。しかし、その原因が分かれば、適切な管理で防ぐことができる。.
ブラックニッケル用:
ニッケルめっき浴を維持し、温度を安定させる。これにより、ニッケルとリンの比率を適切な範囲に保つことができます。.
酸性金浴を維持する。金浴の腐食性が強すぎる場合は、時間内に調整する。.
前処理をよくコントロールすること。深いブラシラインは避ける。残留物をよく取り除く。.
パラジウムの播種が均一で、ニッケルがよく析出するように、活性化とリンスをコントロールする。.
ゴールドにひびが入らないよう、浸漬時間をコントロールする。.
ユーザーやバイヤーは、組み立てる前にENIGの品質をチェックしてください。いくつかの方法があります:
走査型電子顕微鏡(SEM)を使ってパッド表面を見る。金にクラックがあるかどうかを確認する。EDSを使ってニッケル中のリン比率を測定する。これでミクロの視点が明確になる。.
手動はんだ試験。代表的なパッドを手ではんだ付けし、接合部の引っ張り強度またはせん断強度を測定する。引っ張り強度が通常よりかなり低い場合、黒ニッケルが存在する可能性があります。このテストは簡単で短時間で行えます。.
酸性ガス腐食試験。ENIGサンプルを酸性ガスにさらす。粉が発生したり、表面が変色したりする場合は、金層に亀裂があることを意味する。これは黒ニッケルの可能性が高いことを示しています。.
この中では、2番目の方法が最も便利で速い。やり方も簡単だ。これらのチェックで、組み立てる前に問題を見つけることができる。そのため、後で故障する基板が減り、ロスが少なくなる。.
リンを多く含む層のコントロール
リンの多い層を減らすには、析出物のニッケル-リン比を適切な範囲に保つ。また、はんだ付けプロセスも管理する。はんだ時間とはんだ温度を管理する。IMCの厚さを約1~2ミクロン(µm)の最適範囲に近づけることを 目指す。IMCが厚くなりすぎると、より多くのリンが濃縮される。その結果、リンの多い層が悪化する。.
つまり、適切な浴槽のメンテナンス、温度管理、正確なはんだ付けプロファイルが鍵となります。これらのステップにより、IMCは薄く、リンを多く含む層は小さく保たれます。そうすれば、はんだ接合部の信頼性は高く保たれます。.
まとめ - シンプルなポイント
ENIGは、無電解ニッケルの後に無電解金を施したものです。電話PCBAや一部のBGAキャリアで一般的です。.
ENIGは電気めっきやパッド配線が不要なため、電気めっきニッケル-金よりも安価でシンプルである。.
主な工程は、前処理、マイクロエッチング、パラジウムによる活性化、化学ニッケル(Ni/P)、無電解金めっき。特殊なニーズには、厚金のバリエーションもある。.
化学ニッケルは銅と金のマイグレーションを阻止し、はんだIMCの形成を助けます。無電解金はニッケルを酸化から保護します。金は薄く、ニッケルを保護するだけでよい。金が多すぎるとはんだ強度が低下する。ワイヤーボンディング(COB)には厚い金を使用する。.
黒ニッケル(ブラックパッド)は、ニッケルのリンの含有量が間違っているか、金の層にひびが入った場合に発生します。黒ニッケルは光沢のある金の下に隠れることがあります。はんだ付け不良やクラックの原因となります。.
ニッケルがリンを含む場合、IMCエッジ付近にリンを多く含む層が形成される。厚いIMCと不十分な工程管理は、これを悪化させる。リンの多い層は接合強度を低下させ、クラックの原因となる。.
ニッケル浴と金浴をよく維持し、温度を管理し、深い刷毛目を避け、はんだのプロファイルを管理することによって問題を防ぐ。.
品質チェックには、SEM/EDS、手動はんだ引き試験、または酸性ガス腐食試験を使用します。手作業によるはんだ引き試験が最も迅速で簡単です。.
鉛フリープロセスでは、IMCの厚さを1~2 µm近くに保ち、リンを多く含む層が破損するリスクを低減する。.
よくある質問
ENIGは、非常に平坦な平坦面を持ち、保存性に優れ、ファインピッチ部品やBGAパッドの信頼性の高いはんだ付け性を実現します。表面平坦性に敏感なアセンブリによく選ばれています。.
平坦性(ファインピッチやBGAに適している)、良好な耐食性、安定したはんだ付け性、いくつかの有機仕上げと比較して長い保管/棚寿命。.
既知の問題としては、ニッケル-リン層が不適切に処理された場合の「ブラックパッド」(ニッケル腐食)があり、これははんだ接合部の信頼性に影響を与える可能性があります。これは、はんだ接合部の信頼性に影響を及ぼす可能性があります。ベンダーの適切な工程管理とQAがリスクを低減します。.
ENIGの金層は非常に薄く、主に保護用です。頻繁な嵌合/嵌合解除やエッジコネクターには、ニッケル上に硬質(電気メッキ)金を推奨します。.
はい。ENIGの平坦性と平坦性は、プロセスが適格であれば、ファインピッチ部品やBGAのはんだ付け性に適しています。.
仕上げを「ENIG(無電解ニッケル/無電解金めっき)」と明記し、要求される受け入れ基準(ニッケル/金クラス、表面粗さ、特別なめっきの注意事項など)があれば、加工業者があなたの期待を知ることができるように記載してください。.
アセンブリチームは、ENIG を他の高貴な仕上げと同様に扱う必要があります。通常のリフロー/はんだ付けプロファイルを使用しますが、ビアインパッドの充填や特殊な洗浄が必要な場合、あるいは ENIG 領域の近くでウェーブはんだ付けを予定している場合は、その調整を行う必要があります。.
ENEPIG(無電解ニッケル無電解パラジウム浸漬金)は、ニッケルと金の間にパラジウム層を追加し、場合によってはワイヤーボンディングとコンタクトの信頼性を向上させます。嵌合サイクル、ボンディングの必要性、ご予算に応じて仕上げをお選びください。.


