ここでいう金メッキとは、電解金メッキのこと。また、ニッケル金メッキ、電解金メッキ、電気金メッキ、電気ニッケル金メッキ基板なども含まれる。金メッキには大きく分けて2種類ある。ひとつは軟質金。もうひとつは硬質金。硬質金はしばしばゴールドフィンガーに使用される。.
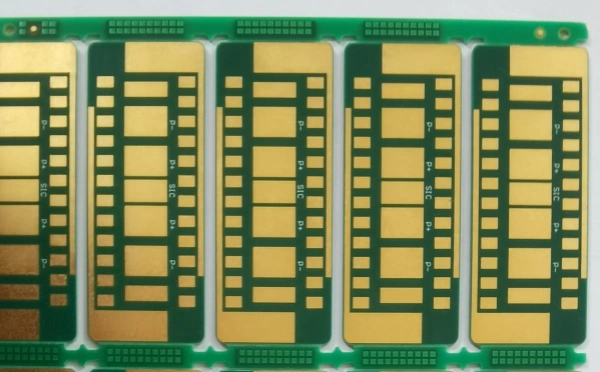
基本的な考え方は単純だ。ニッケルと金(しばしば金塩と呼ばれる)を薬品槽で溶かす。プリント基板をメッキ槽に入れる。そして電流を流す。そうすることで、基板の銅箔上にニッケル-金層が形成される。ニッケル金メッキは電子機器に広く使われている。めっき層が硬く、摩耗しにくく、酸化しにくいからです。.
なぜ金メッキプリント基板を使うのか?
ICのピン数が増えた。ピンとピンが接近している。スプレー錫プロセスでは、非常に微細なパッドを十分に平坦にすることができない。そのため きょくかんり 配置が難しい。また、錫鉛やHASL基板は保存期間が短い。金メッキ基板はこれらの問題のいくつかを解決します。.

表面実装技術の場合、そして0201以下のような非常に小さな部品の場合、パッドの平坦性は非常に重要です。パッドの平坦度は、はんだペーストの印刷品質に影響します。そして、それはリフローはんだ付けの品質に影響します。そのため、高密度で非常に小さなSMD作業では、フルボード金メッキが一般的です。.
トライアルやプロトタイプの段階では、部品の購入によって組み立てが遅れることがある。プリント基板が出来上がってから数週間から数ヶ月間、SMTを開始できないこともある。金メッキ基板は、錫リード基板よりも保存期間が長い。そのため、多くの人が金メッキ基板を好む。また、サンプルの場合、金メッキ基板のコストは錫リード基板に近い。.
配線が高密度になると、トレース幅と間隔は3-4milに達する。これにより、金線ショートのリスクが高まる。信号周波数が上がると、表皮効果がより重要になる。表皮効果とは、高周波の交流電流が導体表面近くを移動することを意味する。これは、メッキ層内での信号の伝わり方を変化させる。これが信号品質に影響を与える可能性がある。表皮の深さは周波数によって異なる。.
そのため、多くの設計において、金メッキははんだ付け性、保存寿命、機械的摩耗に役立つ。しかし、設計者は金線のショートや高周波での信号変化などの問題に注意しなければならない。.
ハードゴールドとソフトゴールド
ハードゴールドとは何か?
ハードゴールドとは、ゴールドの層に他の金属を加えることを意味する。これによって金の構造が変化する。層は硬くなる。よく使われる金属は、コバルト、ニッケル、銅、パラジウム、インジウム。かつては鉄、スズ、カドミウムも使われていた。今日ではコバルトとニッケルが一般的である。色を調整するために小さなインジウムが加えられることもある。.
メッキの硬度は合金の含有量に依存する。コネクタのコンタクトは、HV130-220程度の硬度を持つことが多い。18金のような装飾的または宝飾的なメッキは、硬度400前後に達することがあります。金-銅-カドミウムや最新の金-銅-インジウムのような過去の合金は非常に硬いことがあります。.
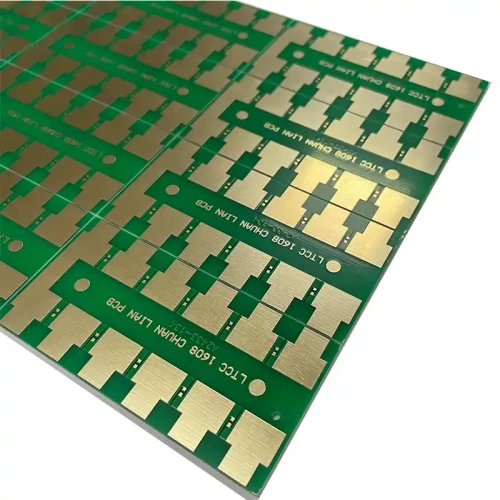
硬質金は耐摩耗性が重要な場合に使用される。例えば、コネクターの端子や装飾部品など。.
ソフトゴールドとは?
ソフトゴールドは純金メッキ。他の金属や元素は加えられていない。硬度はHV70程度と柔らかい。ソフトゴールドはチップボンディングや超音波ボンディングに適しています。LED業界では、ワイヤーボンディングにソフトゴールドをよく使用します。.
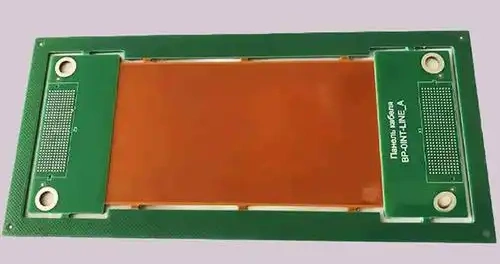
軟質金と硬質金のめっき順序
ソフト・ゴールド・シークエンス
酸洗→ニッケルめっき→純金めっき
ハード・ゴールド・シークエンス
酸洗→ニッケルめっき→プレゴールド(フラッシュゴールド)→金-ニッケルまたは金-コバルト合金の電解めっき
これらの順序は、現場での標準的な手順である。ニッケルの下地、そして金の仕上げを確実にする。プレゴールドステップは、ハードゴールドプロセスの密着性と最終的な硬度調整に役立ちます。.
無電解金めっきと電気めっきの違い
以下は、エンジニアがよく目にする実践的な違いである。製品のニーズに基づいてプロセスを選択する。.
結晶構造と厚みが異なる。無電解金(業界ではしばしばENIGと呼ばれる)と電気めっき金は異なる結晶構造を形成する。こちらの注釈によると、無電解めっきの金の方が厚く、より黄金色に見える傾向があります。顧客はその外観を好むかもしれない。.
無電解金めっきは、実際にははんだ付けが容易である。はんだ付けの欠陥が少なく、顧客からの苦情も少ない傾向があります。また、無電解金はストレスも少ない。ボンディングが必要な製品には、無電解金の方が適しています。しかし、無電解金は電気メッキされた硬質金よりも柔らかいため、無電解金は金指の耐摩耗性に劣ります。.
パッドにニッケルの下地がある限り、表皮効果の信号経路は銅の中に留まる。そのため、無電解ゴールドが信号伝送に悪影響を与えることはないはずだ。.
無電解金は結晶構造が緻密で酸化に強いと言われている。製品のニーズによってプロセスを選択する。.
配線が密になり、トレース幅や間隔が3~4milになると、電解めっき金は金線ショートを起こしやすくなります。パッドの下にニッケルを使用した無電解金めっきは、多くの場合、金線の短絡を避けることができます。.
ニッケル下地層付き無電解金パッドは、ソルダーマスクと銅との接合が良好です。そのため、マスクの密着がより強固になります。技術者が補正や手直しをする場合、距離は簡単には変わりません。.
無電解金めっきは、平坦度が高く、重要な組み立てが必要な基板によく使用される。無電解金めっきは、通常、組み立て後に黒パッドの問題が発生することはありません。無電解めっき金の平坦度と保存性は、多くの場合、良質の電気めっき金に匹敵します。.
注:これらのポイントは、ショップでの実務経験を反映したものです。常に特定の製品と組立ラインについてテストしてください。.
PCB表面金めっきプロセスフロー
以下は、フルボードの電気メッキハードゴールドのフロー例です。数値と手順はショップスタンダードに従う。.
全面電気めっき硬質金、金厚≤1.5μm
プロセスフロー
前工程 → 外層ドライフィルム → ドライフィルムチェック → パターンめっき銅-ニッケル-金 → 二次ドライフィルム → ドライフィルムチェック → ハード金電解めっき → 外層エッチング → 次工程
プロダクションノート
電解金に耐性のあるGPM-220ドライフィルムを使用する。.
フル基板にソルダーマスク印刷がない場合、2枚目のドライフィルムは必要ない。.
基板にソルダーマスクがある場合、2枚目のドライフィルムはパッドの窓の位置だけを覆ってください。基板全体にセカンドフィルムを貼らないでください。.
二次ドライフィルムフィルム(ドライフィルム用フィルム)は、ソルダーマスクフィルムと同じように機能させる。パッドのみを残し、ソルダーマスクフィルムと共用しないこと。ドライフィルムはソルダーマスクフィルムより2mil大きくなければならない。.
金厚1.5μm < 金厚≦4.0μm
プロセスフロー
前工程→外層ドライフィルム→ドライフィルムチェック→パターンめっき→外層エッチング→二次ドライフィルム→ドライフィルムチェック→銅-ニッケル-金のベタめっき→硬質金電解めっき→リード線剥離→次工程
プロダクションノート
電解金にはGPM-220ドライフィルムを使用する。.
フル基板にソルダーマスクが印刷されていない場合、2枚目のドライフィルムは必要ない。.
ソルダーマスクがある場合は、パッドの窓の部分のみドライフィルムにする。基板全体は行わないでください。.
二次ドライフィルムはパッドのみを保持し、ソルダーマスクフィルムと共有することはできません。ソルダーマスクフィルムより2mil大きいこと。.
金メッキのエリア間隔については、配線能力設計を参照のこと。.
ピールオフリード線またはリワークリード線を使用する。.
特記事項
厚い金メッキは現在、金-コバルト合金を使うことが多い。これはPCBプラグや接点スイッチのパッドによく使われる。.
フルボードの厚金の場合、厚金部分に SMT または BGA パッドがあるかどうかを評価する。もしそうなら、はんだ付け性に問題がある可能性があることを顧客に警告してください。そのような位置には、代わりにパターンめっきされた銅-ニッケル-金を提案してください。.
硬質金を必要とするリード・アウト・パッドがすでに準備されている場合は、外層エッチングの後、硬質金工程に直接進むことができる。.
金の厚さが4μmを超える基板は作らないこと。.
金+硬質金用の二次乾燥膜を使用するプロセスでは、金厚に対するスペーシング要件は、金厚0.38μmの場合は最小スペーシング7mil、0.8μmの場合は最小スペーシング8mil、1.0μm以上の場合は最小スペーシング10milである。.
フル基板電着ソフトゴールド(金厚≤1.5μm)
プロセスフロー
前工程 → 外層ドライフィルム → ドライフィルムチェック → パターンめっき銅-ニッケル-金 → 二次ドライフィルム → ドライフィルムチェック → 電解ソフト金めっき → 外層エッチング → 次工程
プロダクションノート
GPM-220ドライフィルムを使用する。.
フル基板にソルダーマスク印刷がない場合、2枚目のドライフィルムは必要ない。.
基板にソルダーマスクがある場合、2つ目のドライフィルムは、基板全体ではなく、パッドウィンドウのみに使用する。.
二次ドライフィルム膜イコールソルダーマスク膜。パッドのみ保管してください。ソルダーマスクフィルムと共有しないでください。ソルダーマスクフィルムより2mil大きいこと。.
金の厚さ1.5μm < 金≦4.0μm
プロセスフロー
前工程→外層ドライフィルム→ドライフィルムチェック→パターンめっき→外層エッチング→2次ドライフィルム→ドライフィルムチェック→パターンめっき銅-ニッケル-金→ソフト金電解めっき→リード線剥離→次工程
プロダクションノート
GPM-220ドライフィルムを使用する。.
フル基板にソルダーマスク印刷がない場合、2枚目のドライフィルムは必要ない。.
基板にソルダーマスクがある場合は、パッドウィンドウにのみドライフィルムを使用する。.
二次ドライフィルムはパッドのみを保持し、ソルダーマスクフィルムと共有しないこと。ソルダーマスクフィルムより2mil大きいこと。.
金領域の間隔については、配線能力設計に従ってください。.
ピールオフリード線または補修用リード線を使用する。.
特記事項
ソフト・ゴールドを必要とするリード・アウト・パッドがすでにある場合は、外層エッチングの後、ソフト・ゴールド・プロセスに従う。.
金の厚さが4μmを超える基板は作らないこと。.
二次ドライフィルムを使用した金+ソフトゴールドの場合、金厚に対するスペーシングルールは以下の通り:0.38μm最小間隔7mil;0.8μm最小間隔8mil;≥1.0μm最小間隔10mil。.
ニッケルフリー電気メッキゴールド(ハード/ソフトゴールド)
必要条件と注意事項
硬質金でも軟質金でも、お客様のご要望のニッケルフリー金については、最小金厚を0.5μmに管理する必要があります。0.5μm未満の場合は、ニッケルフリー金を使用しないでください。.
金の厚さが4μmを超える場合は、作らないこと。.
ハードゴールドまたはソフトゴールドにニッケル電気メッキを施したボードについても、同じ規則に従ってください。唯一の違いは、MIに「金のみ、ニッケルなし」という印をつけないことです。代わりに、必要なニッケルの厚さを記入してください。.
金+硬質金+二次ドライフィルムの場合、スペーシングルールは以下の通り:金0.38μm以上7mil未満、金0.8μm以上8mil未満、金1.0μm以上10mil未満。.
金めっきの設計要件と注意事項
リード線がある場合
リードとして、ゴールド・フィンガーの端に幅12ミルのトレースを追加する。仕上がりの銅の厚さ≤2オンスの場合、銅の厚さ>2オンスの場合、リード・トレースはボードの最小線幅より小さくならないようにしてください。ゴールド・フィンガーの両側、最も近いミリング・スロットで、電流を分割するために偽のゴールド・フィンガーを追加します。これにより、中間の金指の厚みが不均一になるのを防ぐことができます。.
リード線がない場合(局部電着金属)
穴あけ:基板を貫通するPTH穴のみを開ける。NPTH穴は2ドリル法で加工する。.
ソルダーマスク 1:MI備考にエレクトロゴールドフィルムを使用することを明記する。.
マーキング1:MI備考にはマーキングなし、ボードを焼くだけと記載。.
ソルダーマスク2:MI備考の状態でソルダーマスクを剥がす。ソルダーマスクを剥がした後は、酸化を避けるため、速やかに次の工程に移ってください。.
注意
I.配線フィルムは、電解金めっきされる位置をマスクしなければならない。.
II.トレースに接続されたエレクトロ・ゴールド・パッドの場合、パッドとトレースの接合部にティアドロップを追加する。.
III.ソルダーマスク 2: MI備考によると、エレクトロゴールドの表面はサンディングしてはならない。片面エレクトロゴールドの場合、前工程の洗浄では大きな銅面のみを研磨すること。.
フィリファストの金めっき能力
Philifastは信頼性の高いプリント基板用金めっきを提供します。軟質金と硬質金。無電解金めっき(ENIG)と電気めっき金めっきを行います。高密度基板、コネクター基板、長期保存を必要とする試作品に対応します。金フィンガー、ボンディングパッド、0201やそれ以下の部品に優れた平坦性を必要とする基板に実績があります。.
セールスポイント
迅速な見積もりと明確なリードタイム。.
ISO認証取得、RoHS対応。.
厳格な工程管理による専門的な金メッキライン。.
金の厚みと間隔を正確にコントロール。.
小ロットのクイックターンやプロトタイプのサポート。.
お客様にお見せするもの
メッキボードのサンプル写真をご希望の方はお問い合わせください。.
品質を証明する試験報告書と検査データ。.
はんだ付け性やスペーシングの問題を回避するための金メッキ設計の無料DFMチェック。.
安定しためっき、厳しい公差、迅速なサービスが必要な場合は、Philifastをお選びください。迅速なお見積もりと、お客様の金メッキ設計の無料DFMレビューについては、弊社までお問い合わせください。.
よくある質問
ENIGは無電解めっきプロセスで、無電解ニッケルの層が、平坦性とはんだ付け性のために非常に薄い無電解金で覆われています。ハードゴールドは電気めっきで、はるかに厚く、機械的摩耗(嵌合サイクル)に最適化されています。フラットBGA/ファインピッチパッドにはENIGを、エッジコネクターにはハードゴールドをお選びください。.
一般的な ENIG の無電解 金は非常に薄い(Au 層は 0.05~0.23 µm、Ni 層は数 µm)。エッジコネクター用の硬質金の厚さは、はるかに大きい(仕様によっては、数十マイクロインチ/十分の一μm~>0.5μm)。ご注文の際は、必ず仕上がり厚さ(μinまたはμm)を明記してください。.
長期保存可能期間、優れた平坦性(BGA/ファインピッチ用)、耐食性、耐嵌合/耐摩耗性(エッジコネクタ)が必要な場合は、金メッキを使用する。一般的な低コストの基板には、HASL/OSPで十分な場合があります。.
金厚測定、めっき欠陥の目視検査、接触抵抗/導通試験、故障リスクが高い場合は(ENIGの場合)断面検査または蛍光X線検査を依頼する。嵌合コンタクトの場合は、嵌合サイクルテストも含める。.
はい-ENEPIG(無電解ニッケル無電解パラジウム浸漬金)は、場合によってはワイヤーボンディングとコンタクトの信頼性を向上させます。ボンディング、嵌合サイクル、腐食、コストのトレードオフによって選択する。.


