Dưới đây là bản dịch tiếng Anh. Tôi đã sử dụng ngôn ngữ rõ ràng, đơn giản và các từ nối cơ bản (và, nhưng, nên, sau đó, vì). Tôi đã giữ nguyên các thuật ngữ kỹ thuật và số liệu chính xác. Văn bản dài (hơn 1800 từ) như bạn yêu cầu.
Quy trình cơ bản để sản xuất bảng mạch HDI có lỗ mù và lỗ chôn
1. Tổng quan
HDI là viết tắt của High Density Interconnect. Đây là công nghệ PCB phát triển vào cuối thế kỷ 20. Ưu điểm chính là việc sử dụng công nghệ khoan laser. Khoan cơ học truyền thống bị giới hạn bởi kích thước mũi khoan. Khi kích thước lỗ đạt 0,15 mm, chi phí tăng đáng kể và việc tối ưu hóa trở nên khó khăn. Lỗ khoan laser HDI có thể chỉ từ 3–5 mil (0,076–0,127 mm). Độ rộng đường dẫn có thể là 3–4 mil (0,076–0,10 mm). Kích thước pad trở nên nhỏ hơn nhiều. Nhiều đường dẫn có thể được bố trí trong cùng một khu vực. Điều này cho phép thực hiện kết nối mật độ cao.
HDI cho phép các nhà thiết kế sử dụng các gói linh kiện có mật độ cao như BGA và QFP. Mức độ kết nối đầu tiên (HDI) hiện nay phổ biến cho BGA có khoảng cách chân 0,5 mm. Khi việc bố trí mạch BGA chuyển từ thoát góc sang thoát trung tâm, mức độ kết nối đầu tiên Chỉ số Phát triển Con người (HDI) Không còn có thể đáp ứng một số nhu cầu. HDI cấp hai trở thành trọng tâm cho nghiên cứu và phát triển (R&D) và sản xuất. HDI cấp một với lỗ mù laser chỉ kết nối bề mặt với lớp trong liền kề. HDI cấp hai có thể khoan từ bề mặt xuống lớp thứ ba, hoặc từ bề mặt qua lớp thứ hai đến lớp thứ ba. Điều này khó khăn hơn nhiều so với HDI cấp một.
2. Vật liệu
2.1 Loại vật liệu
- Tấm đồng: vật liệu cơ bản dùng để tạo ra các mẫu dẫn điện.
- Lõi (CORE): là phần cốt lõi của bảng mạch. Đây là bảng mạch hai mặt phủ đồng được sử dụng để tạo các lớp bên trong.
- Prepreg: Tấm nhựa bán đóng rắn được sử dụng làm keo cho bảng mạch nhiều lớp và làm vật liệu cách điện.
- Mực in mặt nạ hàn: được sử dụng cho mặt nạ hàn, cách điện và bảo vệ chống ăn mòn.
- Mực in Legend (in lụa): dùng để in dấu hiệu và nhãn mác.
- Vật liệu hoàn thiện bề mặt: bao gồm hợp kim thiếc-chì, niken-vàng, bạc, OSP, và các đối tượng khác.
2.2 Vật liệu cách nhiệt laminate
2.2.1 Các loại laminate thông dụng
Các vật liệu có nhiệt độ chuyển pha cao (Tg) phổ biến bao gồm MICA/EG-150T, SYST/S1141, Grace/MTC-97 và HITACHI/MCL-HD-67. Các vật liệu này được sử dụng khi cần độ bền nhiệt cao hơn.
2.2.2 Vật liệu cách điện chuyên dụng cho HDI
Các loại phổ biến và thông số kỹ thuật:
- Vật liệu RCC: 80T18, 60T12, 65T12, 80T12, 60T18.
- fr4 (LDP): 1080, 106.
Lưu ý: Tôi đã sử dụng “fr4” cho FR-4 theo yêu cầu của bạn.
2.3 Vật liệu đặc biệt: Giải thích về RCC
RCC là viết tắt của Resin Coated Copper. Đây là lá đồng được phủ một lớp màng nhựa đặc biệt. Lớp màng này bao phủ hoàn toàn các đường dẫn bên trong và đóng vai trò cách điện. RCC chủ yếu có hai loại: B-stage (Mitsui) và B+C stage (Polyclad).
Tính năng chính:
- Không có lớp sợi thủy tinh trong màng nhựa. Điều này giúp dễ dàng tạo ra các lỗ vi mô bằng laser hoặc plasma.
- Lớp cách điện mỏng và độ bền bóc tách cao.
- Độ bền cao và bề mặt mịn, thích hợp để khắc các đường mạch rất hẹp.
- Khoan laser cho HDI thường nhắm vào RCC. Các lỗ khoan laser có hình dạng giống như hình thang ngược, không phải hình trụ như các lỗ khoan cơ khí. Kích thước lỗ khoan thông thường là 0,076–0,10 mm.
Các vật liệu HDI khác (lõi, prepreg, lá đồng) không có gì đặc biệt. Thông thường, độ dày của lớp đồng bên trong khá mỏng: các lớp bên trong là 1 oz, các lớp bên ngoài là 0,5 oz, lớp đồng cơ bản được mạ lên 1 oz. Toàn bộ bảng mạch mỏng hơn. Vì RCC không có sợi thủy tinh, độ cứng và độ bền của nó thấp hơn so với các bảng mạch in (PCB) khác có cùng độ dày.
3. Quy trình sản xuất (ví dụ: bảng mạch 8 lớp 2+4+2)
Dưới đây, tôi liệt kê các bước chính và điểm quan trọng. Tôi sử dụng từ ngữ đơn giản và trình tự rõ ràng.
3.1 Cắt nguyên liệu thô (CUT)
Cắt các tấm đồng mạ lớn thành các kích thước phù hợp với máy móc sản xuất. Ba khái niệm cơ bản sau đây phải được làm rõ:
- ĐƠN VỊ: Một đơn vị thiết kế trong bố cục của khách hàng.
- BỘ: Gồm nhiều đơn vị kết hợp, bao gồm cạnh quy trình và dụng cụ.
- BỘ PHẦN: Nhiều bộ phận được ghép lại với nhau bằng viền công cụ để tạo thành một bộ phận sản xuất. Kích thước nguyên liệu thông dụng khi mua là 36,5 inch × 48,5 inch, 40,5 inch × 48,5 inch và 42,5 inch × 48,5 inch. Tỷ lệ thu hồi phụ thuộc vào thiết kế và mục đích sử dụng của bộ phận.

3.2 Quy trình màng khô lớp trong (INNER DRY FILM)
Bước tạo màng khô bên trong chuyển các mẫu của lớp bên trong. Các bước bao gồm: phủ màng photoresist, phơi sáng, phát triển, ăn mòn và tẩy màng:
- Laminate: Dán phim nhạy sáng lên bề mặt đồng. Ánh sáng làm cứng các phần tiếp xúc để tạo thành lớp bảo vệ.
- Phơi sáng và phát triển: phơi sáng phim. Các phần sáng sẽ cứng lại. Các phần tối vẫn mềm. Quá trình phát triển loại bỏ phần phim mềm.
- Gia công ăn mòn và bóc lớp bảo vệ: Gia công ăn mòn lớp đồng lộ ra. Sau đó bóc lớp màng bảo vệ đã cứng. Các đường dẫn của lớp trong được hình thành.
Mẹo thiết kế: Kiểm soát độ rộng tối thiểu của đường dẫn, khoảng cách và độ đồng đều. Nếu khoảng cách quá nhỏ, hiện tượng chập mạch có thể xảy ra trong quá trình ép laminate. Nếu đường dẫn quá mỏng, độ bám dính của màng có thể bị hỏng và đường dẫn bị đứt. Để lại khoảng cách an toàn cho quá trình sản xuất.
3.3 Oxy hóa màu đen hoặc nâu (Oxy hóa đen)
Sau khi hoàn thành các đường nét bên trong, hãy thực hiện quá trình oxy hóa màu đen hoặc nâu trước khi ép laminate. Mục tiêu chính:
- Loại bỏ dầu và tạp chất khỏi bề mặt đồng.
- Tăng diện tích bề mặt đồng để cải thiện khả năng kết dính với nhựa.
- Chuyển đổi bề mặt đồng không phân cực thành đồng ôxit (CuO) và đồng ôxit hai (Cu₂O) để cải thiện liên kết hóa học.
- Cải thiện khả năng chống ẩm ở nhiệt độ cao và giảm nguy cơ bong tróc giữa đồng và nhựa.
Nếu Cu₂O là sản phẩm chính, quá trình này được gọi là oxy hóa nâu (màu đỏ). Nếu CuO là sản phẩm chính, quá trình này được gọi là oxy hóa đen (màu đen).
3.4 Laminate (Ép)
Lamination kết dính tất cả các lớp bằng vật liệu prepreg ở giai đoạn B. Các bước chính:
- Xếp chồng: sắp xếp các lớp đồng, vật liệu prepreg, lõi trong, tấm thép không gỉ, tấm cách điện, giấy kraft và tấm ép ngoài. Đối với các bảng mạch có sáu lớp trở lên, cần thực hiện xếp chồng trước.
- Ép nóng: Đặt chồng vật liệu vào máy ép nóng chân không. Nhiệt độ làm tan chảy nhựa và liên kết các lớp vật liệu, lấp đầy các khe hở.
Lưu ý: Đảm bảo lớp phủ laminate đối xứng. Nếu lực căng không được cân bằng ở cả hai bên, hiện tượng cong vênh sẽ xảy ra. Kiểm soát phân bố đồng để tránh sự chênh lệch dòng chảy nhựa gây ra độ dày không đều. Lập kế hoạch trước cho các lỗ vias ẩn và chôn.
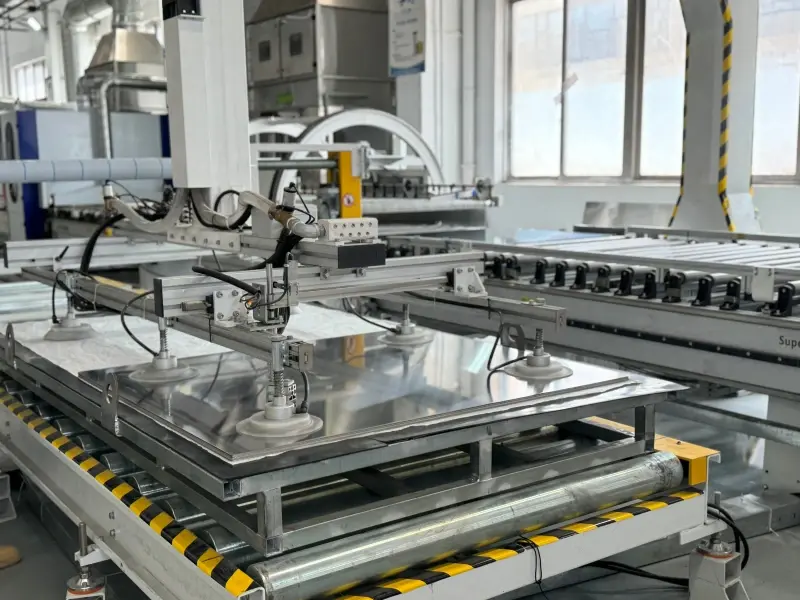
3.5 Khoan lỗ mù và lỗ chôn (KHOAN)
Trong sản xuất PCB, khoan cơ khí là phương pháp chính để tạo lỗ xuyên qua có đường kính lớn hơn khoảng 8 mil. Khoan cơ khí xác định vị trí mà các lỗ vias ẩn và lỗ vias chôn không thể giao nhau. Ví dụ với bảng mạch 8 lớp, bạn có thể tạo lỗ vias chôn cho các lớp 3–6, lỗ vias ẩn cho các lớp 1–2 và lỗ vias ẩn cho các lớp 7–8 cùng lúc. Tuy nhiên, bạn không thể thiết kế các lỗ vias chôn lấp giao nhau như 3–5 và 4–6 vì chúng không thể được tạo ra. Các mẫu lỗ vias chôn lấp không đối xứng (như 3–5 và 4–6) làm tăng đáng kể độ khó và tỷ lệ phế phẩm. Chi phí có thể cao gấp sáu lần so với chi phí của các lỗ vias chôn lấp đối xứng.

3.6 Điện phân đồng và mạ đồng (thông qua quá trình kim loại hóa)
Qua quá trình mạ đồng, bề mặt thành lỗ khoan được phủ một lớp đồng đồng nhất và chịu nhiệt. Ba bước:
- Loại bỏ cặn khoan.
- Điện phân đồng hóa học.
- Mạ điện toàn bộ bề mặt để làm dày lớp đồng.
Tham số chính: tỷ lệ khung (độ dày bảng mạch so với đường kính lỗ). Khi độ dày bảng mạch tăng và đường kính lỗ giảm, hóa chất không thể tiếp cận trung tâm lỗ một cách dễ dàng. Điều này có thể khiến lớp mạ mỏng ở trung tâm và gây ra các lỗi hở vi mô. Các nhà thiết kế phải nắm rõ giới hạn quy trình của nhà sản xuất bảng mạch. Cả lỗ mù/lỗ chìm và lỗ xuyên qua đều phải tuân thủ giới hạn tỷ lệ khung.
3.7 Lớp màng khô bên trong thứ hai
Sau khi mạ kim loại các lỗ vias chôn ngầm cho các lớp 3–6, đổ đầy lỗ bằng mực nhựa và quay lại các bước phim khô bên trong để tạo các đường dẫn cho các lớp 3 và 6. Sau khi hoàn thành các bước này, thực hiện quá trình oxy hóa đen/nâu lần nữa và sau đó gửi đi để thực hiện quá trình ép lớp lần thứ hai. Quá trình ép lớp lần thứ hai được thực hiện theo cùng quy trình như lần đầu.
3.8 Lớp phủ thứ hai (máy ép HDI)
Bảng HDI có lớp cách điện mỏng, do đó việc ép chặt khó hơn. Đối với cùng độ dày, độ bền của LDP tốt hơn so với RCC. LDP chảy chậm hơn, do đó việc kiểm soát dễ dàng hơn.
Ghi chú thiết kế:
- Trên các khu vực bên trong có các lỗ vi mạch bị che khuất/chôn vùi, các đường dẫn bên ngoài phải tránh vị trí của các lỗ vi mạch để tránh tình trạng mạch hở do các vùng lõm gây ra.
- Quá nhiều lỗ vias bị chôn giữa lớp thứ hai và lớp trước cuối cùng có thể tạo ra các kênh làm mỏng lớp cách điện. Hãy giảm thiểu các lỗ vias như vậy khi có thể.
Đối với các lỗ mù laser CO₂ HDI, phương pháp phổ biến là kỹ thuật mặt nạ phù hợp. Chuyển các mẫu lên lớp đồng ngoài, khắc các cửa sổ nhỏ trùng khớp với vị trí lỗ mù laser, sau đó sử dụng tia laser công suất cao tại các tọa độ đó. Phương pháp này phù hợp cho quá trình sản xuất đa lớp trừ.
3.9 Mặt nạ tuân thủ (xử lý trước bằng laser)
Mặt nạ định hình có hai phần: Mặt nạ định hình 1 và Mặt nạ định hình 2:
- Mặt nạ tuân thủ 1: Ghi các vùng etch trên cả hai mặt của bảng mạch con để khớp với các lỗ mù (blind via) và ghi các mục tiêu định vị cho máy phơi sáng tự động. Điều này hỗ trợ cho các công đoạn gia công sau này và khoan laser.
- Mặt nạ phù hợp 2: Tạo các cửa sổ trên lớp đồng trên và dưới của bảng mạch, có kích thước lớn hơn một chút so với lỗ laser. Điều này chuẩn bị cho quá trình gia công bằng laser CO₂.
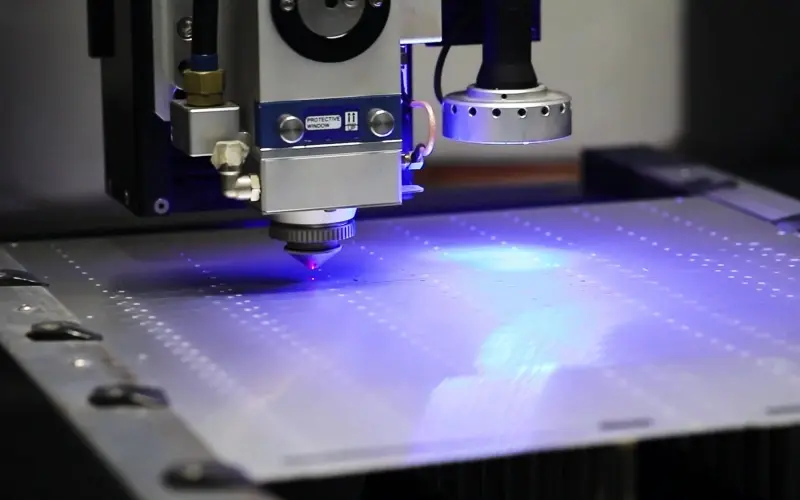
3.10 Khoan laser (KHOAN LASER)
Kỹ thuật khoan laser sử dụng năng lượng laser để đốt nhựa và tạo ra các lỗ mù. Năng lượng laser suy giảm từ trên xuống dưới, do đó đường kính lỗ thu hẹp theo độ sâu. Kích thước lỗ điển hình là 4–6 mil (0.10–0.15 mm). Theo tiêu chuẩn IPC6016, các lỗ có đường kính ≤0.15 mm được gọi là micro-vias.
Các lỗ có đường kính lớn hơn 0,15 mm cần sử dụng khoan xoắn ốc. Tốc độ giảm và chi phí tăng nhanh. Các công cụ laser chính thống hiện nay sử dụng phương pháp khoan ba lần. Tốc độ khoan là 100–200 lỗ mỗi giây. Các lỗ nhỏ hơn có thể khoan nhanh hơn (lỗ 0,100 mm ~120 lỗ/giây; lỗ 0,076 mm ~170 lỗ/giây).
3.11 Laser thông qua quá trình mạ kim loại
Lỗ laser đốt cháy thành lỗ và để lại vết cháy. Lớp đồng thứ hai có thể bị oxy hóa. Cần rửa bằng nước áp suất cao để loại bỏ cặn khoan. Vết cháy ở lỗ vi mô khó loại bỏ. Mạch in HDI hai tầng xếp chồng cần mạ lỗ mù đặc biệt và đổ đồng (COPPER FILLING). Điều này tốn kém và được sử dụng cho các sản phẩm cao cấp.
3.12 Lớp màng khô bên trong thứ ba
Sau khi hoàn thành quá trình mạ kim loại qua lỗ laser, thực hiện lớp mặt nạ bảo vệ thứ hai (Conformal mask1). Sau đó, quay lại các bước xử lý phim khô bên trong để tạo các đường dẫn của lớp 2 và 7. Sau khi hoàn thành các đường dẫn, thực hiện quá trình oxy hóa màu đen/nâu và lớp lamination thứ ba. Tiếp theo, thực hiện bước ăn mòn lỗ mù thứ ba (bước 1) và bước ăn mòn lỗ mù thứ hai (bước 2) để chuẩn bị cho quá trình khoan laser lần thứ hai.
Chỉ số Phát triển Con người (HDI) cấp hai đòi hỏi nhiều sự đồng bộ. Lỗi có thể tích lũy. Điều này làm tăng tỷ lệ phế phẩm. Từ dễ đến khó trong các kết hợp:
1–2 + 2–3 lỗ < chỉ 1–3 lỗ < 1–2 + 1–3 lỗ < 2–3 + 1–3 lỗ < 1–2 + 2–3 + 1–3 lỗ.
Các lỗ vias HDI nên được thiết kế đối xứng.
3.13 Khoan laser lần thứ hai
Thực hiện bước khoan laser thứ hai theo kế hoạch cho mạch in hai lớp (HDI). Quy trình này tuân theo các quy tắc tương tự như bước khoan laser đầu tiên nhưng yêu cầu sự căn chỉnh cẩn thận và lập kế hoạch lỗ via.
3.14 Khoan cơ khí (khoan lỗ xuyên qua)
Sau các bước gia công laser, tiến hành khoan cơ khí để tạo lỗ xuyên qua. Bước này khoan các lỗ xuyên qua toàn bộ tấm panel.
3.15 Loại bỏ cặn khoan và mạ lỗ thông (P.T.H)
Đặt các lỗ vias mù và lỗ xuyên qua cùng nhau để tất cả các lỗ vias được mạ kim loại. Tại thời điểm này, quy trình HDI đặc biệt kết thúc. Từ nay trở đi, bảng mạch sẽ tuân theo các bước hoàn thiện PCB tiêu chuẩn.
3.16 Lớp màng khô bên ngoài và mạ theo mẫu (DRY FILM & PATTERN PLATING)
Quá trình chuyển mẫu bên ngoài tương tự như các lớp bên trong. Sự khác biệt chính nằm ở phương pháp mạ:
- Phương pháp trừ: sử dụng phim âm bản. Phim khô cứng được giữ lại làm mạch. Gọt và tẩy phim để giữ lại mạch.
- Phương pháp cộng thêm/thông thường: Sử dụng phim dương. Lớp phim khô cứng phủ lên các vùng không thuộc mạch. Thực hiện mạ theo mẫu (đồng trước, sau đó là thiếc), sau đó bóc phim, thực hiện ăn mòn kiềm, loại bỏ thiếc và giữ lại mạch.
3.17 Màng hàn dạng ướt (WET FILM SOLDER MASK)
Lớp phủ hàn (solder mask) bao phủ bề mặt bảng mạch. Nó ngăn chặn việc hàn sai, độ ẩm hoặc hóa chất gây ra chập mạch, và bảo vệ các đường mạch khỏi hư hỏng vật lý. Điều này giúp duy trì tính ổn định của chức năng PCB.
Quy trình: làm sạch sơ bộ → phủ lớp → nướng sơ bộ → phơi sáng → phát triển → đóng rắn bằng tia UV → đóng rắn bằng nhiệt. Các điểm kiểm soát chính: độ chính xác của lớp phủ hàn, kích thước cầu lớp phủ, sản xuất lỗ via và độ dày lớp phủ. Chất lượng mực ảnh hưởng đến bề mặt hoàn thiện sau này, lắp ráp SMT và tuổi thọ bảng mạch.
3.18 Mạ vàng chọn lọc (IMMERSION GOLD)
Mạ niken/vàng hóa học là lớp hoàn thiện bề mặt sau khi phủ lớp chống hàn. Phương pháp này phù hợp với bảng mạch in (PCB) có khoảng cách đường mạch nhỏ và nhiều linh kiện hàn bề mặt. Nó giúp đảm bảo độ đồng phẳng và phẳng của các pad. Vàng có tính ổn định và bảo vệ tốt. Thông số mạ: niken ~5 μm, vàng 0.05–0.1 μm. Vàng quá dày có thể nứt và gây ra các mối hàn yếu. Vàng quá mỏng có khả năng bảo vệ kém. ENIG có thể khó hàn trong một số trường hợp và có thể xuất hiện các khuyết tật pad tối màu.
3.19 In ấn biểu đồ (In ấn C/M)
In ấn các ký hiệu và dấu hiệu bằng mực in ký hiệu. Điều này giúp thuận tiện cho việc lắp ráp và bảo trì sau này.
3.20 Gia công phay và tạo hình (TẠO HÌNH)
Cắt tấm panel hoàn thiện thành kích thước UNIT hoặc SET bằng máy CNC. Thực hiện cắt viền và gia công rãnh. Nếu cần V-CUT, thêm các bước tương ứng. Các thông số chính: độ dung sai của profile, kích thước góc vát, bán kính góc trong. Giữ khoảng cách an toàn giữa các mẫu và mép tấm.
3.21 Kiểm tra điện (E-TEST)
Đây là bài kiểm tra liên tục và cách ly. Các phương pháp chính bao gồm bài kiểm tra giường đinh và bài kiểm tra đầu dò bay:
- Giá đỡ đinh: giá đỡ tiêu chuẩn hoặc giá đỡ tùy chỉnh. Giá đỡ tiêu chuẩn có giá cao hơn nhưng phù hợp với nhiều loại mạch in (PCB). Giá đỡ tùy chỉnh có giá rẻ hơn cho từng bộ phận nhưng chỉ dành cho các loại mạch in cụ thể.
- Đầu dò di động: di chuyển các đầu dò để kiểm tra mạch in. Nó linh hoạt và phù hợp cho nhiều lô sản xuất nhỏ.
3.22 OSP (Chất bảo quản khả năng hàn hữu cơ)
OSP tạo thành một lớp màng hữu cơ trên các pad đồng trần và lỗ thông sau khi kiểm tra điện và kiểm tra bằng mắt thường. Độ dày của lớp màng là 0,3–0,5 μm. Nhiệt độ phân hủy khoảng 300 °C.
Ưu điểm chính: Lớp mạ phẳng phù hợp với PCB có khoảng cách chân nhỏ; quy trình đơn giản, ít ô nhiễm, chi phí thấp và khả năng hàn tốt. Nhược điểm: Lớp màng mỏng và dễ trầy xước. Thời hạn sử dụng ngắn.
Hiện nay, sự kết hợp giữa ENIG và OSP được sử dụng cho các bo mạch có độ chính xác cao. Chúng cung cấp khả năng bảo vệ và hàn tốt, đồng thời là một lựa chọn không chứa chì để thay thế HASL trong một số trường hợp. Chi phí cao hơn.

3.23 Kiểm toán cuối cùng (KIỂM TOÁN CUỐI CÙNG)
Kiểm tra ngoại hình, kích thước, hiệu suất điện và chất lượng mạ của bảng mạch in (PCB). Đảm bảo tất cả các yếu tố đều tuân thủ các tiêu chuẩn thiết kế và tiêu chuẩn ngành.
3.24 Đóng gói (ĐÓNG GÓI)
Đóng gói bo mạch in (PCB) để ngăn ngừa ẩm ướt và trầy xước. Bảo vệ bo mạch trong quá trình vận chuyển và lưu trữ chúng cẩn thận để sử dụng sau này.




