セラミック基板は、酸化物またはセラミックシートの表面に銅箔を高温で直接接合した特殊な基板です。銅は高温プロセスでセラミックに接合されるため、金属とセラミックは回路の安定した基盤を形成する。.
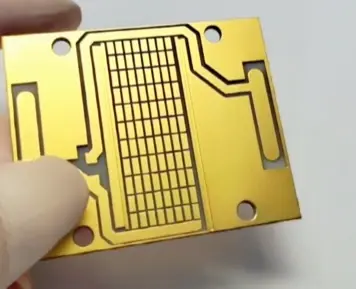
セラミックPCBの特性
機械的特性(回路トレースの形成方法)
a.機械的強度が高い。部品を保持し、支持構造としても機能する。.
b.機械加工が容易である。正確な寸法を保つことができる。何層にもできる。.
c.表面が滑らかである。反ったり、曲がったり、小さなひび割れがない。.
b.機械加工が容易である。正確な寸法を保つことができる。何層にもできる。.
c.表面が滑らかである。反ったり、曲がったり、小さなひび割れがない。.
電気的特性
a.絶縁抵抗が高く、耐圧が高い。このため、回路は短絡や高電圧による損傷から安全に保たれる。.
b.誘電率が低く、誘電損失が小さい。そのため、信号が損失少なく通過できる。.
c.高温多湿の環境下でも安定した性能を維持する。このため、ハードな使用条件下でも信頼性を確保できる。.
b.誘電率が低く、誘電損失が小さい。そのため、信号が損失少なく通過できる。.
c.高温多湿の環境下でも安定した性能を維持する。このため、ハードな使用条件下でも信頼性を確保できる。.
熱特性
a.熱伝導率が高い。このため、高温の部品から熱を逃がすことができる。.
b.その熱膨張係数は、関連する材料、特にシリコンに一致させることができる。この一致により、部品が加熱・冷却される際の応力が軽減される。.
c.耐熱性に優れている。高温でも安定している。.
b.その熱膨張係数は、関連する材料、特にシリコンに一致させることができる。この一致により、部品が加熱・冷却される際の応力が軽減される。.
c.耐熱性に優れている。高温でも安定している。.
その他の物件
a.化学的に安定している。メタライズが容易である。回路パターンが密着しやすい。.
b.水分を吸収しない。油や化学薬品に強い。放射線をほとんど放出しない。.
c.使用されている材料は無害で毒性がない。使用温度範囲で結晶構造が変化しない。.
d.原材料が豊富。技術が成熟している。作りやすく、価格が安い。.
b.水分を吸収しない。油や化学薬品に強い。放射線をほとんど放出しない。.
c.使用されている材料は無害で毒性がない。使用温度範囲で結晶構造が変化しない。.
d.原材料が豊富。技術が成熟している。作りやすく、価格が安い。.
セラミック基板の製造方法
セラミックを焼成する前に、4つの一般的な成形方法があります。粉末プレス法(モールドプレス法、アイソスタティックプレス法がある)、押出成形法、テープキャスト法、射出成形法である。このうち、テープキャスティングは、多層化が容易で生産効率が高いため、近年、LSIパッケージやハイブリッド回路基板に多く用いられている。.
一般的なプロセスルートはこの3つだ:
- レイヤーを重ねる-ホットプレス-バインダーを取り除く-ベースシートを焼成する-回路パターンを形成する-回路を焼成する。.
- レイヤーを重ねる-表面に回路パターンを印刷する-ホットプレスする-バインダーを取り除く-混焼する。.
- 回路パターンの印刷 - スタック - ホットプレス - バインダーの除去 - 混焼。.
セラミックPCBのメタライゼーション
a.厚膜法:
厚膜法では、導体(回路トレース)と抵抗がスクリーン印刷によってセラミック上に形成される。印刷後、焼結して回路とコンタクトパッドを形成する。印刷した金属を固定するバインダーには、ガラス系、酸化物系、ガラスと酸化物の混合系などがある。.
b.薄膜法:
薄膜は、蒸着、イオンプレーティング、スパッタリングなどの真空法を用いて金属を蒸着する。薄膜は気相から金属を析出させるため、原理的にはどんな金属でも析出させることができる。また、どんな基板も原理的にはこの方法で金属化できる。しかし、金属薄膜とセラミック基板の熱膨張はできるだけ一致させる必要がある。また、金属層とセラミックの密着性を高めることも重要である。.
c.c.同時焼成法:
焼成前に、Mo、Wおよび同様の金属の耐火性金属ペーストが、未焼成のセラミックシートにスクリーン印刷される。その後、スタックを脱バインダーし、セラミックと金属が一体構造を形成するように焼成する。この方法には次のような特徴がある:
微細な回路形成が可能で、多層化が容易なため、高密度配線が可能。.
絶縁体と導体が一体形成されているため、パッケージの気密封止が可能。.
適切な組成、成形圧力、焼結温度を選択することで、焼結収縮を制御することができます。特に面内収縮ゼロの基板を作製すれば、BGA、CSP、ベアチップ高密度実装への応用が広がる。.
微細な回路形成が可能で、多層化が容易なため、高密度配線が可能。.
絶縁体と導体が一体形成されているため、パッケージの気密封止が可能。.
適切な組成、成形圧力、焼結温度を選択することで、焼結収縮を制御することができます。特に面内収縮ゼロの基板を作製すれば、BGA、CSP、ベアチップ高密度実装への応用が広がる。.
セラミック基板の種類
アルミナ基板(Al₂O₃)
a.原料:Al₂O₃はしばしば バイヤー法. .この方法では、原料はボーキサイトであり、水和アルミニウム酸化物および関連化合物を含む。.
b.作る:Al₂O₃セラミックスは通常、未焼成のシートを積層することで形成される。ポリビニルブチラール(PVB)のようなバインダーを使用することが多い。焼成温度は添加する焼結助剤によって異なり、通常1550~1600℃である。Al₂O₃のメタライゼーション法は、主に厚膜法と同時焼成法である。ペーストとプロセス技術は成熟している。今日、多くの応用ニーズに応えている。.
c.用途ハイブリッド集積回路用基板、LSIパッケージ基板、多層回路基板。.
b.作る:Al₂O₃セラミックスは通常、未焼成のシートを積層することで形成される。ポリビニルブチラール(PVB)のようなバインダーを使用することが多い。焼成温度は添加する焼結助剤によって異なり、通常1550~1600℃である。Al₂O₃のメタライゼーション法は、主に厚膜法と同時焼成法である。ペーストとプロセス技術は成熟している。今日、多くの応用ニーズに応えている。.
c.用途ハイブリッド集積回路用基板、LSIパッケージ基板、多層回路基板。.

ムライト基板(3Al₂O₃-2SiO₂)
ムライトはAl₂O₃-SiO₂系で最も安定した結晶相の一つである。Al₂O₃に比べ、ムライトは機械的強度がやや低く、熱伝導率も低いが、誘電率は低い。この誘電率の低さは、信号速度の向上に役立ちます。また、熱膨張率も低いため、実装LSIへの熱ストレスを低減することができます。また、MoやWのような導体金属との膨張差も小さいため、混焼しても金属とセラミック間の応力が小さくなります。.
窒化アルミニウム基板(AlN)
a.原料:AlNは天然の鉱物ではない。1800年代に初めて合成された人工材料である。典型的なAlN粉末は、還元窒化法または直接窒化法で作られる。還元窒化法はAl₂O₃から出発し、高純度炭素で還元し、窒素と反応させてAlNを生成する。直接窒化法は、Al粉末をN₂と反応させ、直接AlNを形成する。.
b.作製:Al₂O₃基板に使用される成形方法はAlNにも使用できる。最もよく使われるのは、未焼成シートを積層する方法である。このために、AlN粉末、有機バインダー、溶剤、界面活性剤を混合してセラミックスラリーを作る。このスラリーをテープキャストし、積層し、ホットプレスし、脱バインダーした後、焼成してAlN基板を作る。.
c.AlN基板の特徴:AlNはAl₂O₃の10倍以上の熱伝導率を持つ。熱膨張係数(CTE)はシリコンに匹敵する。Al₂O₃と比較して、AlNは絶縁抵抗が高く、耐圧が高い。誘電率は低い。これらの特徴により、AlNはパッケージ基板として非常に価値がある。.
d.用途VHF帯パワーアンプモジュール、ハイパワーデバイス、レーザーダイオード基板に使用。.
b.作製:Al₂O₃基板に使用される成形方法はAlNにも使用できる。最もよく使われるのは、未焼成シートを積層する方法である。このために、AlN粉末、有機バインダー、溶剤、界面活性剤を混合してセラミックスラリーを作る。このスラリーをテープキャストし、積層し、ホットプレスし、脱バインダーした後、焼成してAlN基板を作る。.
c.AlN基板の特徴:AlNはAl₂O₃の10倍以上の熱伝導率を持つ。熱膨張係数(CTE)はシリコンに匹敵する。Al₂O₃と比較して、AlNは絶縁抵抗が高く、耐圧が高い。誘電率は低い。これらの特徴により、AlNはパッケージ基板として非常に価値がある。.
d.用途VHF帯パワーアンプモジュール、ハイパワーデバイス、レーザーダイオード基板に使用。.

炭化ケイ素基板(SiC)
a.原料:SiCは天然の鉱物ではない。シリカ、コークス、少量の塩を粉末として混合して作られる。この混合物を黒鉛炉で2000℃以上に加熱して反応させ、α-SiCを形成する。その後、SiCを昇華させて精製し、濃い緑色の多結晶のブロックを得ることができる。.
b.製造:SiCは化学的・熱的安定性が非常に高いため、通常の焼成方法では緻密化しにくい。焼結助剤と特殊な焼成方法が必要である。真空ホットプレスが一般的である。.
c.SiCの特徴:主な特徴は、熱拡散係数が非常に大きいことである。銅よりも大きいことさえある。熱膨張率はシリコンに近い。しかし、SiCには欠点もある。誘電率が比較的高く、絶縁破壊電圧は他のセラミックほど高くありません。.
d.用途:SiC基板は、高熱拡散が必要で電圧は高くない場合に使用される。VLSIの放熱パッケージ、ヒートシンク付き高速・高集積ロジックLSI、大型コンピュータ、光通信用レーザーダイオード基板などに使用される。.
b.製造:SiCは化学的・熱的安定性が非常に高いため、通常の焼成方法では緻密化しにくい。焼結助剤と特殊な焼成方法が必要である。真空ホットプレスが一般的である。.
c.SiCの特徴:主な特徴は、熱拡散係数が非常に大きいことである。銅よりも大きいことさえある。熱膨張率はシリコンに近い。しかし、SiCには欠点もある。誘電率が比較的高く、絶縁破壊電圧は他のセラミックほど高くありません。.
d.用途:SiC基板は、高熱拡散が必要で電圧は高くない場合に使用される。VLSIの放熱パッケージ、ヒートシンク付き高速・高集積ロジックLSI、大型コンピュータ、光通信用レーザーダイオード基板などに使用される。.
ベリリア基板 (BeO)
BeOはAl₂O₃の何倍もの熱伝導率を持つ。大電力回路に適している。誘電率が低いので高周波回路に適している。BeO基板は通常ドライプレスで製造される。また、MgOやAl₂O₃を少量添加した非焼成シートルートでも製造可能です。BeO粉末は有毒であるため、BeO製品は環境と健康への懸念を引き起こす。日本ではBeO基板の製造は許可されておらず、BeOは米国などから輸入しなければならない。.
いくつかのセラミック材料と基板タイプの比較
セラミック基板は、その構造や製造方法から、HTCC、LTCC、TFC、DBC、DPCなどに分類することができます。セラミック基板は、熱伝導性、耐熱性、絶縁性、低熱膨張性、低コストであることから、IGBT(絶縁ゲートバイポーラトランジスタ)、LD(レーザーダイオード)、高出力LED、CPV(集光型太陽光発電)などの電子機器パッケージングやパワーエレクトロニクス分野でますます使用されるようになっています。.
一般的なセラミック母材はBeO、Al₂O₃、AlN、Si₃N₄です。中でもSi₃N₄は電気絶縁性と化学的安定性が非常に高い。また、熱安定性が高く、機械的強度も高い。高密度、高集積の回路基板に使用できる。.
高温同時焼成セラミック多層膜(HTCC)
HTCCは高温同時焼成セラミック基板である。HTCCを作るには、まずAl₂O₃やAlNなどのセラミック粉末を有機バインダーと混合する。この混合物をペースト状にし、ドクターブレードなどでシート状に成形する。乾燥したシートはグリーンボディとなる。ビア用の穴が開けられ、配線やビア充填用の導体ペーストがスクリーン印刷される。その後、グリーンシートを積層し、1600℃前後の高温炉に入れて焼結する。焼結温度が高いため、導体金属の選択肢は限られる。タングステン、モリブデン、マンガンなど、融点は高いが導電率が低い金属が使われる。コストは高く、熱伝導率はおおよそ20~200W/(m・℃)である。.
低温同時焼成セラミックPCB(LTCC)
LTCCは低温同時焼成セラミックである。その製造ステップはHTCCに似ている。違いは、Al₂O₃粉末が30~50%の低融点ガラスを含むことである。これにより、焼成温度が約850~900℃に下がる。焼成温度が低いため、金や銀のような導電性の良い金属を電極やトレースに使用できる。LTCCでは、金属線にスクリーン印刷を使用する。この方法ではメッシュが伸びるため、位置合わせに誤差が生じることがある。また、多層膜を積層して同時焼成すると、異なる収縮が発生し、歩留まりが低下する。LTCCの熱伝導率を上げるために、部品部分にサーマルビアや導電性ビアを追加することができるが、コストが上がる。.
厚膜セラミック基板(TFC)
LTCCやHTCCに比べ、TFCは後焼成セラミック基板である。スクリーン印刷でセラミック基板表面に金属ペーストを塗布します。乾燥後、高温(700~800℃)で焼成する。金属ペーストは金属粉末、有機樹脂、ガラスでできている。焼成後、樹脂は燃え尽き、セラミック表面にガラス状の接着剤で結合された金属層が残る。焼成された金属層の厚さは通常10~20μmで、最小線幅は約0.3mmである。技術が成熟しており、工程が単純でコストが低いため、TFCはパターン精度の要求が高くない場合に使用される。.
ダイレクトボンディング銅セラミックPCB(DBC)
DBCは、銅箔とセラミックシートを高温(約1065℃)で共焼結または共晶接合することにより製造される。接合後、エッチングにより回路パターンを形成する。銅箔は電気伝導と熱伝導がよく、Al₂O₃はCu-Al₂O₃-Cu複合体の膨張を制御できるため、DBCはアルミナに近い熱膨張を持つ。DBCは熱伝導がよく、絶縁性が強く、信頼性が高い。IGBT、レーザーダイオード、CPVパッケージに広く使用されている。DBCには欠点もある。CuとAl₂O₃の高温共晶反応は、装置とプロセスを厳密に管理する必要があるため、コストが高くなる。Al₂O₃とCuの間に微細孔ができ、耐熱衝撃性が低下する。銅箔は高温で反る可能性があるため、DBCの銅厚は通常100μm以上。また、エッチングでパターンを形成するため、最小線幅は100μm以上が一般的。.

ダイレクトメッキ銅セラミックPCB(DPC)
DPCはセラミックシートの洗浄と前処理から始まります。次に、基板表面に真空スパッタリングでTi/Cuシード層を成膜する。フォトリソグラフィー、現像、エッチングを用いて回路パターンを形成する。その後、電気メッキまたは化学メッキを使用して回路厚を成長させる。フォトレジストを除去すると基板は完成する。DPCには次のような利点がある:低温プロセス(300℃以下)なので、材料や回路に対する高温の欠点を回避でき、製造コストを下げることができる。薄膜とフォトリソグラフィーを使用することで、基板上の金属ラインがより微細になる。そのため、DPCは高いアライメント精度を必要とするパッケージに適している。しかし、DPCにも欠点がある。電解銅メッキの厚さには限界があり、電解メッキ廃液は公害の原因となる。金属層とセラミックの密着性が低いため、製品の信頼性が低くなる可能性がある。.
使用と選択に関する注意事項
セラミック基板を選択する際は、アプリケーションのニーズに合わせて材質を決定してください。高い熱伝導率とシリコンに近い熱膨張率が必要な場合は、AlNまたはSiCが最適でしょう。コストと成熟した加工が重要な場合は、Al₂O₃が堅実な選択です。細線と低温処理が必要なら、DPCとLTCCが使える。高密度多層配線と気密封止が必要なら、LTCCやHTCCのような金属共焼結ルートが適しているかもしれない。.
一般的な応用分野としては、パワーモジュール、RFパワーアンプ、レーザーダイオードモジュール、高出力LED、高密度LSIパッケージなどがある。パワーエレクトロニクスでは、セラミック基板が熱をよく移動させ、熱応力下でも絶縁性と機械的強度を維持するため得られます。RFデバイスは、低誘電損失と安定した誘電特性から得られます。高密度パッケージングでは、微細な配線が可能であり、プロセスが適切であればアライメント制御が良好な多層積層が可能であることが利点となる。.
製造上のトレードオフと実用上のポイント
どのセラミックタイプにも、どのプロセスにもトレードオフがあります。HTCCは焼成温度が高いため、導体に耐火性金属を使用します。このため、導電性が制限され、コストが上昇しますが、HTCCは高温で非常に堅牢になります。LTCCは、ガラスを加えることで焼成温度を下げるので、より良い導体を使用することができるが、LTCCには収縮の問題があり、多層膜のアライメントに問題がある。TFCは安価でシンプルだが、非常に微細なパターンは得られない。DBCは厚い銅で優れたヒートスプレッドが得られるが、パターニングの限界と製造コストが問題となる。DPCは微細パターニングと低温処理が可能だが、密着性と廃棄物管理に注意が必要。.
同時焼成と焼成後のメタライゼーション
同時焼成とは、グリーンセラミック上に金属ペーストを印刷し、すべてを一緒に焼成することです。これにより、非常に小さなフィーチャーや真の多層配線を作ることができます。また、セラミックと金属を一体化させることができるため、気密封止にも役立ちます。しかし、同時焼成には、収縮と焼結を一致させるために材料を注意深く管理する必要があります。焼成したセラミックに厚膜や薄膜のような焼成後のメタライゼーションを施すことで、共焼結による収縮の問題を回避することができます。単層や単純な二重層が必要な場合は、この方が簡単です。しかし、後焼成法は同じ配線密度に達しない場合があり、接着性や熱特性が異なる場合があります。.
典型的なプロセスフローの例(短い要約)
- 共焼成多層基板の場合:セラミックスラリーを作り、テープキャストし、グリーンテープにビアを開け、スクリーンで導体ペーストを印刷し、テープを重ね、プレスして脱バインダーし、焼成する。焼成後、必要に応じてパッドメタライゼーションや回路エッチングなどの最終処理を行う。.
- セラミック上の厚膜の場合:焼成セラミック基板を使用し、導体および抵抗ペーストをスクリーン印刷し、700~800℃で焼成した後、抵抗をトリミングし、最終的に金属パッドを追加する。.
- DPCの場合:セラミックの洗浄、スパッタによるTi/Cuシードの析出、フォトレジストのパターン形成、シードをエッチングしてパターンを形成、電解めっきで銅を成長させ、レジストを剥離、最終洗浄。.
概要
セラミックPCBは、電子パッケージングにユニークな強みを与える基板材料のクラスです。優れた熱経路、温度に対する安定した電気的挙動、優れた機械的強度を提供します。異なるセラミックの選択と異なるメタライゼーション・ルートにより、設計者はコスト、熱性能、電気性能、微細なラインパターンのニーズのバランスをとることができます。このため、セラミック基板は、パワーエレクトロニクス、RFモジュール、レーザーおよびダイオードパッケージ、高出力LED、および多くの高密度パッケージ分野で広く使用されています。.
よくある質問
最も一般的なものは、一般的な用途のアルミナ(Al₂O₃)と、より高い熱伝導率の窒化アルミニウム(AlN)である。その他の特殊セラミックス(炭化ケイ素など)は、ニッチな高出力または高温のニーズに使用される。.
セラミックPCBは、厚膜印刷、薄膜蒸着、レーザー加工、金属化(銅または銀)、焼成、仕上げなどの工程を経て製造される。.
主な利点は、熱伝導性(放熱性)が非常に優れていること、熱膨張係数(CTE)が低いこと、高温耐性があること、電気絶縁性に優れていることなどであり、LED、パワーエレクトロニクス、RF/高周波用途に理想的である。.
セラミックPCBは、材料コストと特殊なプロセス(焼成、レーザー加工、メタライゼーション)により、一般的に標準的なFR-4よりも高価になりますが、ハイパワーまたは高信頼性設計では、性能と寿命を向上させることにより、システムコストを削減することができます。.
はい。セラミック基板は安定した誘電特性を持ち、高周波での損失が少ないため、RFおよびマイクロ波回路部品に適しています。.
費用対効果と一般的な用途にはアルミナを、高出力用途でより高い熱伝導性と優れた熱管理が必要な場合はAlNをお選びください。熱的要件、機械的要件、予算要件を考慮して選択する必要があります。.


