序文
BGA技術の研究は1960年代に始まった。米国のIBMが最初に使用した。しかし、BGAが実用化されたのは1990年代初頭のことである。.
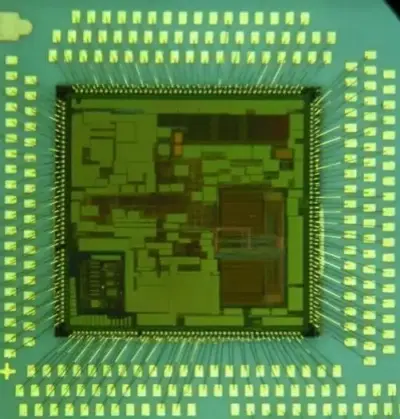
1980年代、人々はより小さな電子回路とより多くのI/Oピンを求めていた。. 表面実装技術(SMT) は、回路アセンブリに、軽く、薄く、短く、小さいという特徴を与えた。SMTはまた、多くのリードを持つ部品のピンピッチとコプラナリティに対するより高い要求をもたらした。しかし、加工精度、製造性、コスト、組立工程の限界から、QFP(Quad Flat Pack)部品のピッチ限界は一般的に0.3mmと見られていた。この限界は、高密度実装の開発に大きな制約となっていた。また、ファインピッチのQFP部品は厳密な組立工程を必要とするため、その用途は限られていた。そのため、用途が限定されていた。そのため、一部の米国企業はBGA部品の開発と使用に注力した。高密度実装のニーズには、QFPよりもBGAの方が優れていると考えたのだ。.
BGAとは?
BGAはBall Grid Arrayの略。このパッケージでは、はんだボールがパッケージ基板の底面に格子状に配置されている。これらのボールは、デバイスとプリント基板(PCB)間のI/O接続として機能する。この方式でパッケージされた部品は表面実装デバイスである。初期のCPUは、今日のいくつかの非常に基本的なマイクロコントローラのように、DIPパッケージを使用していました。.
今日、エレクトロニクス産業の急速な成長により、コンピューターや携帯電話は一般的なものとなった。人々はエレクトロニクス製品に多機能と高性能を求める一方で、小型化と軽量化を求めている。そのため、製品の多機能化、高性能化、小型化が進んでいる。この目標を達成するためには、ICチップはより小さく、より複雑にならざるを得ない。そして、回路のI/O数は増加し、パッケージのI/O密度は上昇する。このトレンドに対応するため、高度な高密度実装技術が誕生した。BGAパッケージもその一つである。.
すべてのICパッケージタイプの中で、BGAは1996年から2001年にかけて最も急速に成長した。1999年のBGA生産量は約10億個であった。今日に至るまで、この技術は依然として高密度、高性能デバイス向けが主流である。より微細なピッチと、より多いI/O数への移行が続いている。BGAパッケージは主に、PCチップセット、マイクロプロセッサー/コントローラー、ASIC、ゲートアレイ、メモリー、DSP、PDA、PLD、および同様のデバイスに使用されています。.
パッケージ材料別BGAの種類
パッケージ材料にもよるが、BGAデバイスには主に以下のようなものがある:
PBGA(プラスチックBGA)
CBGA(セラミックBGA)
CCBGA(セラミック・コラムBGA)
TBGA(テープBGA)
CSP(チップスケールパッケージまたはμBGA)
PBGA - プラスチック・ボール・グリッド・アレイ
PBGAは基板にBT樹脂/ガラスラミネートを使用。パッケージはプラスチック(エポキシ成形コンパウンド)で封止されている。はんだボールは有鉛合金(例えば63Sn37Pb、62Sn36Pb2Ag)または無鉛合金(例えばSn96.5Ag3Cu0.5)です。はんだボールとパッケージ本体は、余分なはんだを加えることなく接合されます。.
PBGAパッケージにはキャビティを持つものがある。キャビティアップ」と「キャビティダウン」のバージョンがある。これらのキャビティPBGAパッケージは熱放散を改善し、熱強化BGA(EBGA)と呼ばれる。また、CPBGA(キャビティ・プラスチックBGA)と呼ぶものもある。.
PBGAの利点:
PCBとの熱的マッチングが良い。PBGAのBT樹脂/ガラスラミネートの熱膨張係数(CTE)は約14ppm/℃です。多くのPCBのCTEは17ppm/℃前後です。この2つの値は近い。ですから、熱的なマッチングは良好です。.
リフローはんだ付けの際、PBGAははんだボールのセルフアライメント効果を利用します。溶融はんだの表面張力が、はんだボールとパッドの位置合わせを助けます。.
低コスト。.
良好な電気的性能。.
PBGAの欠点:
湿気に弱い。気密封止や非常に高い信頼性を必要とする機器には適さない。.
CBGA - セラミック・ボール・グリッド・アレイ
CBGAはBGAファミリーの中で最も長い歴史を持つ。その基板は多層セラミックです。ダイ、ワイヤーボンド、パッドを保護するため、金属製の蓋が封止はんだで基板に封止されている。パッケージのはんだボール材料は高温合金で、原文では10Sn90Pbと表記されている。ボールとパッケージ本体の接続には、63Sn37Pb などの低温合金が使用される。.
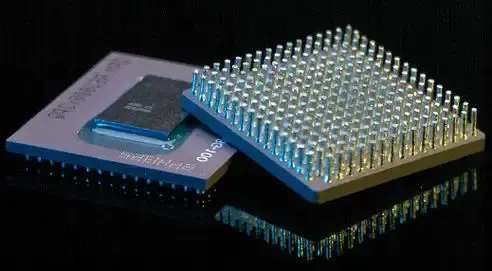
CBGAの利点:
優れた気密性と高い耐湿性。長期信頼性が高い。.
PBGAよりも優れた電気絶縁性。.
PBGAよりもパッケージ密度が高い。.
PBGAよりも優れた放熱性。.
CBGAの欠点:
セラミック基板とPCBのCTEは大きく異なる。熱のミスマッチが悪い。はんだ接合部の疲労が主な故障モードである。.
PBGAより高コスト。.
パッケージエッジ付近のはんだボールの位置合わせが難しくなる。.
TBGA - テープ・ボール・グリッド・アレイ
TBGAはキャビティ・パッケージである。TBGAでダイと基板を接続するには、フリップチップはんだ接合とワイヤーボンディングの2つの方法がある。フリップチップでは、ダイは多層配線のフレキシブルテープ上にボンディングされる。回路I/O端子となるペリフェラルアレイのはんだボールは、フレキシブルテープの下に配置される。厚い封止蓋がヒートシンクと補強を兼ねている。これにより、フレキシブル基板下のはんだボールはよりコプラナーになる。ダイはキャビティ内の銅製ヒートスプレッダーに接着される。ダイ・パッドとフレキシブル・テープ・パッドはボンディング・ワイヤーで接続される。封止材がダイ、ワイヤー、フレキシブル・テープ・パッドを(ポッティングまたはコーティングによって)封止する。.
TBGAの利点:
パッケージのフレキシブル・テープは、プリント基板の熱膨張によりよくマッチする。.
リフローはんだは、はんだのセルフアライメント効果を利用することができます。溶融ボールの表面張力は、ボールとパッドの位置合わせに役立ちます。.
TBGAは最も経済的なBGAパッケージです。.
PBGAよりも優れた放熱性。.
TBGAの欠点:
湿気に弱い。.
パッケージ内の複数の材料層は信頼性を低下させる可能性がある。.
その他のBGAタイプ
その他のパッケージ形態は以下の通り:
MCM-PBGA(マルチチップモジュールPBGA)
μBGA(マイクロBGA)、チップスケールパッケージ
SBGA(スタックド・ボール・グリッド・アレイ)
etBGA(超薄型BGA):パッケージの高さが約0.5mmで、チップの厚さに近い。
CTBGA、CVBGA(薄型および極薄チップアレイBGA) - 薄型および極薄BGA
標準的なリワーク
標準的なSMDリワークシステムの原理:
熱風を使って表面実装デバイス(SMD)のピンやパッドに熱を集中させる。これにより、はんだ接合部を溶かしたり、はんだペーストを再流動させたりして、部品の取り外しやはんだ付けが可能になります。各ベンダーのリワークシステムは、主に熱源と熱風のフローパターンによって異なります。熱風をSMDの上方に吹き付けるノズルもある。デバイス保護の観点からは、PCBの周囲を気流が循環している方がよい。プリント基板の反りを防ぐには、プリント基板を予熱できるリワーク・システムを選ぶこと。.
BGAリワーク
このセクションでは、HT996システムを例に、BGAリワークの手順をまとめています。.
BGAの取り外し
PCBパッドに残ったはんだを、はんだごてできれいに均してください。必要に応じて、はんだ吸い取り用ブレードと平らな刃のはんだごてのこて先を使用してください。クリーニングの際は、パッドやソルダーマスクを傷つけないように注意してください。.
フラックスの残留物を除去するには、専用のクリーナーを使用する。.
脱水(ベーキング)
PBGA部品は湿気に弱い。組み立てる前に、部品が湿気を吸収していないか確認してください。湿っている場合は、ベーキング工程を実施して湿気を除去してください。.
ソルダーペースト印刷
他の部品が既に基板上にあるため、専用の小型BGA用ステンシルを使用する。ステンシルの厚みと開口サイズは、ボールの直径とピッチに依存します。印刷後、印刷品質を検査する。印刷品質が悪い場合は、プリント基板を洗浄し、乾燥させてから再印刷してください。ピッチが0.4mm以下のCSPの場合、ソルダーペーストの印刷を省略することができます。その場合は、フラックスペーストをプリント基板のパッドに直接塗布してください。.
プリント基板をリフロー炉に入れ、部品を取り出す。リフロープログラムを実行する。ピーク温度で、真空ピックアップを使用して部品を取り外します。PCBを冷まします。.
パッドクリーニング
はんだごてとはんだ吸取材を使用して、PCBパッド上のはんだ残渣を清掃し、平らにしてください。パッドやはんだマスクを傷つけないように注意してください。.
脱水症状(再び)
PBGAは湿気に弱いため、組み立て前に湿った部品をチェックし、ベークしてください。.
ソルダーペースト印刷(再び)
前回同様、小型のBGA専用ステンシルを使用する。ステンシルの厚みと開口部は、ボールのサイズとピッチに合わせる必要があります。印刷後、印刷品質をチェックする。許容できない場合は、プリント基板を洗浄し、乾燥させてから再印刷してください。ピッチが0.4mm以下のCSPの場合は、印刷を省略してパッドにフラックスペーストを塗布してもよい。.
BGAの配置
BGAが新しい場合は、含水率をチェックする。湿っている場合は、配置する前にベークしてください。.
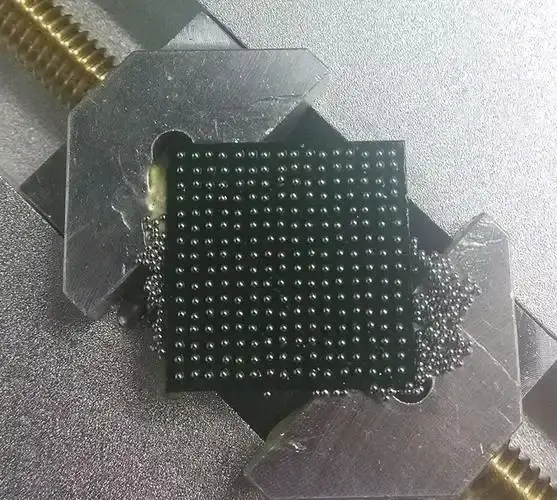
一般に、取り外したBGA部品は再利用できる。ただし、最初に再ボールする必要があります。BGAを配置する手順:
A.はんだペーストが印刷されたプリント基板を作業台の上に置きます。.
B.適切なノズルを選び、真空ポンプのスイッチを入れる。ノズルでBGAをピックし、BGAの底をPCBのパッドに合わせ、ノズルを下げてBGAをPCBに置き、真空を切る。.
リフローはんだ付け
デバイスサイズとPCB厚さに応じてリフロープロファイルを設定してください。BGAのリフロー温度は、一般的に従来のSMD部品よりも約15℃高くなります。.
検査
BGAはんだ接合部の品質は、通常、X線検査装置または超音波検査装置で検査されます。これらのツールがない場合は、機能テストまたは経験豊富な目視検査を使用してください。.
完成したPCBを光にかざし、BGAのエッジをチェックする。光を通すか、BGAとPCBの隙間は均一か、はんだペーストは完全に溶けているか、はんだボールの形は規則的か、ボールの崩れ具合などを見る。.

接合部が半透明でない場合、パッド間にブリッジやはんだボールが発生している可能性があります。.
ボールの形状が不規則であったり、斜めになっている場合は、温度が低すぎる可能性があります。はんだ付けが不完全な場合、リフロー時のセルフアライメント効果が得られないことがあります。.
ボール倒れレベルは、リフロー温度、ペースト量、パッドサイズに依存します。正しいパッド設計であれば、リフロー後の通常の倒れ込みはリフロー前のボール高さの 1/5 から 1/3 程度である。崩壊が大きすぎる場合、温度が高すぎ、ブリッジが発生する可能性があります。.
BGAエッジとPCB間のギャップが均一でない場合、パッケージ周囲の温度は均一ではなかった。.
リボール(はんだボール取り付け)工程
BGAボトムパッド上の残留はんだを除去し、洗浄する。.
はんだごてを使用して、PCBパッドに残ったはんだを除去します。はんだ吸い取り用モールと平らなはんだごてのこて先を使用してください。パッドやソルダーマスクを傷つけないように注意してください。.
フラックス残渣の除去には専用クリーナーを使用する。.

BGAの底部パッドにフラックスを印刷する。
粘着性とはんだ助剤としての特性から、しばしば高粘度フラックスを使用する。印刷されたフラックスパターンが鮮明で、広がらないようにする。フラックスの代わりにはんだペーストを使用することもある。ペーストを使用する場合は、ペースト中の金属組成がはんだボール金属と一致している必要があります。.

印刷には小型の専用BGAステンシルを使用する。ステンシルの厚みと開口部は、ボールの直径とピッチに合わせる必要があります。印刷後、印刷品質をチェックする。良好でない場合は、クリーニングして再印刷する。.
はんだボールを選ぶ
はんだボールを選ぶ際には、ボールの材質と直径を考慮してください。PBGA のはんだボールは通常 63Sn/37Pb を使用しており、これはリフローはんだに使用される合金と同じです。そのため、デバイスのボールと同じ合金のボールを選択します。.
ボールの大きさの選択は重要である。高粘度フラックスを使用する場合は、デバイスボールと同じ直径のボールを選択します。ソルダーペーストを使用する場合は、デバイスボールより少し小さいボールを選択してください。.
ボールアタッチメント
ボールを取り付ける方法はいくつかある:
A) ボールマシン法
ボール盤をお持ちの場合は、BGAパッドレイアウトに合ったテンプレートをお選びください。テンプレートの開口部はボールの直径より0.05~0.1mm大きくする。テンプレート上にボールを均等に振りかける。ボール・マシンを振って、余分なボールが回収トレイに転がるようにし、各穴に正確に1個ずつボールを残す。.
作業台にテンプレートを置く。印刷されたフラックスまたはペーストでコーティングされたBGAをバキュームノズルでピックアップする。ペーストまたはフラックスがデバイス・パッド上のボールを保持するように、BGAをテンプレート内のボール上に整列させ、下降させる。ピンセットを使ってデバイスフレームを保持し、真空をオフにする。デバイスをボール面を上にしてベンチに置く。ボールが欠けていないか確認し、必要であればピンセットで追加する。.
B) テンプレート方式
フラックスまたはペーストでコーティングしたBGAを、フラックスを上にしてベンチに置きます。BGAパッドレイアウトに合ったテンプレートを用意する。テンプレートの開口部は、ボールの直径より0.05~0.1mm大きくしてください。BGAまでの距離がボール直径と等しいか、わずかに小さくなるように、テンプレートの端をシムで支える。顕微鏡で位置合わせをする。テンプレート上にボールを均等に振りかける。余分なボールをピンセットで取り除き、各穴にボールが1個ずつ残るようにする。テンプレートを取り外して確認し、不足しているボールがあれば補充する。.
C)手動配置
フラックスまたはペーストを塗布したBGAをベンチに置く。通常のSMD配置のようにピンセットやピックアップペンを使ってボールを1つずつ配置する。.
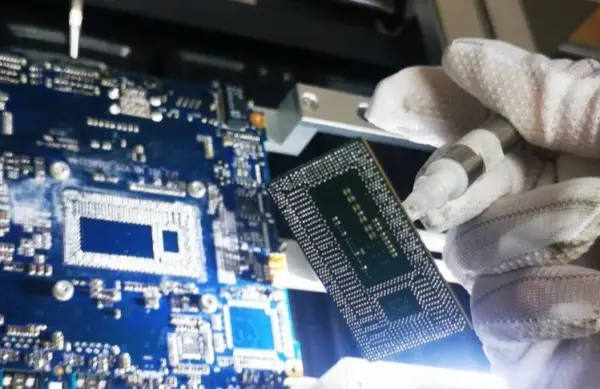
D) ソルダーペースト印刷法
ステンシルを厚くし、開口部を少し大きくする。BGAパッドに直接はんだペーストを印刷する。表面張力により、リフロー後にはんだボールが形成されます。.
リフロー
リフローを行い、はんだボールをデバイスに固定する。.
はんだ付け後の洗浄と取り扱い
リボール後は、BGAデバイスを十分に洗浄してください。その後、できるだけ早く組み立て、はんだ付けしてください。これにより、はんだボールの酸化やデバイスの吸湿を防ぐことができます。.
概要
技術の絶え間ない進歩により、現代生活はエレクトロニクスと密接に結びついている。小型携帯電話、小型ラジオ、ポータブル・コンピューター、メモリー、ハードディスク・ドライブ、CDドライブ、ハイビジョン・テレビはすべて、小型化・軽量化が求められている。そのためには、製造工程や部品に工夫を凝らす必要がある。.
SMT(表面実装技術)はこのトレンドに合致し、軽薄短小の電子製品の基礎を築いた。SMTが成熟した1990年代以降、携帯性、小型化、ネットワーク化、マルチメディア化といった電子製品のトレンドは、組立技術をさらに押し進めた。新しい高密度組立方法が登場した。BGAは、実用化された高密度実装方式の一つである。本稿では、BGA組立の特徴とはんだ接合部の品質管理について紹介する。.

